Inhalt
- Highlights
- Was ist ein 5G Phone PCB? (Umfang & Grenzen)
- Wichtige Kennzahlen (Wie man sie bewertet)
- Wie man wählt (Material- & Designauswahl)
- Implementierungs-Prüfpunkte (vom Design bis zur Fertigung)
- Häufige Fehler (und wie man sie vermeidet)
- Checkliste zur Lieferantenqualifizierung: Wie Sie Ihre Fabrik überprüfen
- Glossar
- 6 wesentliche Regeln für 5G Phone PCBs (Spickzettel)
- FAQ
- Fordern Sie ein Angebot / DFM-Review für 5G Phone PCBs an
- Fazit
Der Übergang von 4G zu 5G war nicht nur ein Geschwindigkeits-Upgrade; es war ein grundlegender architektonischer Wandel bei mobiler Hardware. Für Ingenieure und Beschaffungsteams ist das "5G Phone PCB" nicht länger ein einfacher Träger von Komponenten – es ist ein aktiver, hochleistungsfähiger Bestandteil des RF-Front-Ends. Mit der Einführung von mmWave-Frequenzen, massiven MIMO-Arrays und extremen Miniaturisierungsanforderungen ist der Spielraum für Fehler bei der Leiterplattenherstellung verschwunden. Bei APTPCB sehen wir aus erster Hand, dass eine erfolgreiche 5G-Implementierung einen ganzheitlichen Ansatz erfordert, der fortschrittliche HDI-Techniken mit exotischen, verlustarmen Materialien verbindet.
Dieser Leitfaden dient als Ihre definitive technische Ressource. Wir gehen über oberflächliche Definitionen hinaus und untersuchen die spezifischen Fertigungsprozesse (wie mSAP), Materialparameter (Dk/Df) und Qualitätsprüfpunkte, die erforderlich sind, um ein ertragreiches 5G-Gerät auf den Markt zu bringen.
Highlights
- Die SLP-Revolution: Warum Substrate-Like PCBs (SLP) traditionelles HDI in 5G-Flaggschiff-Geräten ersetzen.
- Materialwissenschaft: Abwägung der Vor- und Nachteile von Modified Polyimide (MPI), LCP und Low-Loss FR4.
- Kritische Kennzahlen: Die exakten Dk-, Df- und Wärmeleitfähigkeitswerte, die für mmWave-Leistung erforderlich sind.
- Fertigungsrealitäten: Verständnis von mSAP (Modified Semi-Additive Process) für Leiterbahnbreiten unter 30 µm.
- Risikominderung: Wie man häufige Ausfälle wie Signaldämpfung, thermische Drosselung und Schichtdelamination verhindert.
- Lieferantenüberprüfung: Eine Checkliste mit Fragen, die Sie Ihrem Fertigungspartner stellen sollten, bevor Sie eine Bestellung aufgeben.
Was ist ein 5G Phone PCB? (Umfang & Grenzen)
Wenn wir über ein "5G Phone PCB" sprechen, sprechen wir selten über eine einzelne Platine. Die Architektur eines modernen 5G-Smartphones ist ein komplexes Ökosystem miteinander verbundener Substrate. Es umfasst im Allgemeinen drei verschiedene Kategorien:
- Das Mainboard (SLP/HDI): Dies ist das Logikzentrum, in dem der AP (Application Processor) und der PMIC untergebracht sind. Bei 5G-Geräten hat sich dies zur Substrate-Like PCB (SLP)-Technologie weiterentwickelt. Im Gegensatz zu Standard-HDI PCB ermöglicht SLP Leiterbahnbreiten/-abstände (L/S) von bis zu 30/30 µm oder sogar 25/25 µm, was die Dichte ermöglicht, die erforderlich ist, um größere Batterien und komplexe RF-Front-Ends in schlanke Gehäuse zu integrieren.
- RF-Module & Antenna-in-Package (AiP): 5G, insbesondere mmWave (24 GHz+), kann keine langen Strecken über Kupferleiterbahnen ohne massive Signalverluste zurücklegen. Daher sind die RF-Transceiver und Antennen in kompakten Modulen (AiP) integriert, die an den Rändern des Geräts platziert sind. Diese erfordern spezielle Hochfrequenzlaminate (Rogers, Tachyon oder LCP).
- Flexible Verbindungen (LCP/MPI): Die Verbindung des Mainboards mit diesen verteilten Antennenmodulen erfordert flexible Leiterplatten, die als Übertragungsleitungen fungieren. Liquid Crystal Polymer (LCP) und Modified Polyimide (MPI) sind hier die Standards, da sie feuchtigkeitsbeständig sind und bei hohen Frequenzen stabile Dielektrizitätskonstanten aufweisen.

Der fertigungstechnische Unterschied ist entscheidend: Standardmäßiges subtraktives Ätzen (wie bei 4G-Platinen verwendet) kann die für 5G-SLP erforderlichen feinen Linien nicht erreichen. Wir verlassen uns jetzt auf den mSAP (Modified Semi-Additive Process), bei dem Kupfer durch Galvanisieren aufgebaut statt weggeätzt wird, was vertikale Seitenwände und eine präzise Impedanzkontrolle gewährleistet.
Technisches Merkmal → Auswirkung auf Käufer
| Technisches Merkmal / Entscheidung | Direkte Auswirkung (Ertrag/Zuverlässigkeit) |
|---|---|
| mSAP (Modified Semi-Additive Process) | Ermöglicht <30 µm Leiterbahnbreite. Auswirkung: Erhöht die Bauteildichte um 40 %, was größere Batterien ermöglicht, erhöht jedoch die Fertigungskosten um 15-20 %. |
| Materialien mit niedrigem Dk/Df (z. B. Megtron 6) | Reduziert den Signalverlust bei >6 GHz. Auswirkung: Korreliert direkt mit dem 5G-Datendurchsatz und der Batterielebensdauer (weniger Energie für die Übertragung erforderlich). |
| Gestapelte Microvias (Any-Layer) | Ermöglicht eine vertikale Verbindung zwischen beliebigen Lagen. Auswirkung: Reduziert den Platzbedarf der Platine um bis zu 30 %, was für faltbare Telefone oder schlanke Profile unerlässlich ist. |
| Thermische Kupfer-Münzen / Pasten | Aktive Wärmeableitung. Auswirkung: Verhindert die Drosselung des Prozessors bei 5G-Downloads mit hoher Bandbreite. |
Wichtige Kennzahlen (Wie man sie bewertet)
In der 4G-Ära war die mechanische Zuverlässigkeit König. In der 5G-Ära teilen sich Signalintegrität (SI) und Thermische Integrität den Thron. Bei der Bewertung eines Designs oder einer fertigen Platine sind dies die nicht verhandelbaren KPIs.
| Kennzahl | Typischer 4G-Wert | Erforderlicher 5G-Wert | Warum es wichtig ist |
|---|---|---|---|
| Dk (Dielektrizitätskonstante) | 4.2 - 4.5 (Standard FR4) | 3.0 - 3.6 (Low Loss) | Ein niedrigeres Dk erhöht die Signalausbreitungsgeschwindigkeit und reduziert kapazitive Kopplungen (Übersprechen). |
| Df (Verlustfaktor) | 0.015 - 0.020 | < 0.005 (Ultra Low Loss) | Kritisch für mmWave. Ein hoher Df wandelt Signalenergie in Wärme um und zerstört Reichweite und Batterie. |
| Leiterbahnbreite / Abstand | 75 µm / 75 µm | 30 µm / 30 µm (SLP) | Unerlässlich für das Routing von 5G-Modems mit hoher Pin-Zahl und APs auf begrenztem Raum. |
| Impedanztoleranz | ±10% | ±5% oder ±7% | Eine strengere Kontrolle ist erforderlich, um Signalreflexionen bei hohen Frequenzen zu verhindern. |
| Wärmeleitfähigkeit | 0.3 - 0.5 W/mK | > 0.8 W/mK (oder Hybrid) | 5G-Chips werden heiß. Die Leiterplatte muss als Kühlkörper fungieren, um die Wärme an das Gehäuse abzuleiten. |
| Feuchtigkeitsaufnahme | < 0.5% | < 0.1% (LCP/PTFE) | Wasser ist polar und absorbiert RF-Energie. Eine hohe Absorption destabilisiert die Impedanz in feuchten Umgebungen. |
Wie man wählt (Material- & Designauswahl)
Die Wahl des richtigen Fundaments für Ihr 5G Phone PCB ist ein Balanceakt zwischen elektrischer Leistung, Herstellbarkeit und Kosten.
1. Materialauswahlstrategie
Sie können Standard-FR4 nicht für den gesamten Stackup eines 5G-Geräts verwenden. Die Verwendung von reinen Rogers/Teflon-Stacks ist jedoch für die Unterhaltungselektronik zu teuer. Die branchenübliche Lösung ist der Hybride Stackup.
- High-Speed-Lagen: Verwenden Sie Materialien wie Panasonic Megtron 6/7, Isola I-Tera MT40 oder spezielle High Frequency PCB-Laminate für die Lagen, die RF-Signale führen.
- Digital-/Power-Lagen: Verwenden Sie Standard-FR4 mit hohem Tg für Lagen, die nur die Stromverteilung oder langsame Steuersignale verarbeiten.
- Klebefolien (Prepregs): Low-Flow-Prepregs sind unerlässlich, um zu verhindern, dass Harz in Hohlräume fließt oder die Impedanz benachbarter Lagen beeinträchtigt.
2. Design für Signalintegrität
Bei mmWave-Frequenzen wird der "Skin-Effekt" dominant. Der Strom fließt nur auf der Außenhaut des Kupferleiters.
- Oberflächenrauheit: Sie müssen HVLP (Hyper Very Low Profile) Kupferfolie spezifizieren. Standard-Kupferrauheit wirkt wie "Bodenschwellen" für hochfrequente Signale und erhöht die Einfügedämpfung.
- Backdrilling: Stubs (Stummel) in Vias wirken als Antennen und verursachen Resonanz und Signalreflexion. Backdrilling (das Entfernen des ungenutzten Teils des durchkontaktierten Lochs) ist für Hochgeschwindigkeitsleitungen >10 Gbps obligatorisch.
3. Wärmemanagement
5G-Modems erzeugen erhebliche Hitze.
- Struktur: Verwenden Sie "Any-Layer"-HDI-Designs, um direkte Wärmepfade vom Bauteil zu den inneren Masseebenen zu schaffen.
- Materialien: Erwägen Sie das Einbetten von Kupfer-Münzen oder die Verwendung von leitfähigen Pasten in Vias direkt unter dem PMIC und PA (Leistungsverstärker).
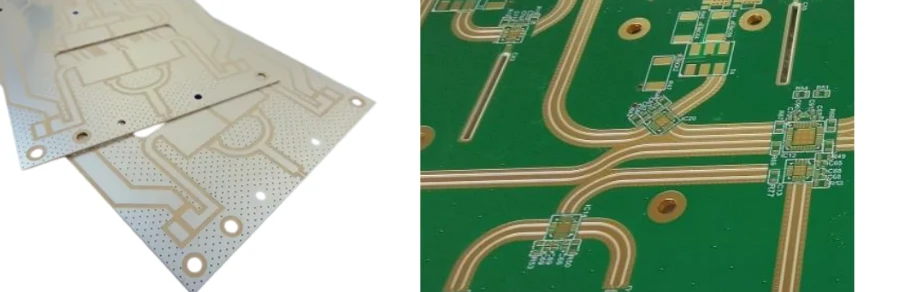
Implementierungs-Prüfpunkte (vom Design bis zur Fertigung)
Die Überführung einer 5G-Leiterplatte von einer CAD-Datei zu einer in Massenproduktion hergestellten Einheit birgt in jeder Phase spezifische Risiken. Bei APTPCB nutzen wir einen schrittweisen Prozess, um die Konformität sicherzustellen.
Implementierungs-Fahrplan
Vom Konzept zur Produktion
Bevor die CAM-Arbeit beginnt, simulieren wir den Stackup mit Field Solvern (wie Polar Si9000). Wir verifizieren, dass die hybriden Materialien (FR4 + Low Loss) hinsichtlich des CTE (Wärmeausdehnungskoeffizient) kompatibel sind, um Delamination beim Reflow zu verhindern.
Für Leiterbahnbreiten <40 µm umgehen wir die traditionelle Filmbelichtung. Wir verwenden Laser Direct Imaging (LDI) für hohe Präzision. Der mSAP-Prozess baut Kupfer auf einer dünnen Keimschicht auf und sorgt für vertikale Seitenwände für eine optimale RF-Leistung.
5G-Platinen verwenden oft 10-14 Lagen mit gestapelten Microvias. Die Registrierungsgenauigkeit ist kritisch. Wir verwenden Röntgen-Bohrziele, um die Lagen dynamisch auszurichten und Materialschrumpfung während der Laminierung zu kompensieren.
Die finale Qualitätskontrolle geht über Konnektivität hinaus. Wir führen TDR-Tests (Time Domain Reflectometry) an Coupons durch, um die Impedanz zu überprüfen. Für High-End-RF-Platinen testen wir möglicherweise auch auf passive Intermodulation (PIM), um die Signalreinheit sicherzustellen.
Häufige Fehler (und wie man sie vermeidet)
Selbst erfahrene Ingenieure können beim Wechsel zu 5G-Architekturen stolpern. Hier sind die häufigsten Fallstricke, die wir bei APTPCB sehen:
Den "Fiber Weave Effect" (Glasgewebe-Effekt) ignorieren: Wenn eine Leiterbahn bei Hochgeschwindigkeitssignalen parallel zum Glasfasergewebe des Leiterplattenmaterials verläuft, kann es zu periodischen Impedanzschwankungen (dem "Skew"-Effekt) kommen.
- Lösung: Verwenden Sie "Spread Glass"-Gewebe (wie 1067 oder 1078) oder verlegen Sie die Leiterbahnen in einem leichten Winkel (Zick-Zack-Routing) relativ zum Gewebe.
Unterschätzung der CTE-Fehlanpassung in Hybrid-Stacks: Das Mischen von Rogers-Material (niedriger CTE) mit Standard-FR4 (höherer CTE) kann dazu führen, dass sich die Platine verzieht oder Vias während der großen Hitze beim bleifreien Löten reißen.
- Lösung: Konsultieren Sie frühzeitig Ihren Hersteller. Wir können kompatible Prepregs empfehlen, die als Puffer zwischen ungleichen Kernmaterialien dienen.
Überspezifizierung von Materialien: Nicht jede Schicht muss aus Megtron 7 bestehen. Die Verwendung teurer Materialien für Energieebenen (Power Planes) ist Budgetverschwendung.
- Lösung: Optimieren Sie den Stackup. Belassen Sie High-Speed-Signale auf bestimmten Schichten und verwenden Sie ansonsten Standardmaterialien.
Vernachlässigung der Auswirkungen des Oberflächenfinishs: ENIG (Electroless Nickel Immersion Gold) ist beliebt, aber die Nickelschicht ist magnetisch und kann bei hohen Frequenzen Einfügedämpfung verursachen.
- Lösung: Ziehen Sie für 5G-RF-Leiterbahnen ISIG (Immersion Silver) oder ENEPIG in Betracht, die eine bessere Skin-Effekt-Leistung bieten.
Checkliste zur Lieferantenqualifizierung: Wie Sie Ihre Fabrik überprüfen
Bevor Sie einem Hersteller Ihr 5G-Design anvertrauen, stellen Sie diese spezifischen technischen Fragen. Ein "Ja" zu allen Punkten ist die Mindestanforderung für eine hochzuverlässige Produktion.
- Verfügen Sie über interne LDI-Kapazitäten (Laser Direct Imaging)? (Erforderlich für <50 µm Leiterbahnen).
- Können Sie Erfahrung mit der mSAP- oder SAP-Technologie nachweisen? (Erforderlich für SLP-Designs).
- Haben Sie einen speziellen Laminierungszyklus für Hybrid-Stackups? (Zur Bewältigung unterschiedlicher Aushärtungsraten von Materialien).
- Was ist Ihre Standard-Impedanztoleranz? (Sollte für 5G ±5 % bis ±7 % betragen).
- Führen Sie bei jeder Produktionscharge eine Querschliffanalyse durch? (Zur Überprüfung der Microvia-Integrität und der Schichtdicke).
- Haben Sie Hochfrequenzlaminate auf Lager (Rogers, Panasonic, Isola)? (Sichert die Stabilität der Lieferkette).
- Ist Ihre Röntgeninspektion in der Lage, gestapelte Microvias zu prüfen? (Entscheidend für Any-Layer HDI).
Glossar
mSAP (Modified Semi-Additive Process): Ein Leiterplattenherstellungsverfahren, bei dem Kupfer auf eine dünne Keimschicht plattiert wird, um Leiterbahnen zu bilden, anstatt Kupfer wegzuätzen. Dies ermöglicht viel feinere, rechteckigere Leiterbahnen im Vergleich zum herkömmlichen subtraktiven Ätzen.
SLP (Substrate-Like PCB): Eine Klasse von Leiterplatten, die die Lücke zwischen herkömmlichen Leiterplatten und IC-Substraten schließt. Sie zeichnet sich durch extrem hohe Dichte und feine Leiterbahnbreiten/-abstände aus (typischerweise <30 µm).
Dk (Dielektrizitätskonstante): Ein Maß für die Fähigkeit eines Materials, elektrische Energie in einem elektrischen Feld zu speichern. Für 5G wird ein niedriger und stabiler Dk-Wert bevorzugt, um die Signalgeschwindigkeit zu maximieren.
Df (Verlustfaktor): Ein Maß dafür, wie viel Signalenergie als Wärme im Leiterplattenmaterial verloren geht. Ein niedrigerer Df-Wert ist entscheidend für die Aufrechterhaltung der Signalstärke in 5G-Anwendungen.
MIMO (Multiple Input Multiple Output): Eine in 5G verwendete Antennentechnologie, bei der mehrere Antennen sowohl an der Quelle als auch am Ziel verwendet werden. Dies erfordert ein komplexes Leiterplatten-Routing, um mehrere RF-Ketten zu unterstützen.
6 wesentliche Regeln für 5G Phone PCBs (Spickzettel)
| Goldene Regel | Warum es wichtig ist | Implementierungsschlüssel |
|---|---|---|
| 1. Niedrigen Df priorisieren | Verhindert Signalverlust bei mmWave. | Verwenden Sie Materialien mit Df < 0,005. |
| 2. mSAP für Dichte verwenden | Ermöglicht <30 µm Leiterbahnen für SLP. | Überprüfen Sie die Fähigkeiten der Fabrik für SAP/mSAP. |
| 3. Stackup ausbalancieren | Verhindert Verziehen während des Reflow-Lötens. | Symmetrische Kupferverteilung. |
| 4. Thermische Vias sind Pflicht | 5G-Chips werden extrem heiß. | Direkt unter PMIC/PA-Pads platzieren. |
| 5. Impedanz frühzeitig simulieren | Vermeidet kostspielige Neuauflagen (Re-Spins). | Verwenden Sie Polar Si9000 vor dem Layout. |
| 6. Oberflächenfinish beachten | Nickel kann Signalverlust verursachen. | Bevorzugen Sie Immersion Silver oder OSP für RF. |
FAQ
F: Was ist der Hauptunterschied zwischen 4G- und 5G-Leiterplattenfertigung?
A: Der Hauptunterschied liegt in der Dichte und den Materialanforderungen. 5G-Leiterplatten nutzen die Substrate-Like PCB (SLP)-Technologie mit Leiterbahnbreiten unter 30 µm (die mSAP-Prozesse erfordern) und integrieren Materialien mit extrem niedrigem Verlust, um mmWave-Frequenzen zu verarbeiten, während 4G-Boards typischerweise Standard-HDI mit subtraktivem Ätzen und Standard-FR4 verwenden.
F: Warum wird ein "Hybrider Stackup" für 5G-Telefone empfohlen?
A: Ein hybrider Stackup balanciert Leistung und Kosten aus. Hochfrequenzmaterialien (wie Rogers oder Megtron) sind teuer und werden nur auf Schichten verwendet, die RF-Signale führen. Standard-FR4 wird für Energie- und digitale Schichten verwendet, um die Gesamtkosten der Platine für die Massenproduktion tragfähig zu halten.
F: Wie bewältigt APTPCB die thermischen Herausforderungen von 5G-Leiterplatten?
A: Wir wenden verschiedene Strategien an, einschließlich der Verwendung von Laminaten mit hoher Wärmeleitfähigkeit, dem direkten Einbetten von Kupfer-Münzen in die Leiterplatte und der Nutzung dichter Arrays von kupfergefüllten thermischen Vias. Unser Leiterplattenbestückungs-Prozess gewährleistet außerdem hohlraumfreies Löten auf Wärmepads, um die Wärmeübertragung zu maximieren.
F: Wie lange ist die Vorlaufzeit für einen 5G SLP-Prototyp?
A: Aufgrund der Komplexität der mSAP-Verarbeitung und der Laminierungszyklen benötigen 5G SLP-Prototypen in der Regel 10-15 Werktage. Standard-HDI-Platinen für 5G-Anwendungen können jedoch je nach Lagenzahl und Materialverfügbarkeit oft in 5-8 Tagen hergestellt werden.
F: Kann ich ein Standard-ENIG-Finish für 5G-Platinen verwenden?
A: Während ENIG zuverlässig ist, kann die Nickelschicht aufgrund des Skin-Effekts bei sehr hohen Frequenzen (mmWave) Einfügedämpfung verursachen. Für kritische RF-Leiterbahnen empfehlen wir häufig Immersion Silver, ENEPIG oder OSP, die bessere Hochfrequenzeigenschaften aufweisen.
F: Unterstützen Sie die Herstellung von Antenna-in-Package (AiP)-Substraten?
A: Ja, wir verfügen über Kapazitäten für die Herstellung von IC-Substraten und AiP-Modulen, wobei wir fortschrittliche BT- und ABF-Materialien mit Fine-Pitch-Flip-Chip-Bondpads verwenden, um integrierte 5G-Antennenmodule zu unterstützen.
Fordern Sie ein Angebot / DFM-Review für 5G Phone PCBs an
Sind Sie bereit, Ihr 5G-Design vom Konzept in die Realität umzusetzen? Unser Engineering-Team ist bereit, Ihren Stackup zu überprüfen und einen umfassenden DFM-Bericht zu erstellen.
- Gerber-Dateien (RS-274X oder ODB++): Stellen Sie sicher, dass alle Layer klar sind.
- Fertigungszeichnung: Spezifizieren Sie Materialanforderungen (z. B. "Panasonic Megtron 6 oder gleichwertig").
- Stackup-Diagramm: Geben Sie High-Speed-Lagen und Impedanzanforderungen an.
- Bohrtabelle: Definieren Sie klar die Strukturen für Blind/Buried Vias.
- Mengen: Schätzungen für Prototypen im Vergleich zur Massenproduktion.
Fazit
Das "5G Phone PCB" stellt den Gipfel moderner Verbindungstechnologie dar. Es ist eine Konvergenz von Materialwissenschaft, Wärmetechnik und nanometergenauer Fertigung. Erfolg in diesem Bereich erfordert mehr als nur einen Lieferanten; er erfordert einen Partner, der die Physik hochfrequenter Signale und die Realitäten der Massenproduktion versteht.
Bei APTPCB haben wir unsere Linien für die 5G-Ära optimiert, von mSAP-Fähigkeiten bis hin zu rigoroser Impedanzkontrolle. Egal, ob Sie ein Flaggschiff-Smartphone, einen industriellen 5G-Router oder ein IoT-Gateway bauen, unser Team ist gerüstet, um Platinen zu liefern, die Leistung erbringen.
Kontaktieren Sie uns noch heute, um Ihr Projekt zu besprechen, oder erkunden Sie unsere High Frequency PCB Fähigkeiten, um mehr darüber zu erfahren, wie wir die nächste Generation der Konnektivität vorantreiben.