اللوحة العارية أصبحت جاهزة. لقد اجتازت اختبار TDR للمعاوقة، وفحص المقاطع الميكروية، والتحقق من رقم دفعة مادة Rogers. والآن تنتقل إلى تجميع SMT، وهنا تظهر مجموعة ثانية من أنماط الفشل التي لا تستطيع عملية تصنيع اللوحة وحدها منعها.
يعد تجميع لوحات RO3003 أكثر تعقيداً من تجميع FR-4 القياسي في أربع نقاط محددة: إدارة الرطوبة قبل دخول الخط، وتصميم stencil معجون اللحام للبنى التي تحتوي على via تحت thermal pad، وأجواء وملف حرارة reflow، ثم فحص وصلات اللحام المخفية بعد التجميع. ولكل نقطة من هذه النقاط ممارسة مثلى محددة بوضوح. وإذا تم تجاهل واحدة فقط، فستظهر المشكلة على شكل voiding تحت thermal pad، أو delamination عند الواجهة الهجينة بين PTFE وFR-4، أو أعطال في الوصلات تظهر خلال أول مئة دورة حرارية.
يغطي هذا الدليل كل هذه النقاط الأربع بالتفصيل: ما المشكلة، وما شكل الحل العملي في العملية، وما معايير القبول.
أربعة متغيرات في التجميع لا تستطيع إعدادات FR-4 القياسية التعامل معها
قبل الدخول في خطوات التجميع واحدة واحدة، من المفيد فهم ما الذي يجعل RO3003 غير مناسب لإعدادات FR-4 القياسية، ليس بوصفه "مختلفاً" فقط، بل لأنه قد يؤدي فعلياً إلى فشل.
تشطيب السطح Immersion Silver. تصل معظم لوحات RO3003 المحسنة لتطبيقات RF مع تشطيب ImAg، وهو الخيار المفضل لأن ترسيبه الرقيق والمسطح شفاف كهرومغناطيسياً عند الترددات العالية. وعلى عكس ENIG، فإن ImAg يتعرض للتشوه أو الاسوداد عند التعرض لمركبات الكبريت أو لدرجات حرارة مرتفعة. لذلك فهو يحتاج إلى reflow في أجواء نيتروجين وإلى ملف حراري مضبوط بدقة، وهو ما لا توفره خطوط FR-4 القياسية العاملة بــ air reflow.
حساسية الركيزة الهجينة للرطوبة. على الرغم من أن RO3003 نفسه لا يمتص تقريباً أي رطوبة (0.04%)، فإن طبقات FR-4 الداخلية في اللوحة الهجينة استرطابية. والرطوبة التي تصل إلى واجهة الربط بين RO3003 وFR-4 أثناء دورة reflow عند 250°C يمكن أن تتحول إلى بخار بشكل مفاجئ وتسبب delamination داخلياً. لذلك يجب أن تعالج بروتوكولات prebake طبقات FR-4 نفسها، لا أن تتعامل مع اللوحة كوحدة أحادية المادة.
مصفوفات POFV الحرارية. إن الـ vias المملوءة والمطلية فوقها أسفل thermal pad الخاص بترانزيفرات RF تخلق تحدياً خاصاً في SMT: إذ قد ينهار معجون اللحام المطبوع فوق المصفوفة داخل البراميل أثناء reflow إذا لم يأخذ تصميم فتحات الـ stencil ذلك في الحسبان. والنتيجة هي void يسد مسار التبريد الرئيسي ولا يمكن لأي إعادة عمل أن تستعيده. وحتى في مرحلة التصميم، فإن طريقة ملء الـ via وتغطيته هي التي تحدد مدى استواء سطح الهبوط، وهذا يؤثر مباشرة في تجانس ترسيب المعجون فوق المصفوفة. أما اللوحات التي لا يكون فيها cap plating الخاص بـ POFV مستوياً مع سطح pad فستظهر فيها فراغات متوقعة في المناطق المنخفضة مهما كانت هندسة الـ stencil.
سقف أقل لدرجة الحرارة القصوى في reflow. يبدأ سلوك التمدد الحراري لمادة PTFE فوق 250°C في فرض إجهاد على الواجهة بين مصفوفة PTFE وطلاء نحاس barrel الخاص بالـ via بطريقة لا تنطبق على لوحات FR-4. ولهذا يتم تقييد منحنى reflow كما سيتضح في الأقسام التالية.
إن فهم هذه القيود في مرحلة تخطيط التجميع، وليس بعد أول تشغيل لفحص 3D X-ray، هو ما يميز تجميع RO3003 عالي العائد عن دورات إعادة العمل المكلفة.
Prebake للرطوبة: حماية الواجهة الهجينة قبل reflow
فيزياء delamination الناتج عن البخار
يبلغ معدل امتصاص FR-4 القياسي للرطوبة نحو 0.1-0.5% بالوزن بعد التعرض لظروف محيطة عادية. وفي اللوحة الهجينة التي بقيت في مستودع غير مضبوط، أو شحنت في حاوية، أو بقيت عدة أيام في الفحص الوارد، يمكن لطبقات FR-4 الداخلية أن تمتص رطوبة من الهواء عبر أي حافة مكشوفة من اللوحة.
وأثناء reflow، عندما ترتفع حرارة اللوحة عبر المجال 200–250°C، تتحول المياه الممتصة عند واجهة FR-4/RO3003 إلى بخار. ويكون التمدد الحجمي هنا كبيراً جداً. وإذا لم يتمكن البخار من الخروج قبل أن يتجمد اللحام وتبرد اللوحة، فإن الضغط الناتج يخلق فقاعات delamination على خط الربط الهجين، وتظهر في المقطع العرضي على شكل انفصال بين الطبقة الخارجية RO3003 ولب FR-4.
هذا عيب ينهي الاعتمادية. فقد تجتاز اللوحة المنفصلة كل فحوص وصلات اللحام، لكنها تفشل حرارياً لأن واجهة FR-4/RO3003 لم تعد متصلة ميكانيكياً بشكل مستمر.
بروتوكول الـ prebake
تقوم APTPCB بإجراء prebake لجميع اللوحات الهجينة RO3003/FR-4 مباشرة قبل دخولها خط SMT. وتعمل دورة الخبز هذه على طرد الرطوبة الممتصة من طبقات FR-4 من دون أكسدة تشطيب ImAg بشكل عدواني، وهو توازن بين الوقت ودرجة الحرارة يجب توصيفه لكل نوع من أنواع البنية.
بعد اكتمال عملية الخبز، تدخل اللوحات إلى خط SMT خلال دقائق. وأي تعرض جديد للهواء المحيط بين الـ bake ومرحلة reflow يعيد إدخال الرطوبة؛ أي إن قيمة الـ prebake تضيع إذا بقيت اللوحات ساعات في درجة حرارة الغرفة قبل دخول الخط.
أما في البرامج التي لا يمكن فيها التحكم بالنافذة الزمنية بين prebake وreflow، مثل الحالات التي تخبز فيها اللوحات في موقع وتجمع في موقع آخر، فإن النهج الأكثر أماناً هو إبقاء اللوحات مغلقة داخل moisture barrier bags حتى دخول الخط وجدولة الخبز مباشرة قبل placement، مع تنسيق نهاية الـ bake مع وقت تجهيز الماكينة لا مع جدول أمر العمل العام.
تصميم stencil بنمط window-pane: إزالة الفراغات تحت thermal pad
لماذا تفشل فتحات الـ stencil الكاملة على thermal pads
تطبع فتحة الـ stencil القياسية لـ thermal pad في حزمة QFN طبقة واحدة متصلة من معجون اللحام تغطي كامل مساحة pad. وأثناء reflow، تتنشط كيمياء الـ flux في المعجون، وتؤدي وظيفتها في تنظيف سطح النحاس، ثم تحتاج إلى التنفيس عبر اللحام المنصهر. وعندما يكون pad كبيراً ومسطحاً وفيه ترسيب عجينة واحد متصل، لا يجد بخار الـ flux أي مسار للهروب، فيتكون على شكل voids تحت البركة المنصهرة ويظل محبوساً بعد تصلب اللحام.
وفي لوحات RO3003 التي تحتوي على مصفوفات POFV تحت thermal pad، يصبح الوضع أسوأ: فالفراغات الواقعة مباشرة فوق أعمدة الـ via تحجب مسار التبريد الرئيسي. ويمكن لفراغ كبير واحد فوق مجموعة من براميل النحاس أن يرفع درجة حرارة الوصلة محلياً بدرجة ملحوظة فوق ما توقعه التصميم الحراري. وهذه الخسارة في الهامش تؤثر مباشرة في اعتمادية RFIC تحت الدورات الحرارية.
تصميم فتحات window-pane
يقسم stencil بنمط window-pane فتحة thermal pad إلى شبكة من المقاطع الصغيرة يفصل بينها شرائط خالية من المعجون، بعرض نموذجي 0.15–0.20mm. والفكرة هي أنه أثناء reflow يخرج بخار الـ flux عبر هذه الفتحات قبل أن يتجمد اللحام. وتندمج الترسيبات الصغيرة معاً عندما ينصهر اللحام، لكن قنوات التنفيس تبقى مفتوحة مدة كافية لخروج الغاز.
معلمات window-pane لبنى thermal pad في RO3003:
- مساحة كل فتحة مفردة: ≤1.5 × 1.5mm
- عرض الشريط الفاصل: 0.15–0.20mm
- إجمالي تغطية المعجون: 50–80% من مساحة thermal pad
- سماكة الـ stencil: 0.12–0.15mm بما يتوافق مع الـ pads الطرفية المجاورة
هذه الهندسة، مع reflow في أجواء النيتروجين كما في القسم التالي، تحقق بشكل ثابت مستوى voiding أقل من 10% على thermal pads في مصفوفات POFV المصممة جيداً. وللدقة في الأرقام: يحدد IPC-A-610 Class 3 حد القبول عند 30% من voiding التراكمي، بينما يضع APTPCB حداً داخلياً أكثر صرامة عند 20%. أما الرقم الأقل من 10% فهو القدرة الفعلية التي تحققها العملية في الإنتاج بهذه الهندسة، أي ما يقدمه الخط فعلاً وليس الحد الذي يحاكم عليه.
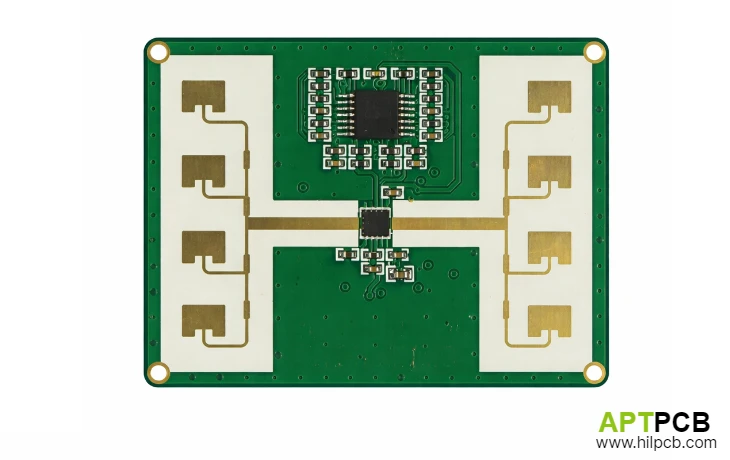
Reflow بالنيتروجين: الأجواء والمنحنى والأهداف الحرارية
لماذا يكون النيتروجين مطلوباً لتجميع ImAg/RO3003
يؤدي reflow بالهواء عند درجات حرارة تجميع وحدات RF إلى آليتي فشل:
اسوداد ImAg. يتأكسد تشطيب Immersion Silver عند درجات الحرارة المرتفعة في أجواء تحتوي على الأكسجين. ويفقد السطح المتأكسد قابليته للحام، فلا يبتل اللحام بشكل متجانس، فتظهر وصلات مفتوحة أو تغطية لحام ذات فراغات مرتفعة على pads كانت تبدو نظيفة قبل reflow.
أكسدة مسحوق اللحام. تطور جسيمات معجون اللحام أغشية أكسيد على سطحها أثناء مرحلة الارتفاع الحراري عندما تحتوي أجواء الفرن على أكسجين. وتزيد هذه الأغشية لزوجة اللحام أثناء reflow، وتقلل قوة الابتلال، وتعزز تكوّن الفراغات في كل وصلات اللحام وليس فقط تحت thermal pads.
تعمل أفران reflow في APTPCB الخاصة بوحدات RO3003 RF في أجواء نيتروجين نقي مع أكسجين متبق أقل من 500 ppm. وعند هذا المستوى تكون أكسدة سطح ImAg مهملة طوال الدورة الحرارية، كما تكون قدرة ترطيب معجون اللحام أفضل بشكل واضح من reflow بالهواء.
منحنى reflow للوحات RO3003 الهجينة
| المرحلة | الهدف | القيد |
|---|---|---|
| Ramp التسخين المسبق | 1.5–2°C/ثانية | إذا كانت أسرع من اللازم: صدمة حرارية لواجهة FR-4/RO3003 |
| منطقة soak وتفعيل flux | 150–180°C لمدة 60–90 ثانية | إذا كانت غير كافية: تفعيل ناقص للـ flux وتكوّن فراغات |
| درجة الحرارة القصوى | 245–250°C | الحد الأقصى 260°C؛ وخفض القمة يقلل الإجهاد عند واجهة PTFE/النحاس |
| الزمن فوق liquidus عند 183°C | 30–45 ثانية | إذا طال أكثر: يزداد الإجهاد الحراري؛ وإذا قصر: لا يكتمل الاندماج |
| معدل التبريد | ≤3°C/ثانية | إذا كان أسرع: صدمة حرارية لخط الربط الهجين |
تكون القمة 245–250°C أقل من القيم 255–260°C الشائعة على خطوط FR-4. وهذا الخفض مقصود، لأن سلوك التمدد الحراري لـ PTFE فوق 250°C يبدأ في إجهاد الواجهة بين مصفوفة PTFE وطلاء النحاس في barrel الخاص بالـ via. لذلك فإن قمة أقل مع زمن كاف فوق liquidus لإكمال اندماج اللحام تعطي اعتمادية أفضل على المدى الطويل لوصلات اللحام على ركائز RO3003.
وكلما أمكن، يجب حصر عدد مرات reflow فوق 220°C في مرتين فقط. وإذا تطلبت إعادة العمل مروراً ثالثاً، فيجب تقييم سلامة واجهة PTFE/FR-4 قبل إعادة اللوحة إلى الخدمة.
اعتبارات وضع المكونات في ترانزيفرات RF
Coplanarity الخاصة بـ thermal pad
تحتوي شرائح RF في حزم QFN وchip-scale عادة على thermal pad مكشوف يجب أن يلامس ترسيب اللحام فوق POFV بشكل متجانس. ولذا يجب أن يكون تفاوت ارتفاعات أرجل الحزمة ضمن ارتفاع طبقة معجون اللحام حتى يلامس thermal pad المعجون باستمرار.
قبل دخول الخط، يجب التحقق من أن coplanarity الخاصة بالمكوّن ضمن 0.05mm. أما المكونات التي تتجاوز هذا الحد فتنتج تماساً غير متجانس على thermal pad مع فراغات متوقعة عند الزاوية أو الزوايا المرتفعة، حتى ولو كان تصميم stencil بنمط window-pane صحيحاً.
Pads موصلات RF ذات الخطوة الدقيقة
تتضمن الكثير من وحدات RF موصلات edge-launch للوصول الاختباري. وعادة ما تكون بخطوة 0.5mm أو أقل. وعلى لوحات RO3003 ذات تشطيب ImAg، تمثل استوائية التشطيب ميزة، لأن الطبقة الرقيقة والمسطحة من ImAg لا تخلق فرق الارتفاع الذي يسببه HASL. وتحتاج هذه البنى الدقيقة إلى فحص SPI لمعجون اللحام قبل placement لتأكيد حجم المعجون وتسجيله قبل وضع أي مكوّن.
اعتبارات underfill في البيئات القاسية
تعاني وحدات RF العاملة في البيئات القاسية، مثل خارج المركبات أو المحطات القاعدية الخارجية أو التطبيقات المحمولة جواً، من مستويات اهتزاز ومعدلات صدمة حرارية قد تتجاوز عمر التعب في وصلات BGA الكبيرة إذا لم يستخدم underfill. وعند استخدام مكونات BGA على لوحات RO3003، يجب أن يراعي اختيار مادة underfill كلّاً من الالتصاق بسطح ImAg والتوافق مع عازل RO3003، لأن جميع التركيبات لا تبتل بشكل مناسب على الركائز المبنية على PTFE.
فحص الأشعة السينية ثلاثي الأبعاد: الطريقة الوحيدة لرؤية ما يهم
ما الذي لا يراه AOI
بعد reflow، تلتقط أنظمة Automated Optical Inspection القياسية صوراً للتجميع من الأعلى. وفي حالة ترانزيفرات RF من نوع QFN، حيث تكون كل وصلات اللحام مخفية تحت جسم المكون، وحزم BGA التي تكون كراتها محصورة بالكامل، وthermal pads المكشوفة التي لا ترى إلا عبر المكون نفسه، فإن AOI لا يرى شيئاً مهماً. فالمكونات الأكثر أهمية في لوحة RF عالية التردد هي بالتحديد المكونات التي يكون AOI أعمى عنها.
ويمثل فحص الأشعة ثنائي الأبعاد تحسناً، لكنه لا يكفي مع بنى POFV، لأن الإسقاط ثنائي الأبعاد يدمج في صورة واحدة أعمدة النحاس في الـ via، وطبقة اللحام فوقها، وطبقات اللوحة أسفلها. لذلك لا يمكن قياس مساحة الفراغ في طبقة اللحام بشكل معزول.
3D AXI مع التصوير المقطعي المحوسب
تعيد أنظمة 3D Automated X-Ray Inspection من APTPCB بناء نموذج حجمي عالي الدقة انطلاقاً من إسقاطات متعددة الزوايا. ويقوم مهندسو الجودة بقطع الطبقة الدقيقة لطبقة اللحام، معزولة عن نحاس الـ via فوقها وعن طبقات اللوحة أسفلها، ثم يقيسون:
- النسبة الإجمالية التراكمية للفراغات على thermal pad
- أبعاد كل فراغ وموقعه
- قرب الفراغ من أعمدة POFV via
معايير قبول الفراغات في تجميع RO3003 لدى APTPCB:
| المعيار | IPC-A-610 Class 3 | المعيار الداخلي لـ APTPCB |
|---|---|---|
| إجمالي الفراغات على thermal pad | ≤30% | ≤20% |
| أي فراغ منفرد | غير محدد | ≤5% من مساحة pad |
| أي فراغ فوق POFV thermal via | غير محدد | عدم السماح إطلاقاً |
إن معيار عدم السماح بأي فراغ فوق via حرارية ليس موجوداً في IPC-A-610، بل هو اشتراط خاص بـ APTPCB مشتق من المحاكاة الحرارية. فالفراغ الواقع مباشرة فوق عمود نحاسي مملوء يقطع مسار سحب الحرارة الرئيسي من وصلة RFIC إلى chassis. والنتيجة هي تشغيل فوق الحد الأقصى لحرارة الوصلة، يبدأ بضغط تدريجي في الكسب ثم ينتهي بعطل الجهاز. ولا يمكن لأي هامش تصميم أن يعوض مساراً حرارياً مكسوراً.
First Article Inspection لبرامج تجميع RO3003
قبل إطلاق دفعات الإنتاج، تجري APTPCB First Article Inspection لبرامج تجميع RO3003. وتشمل FAI الخاصة بوحدة RF ما يلي:
- فحص 3D AXI بنسبة 100% لجميع المكونات ذات الوصلات السفلية
- مقطع microsection لمجموعة ممثلة من الوصلات، thermal pad مع الـ pads الطرفية
- قياس المقاومة الحرارية على مسار RFIC إذا كان الوصول الاختباري يسمح بذلك
- توثيق منحنى reflow لمجموعة اللوحة/الفرن المحددة
- بيانات SPI لمعجون اللحام من أول دورة طباعة إنتاجية
وتصبح وثائق FAI هي baseline التي تقاس عليها عينات دفعات الإنتاج. وإذا بدأ اتجاه الفراغات في الارتفاع أثناء الإنتاج، فإن بيانات FAI توضح ما إذا كان الانحراف في أداء الـ stencil، أو في حجم المعجون، أو في منحنى الفرن، من دون الاضطرار إلى إعادة بناء تحليل السبب الجذري من البداية.
لماذا يهم دمج التصنيع مع التجميع في RO3003
إن أكثر طريقة موثوقة لتنفيذ تجميع RO3003 هي ألا يتم فصله عن تصنيع اللوحة. فعندما تنفذ صناعة اللوحة العارية وتجميع SMT بواسطة الفريق نفسه وفي المنشأة نفسها:
- يتم التحكم في توقيت الـ prebake عبر الجدول نفسه الذي يدير تحميل الخط
- تتم إدارة عمر ImAg التخزيني مع معرفة مباشرة بتاريخ تصنيع اللوحة
- تكون بيانات استواء سطح POFV من التصنيع متاحة لمهندس التجميع الذي يصمم فتحات الـ stencil
- تعود نتائج voiding من 3D AXI مباشرة إلى فريق التصنيع باعتبارها مؤشراً على أداء العملية
أما عندما ينقسم التصنيع والتجميع بين مورّدين، فإن المسؤولية عن مشاكل الفراغات تتفتت: فيعزوها مورّد التجميع إلى استواء POFV أو إلى تدهور ImAg أثناء الشحن، ويعزوها مصنع اللوحة إلى منحنى reflow. ويبقى OEM هو من يتحمل المسؤولية وتأخير الجدول.
وتغطي خدمة APTPCB المتكاملة تصنيع Rogers RO3003 PCB حتى تجميع SMT مع وثائق DFM مشتركة، وتخزين مشترك في الموقع، ونظام جودة واحد IATF 16949 يغطي مرحلتي العملية كلتيهما.
وإذا كان برنامجك قد واجه بالفعل voiding غير متوقع في الإنتاج، أو كنت تقيّم تصميم الـ stencil قبل أول تشغيل للنموذج الأولي، فإن أسرع طريق تشخيص هو مقارنة بيانات مقاطع 3D AXI مع baseline الخاصة بـ FAI وربطها بسجلات الزمن بين prebake وreflow. فمعظم مشاكل voiding المستمرة في برامج RO3003 تعود إلى واحد من ثلاثة متغيرات: انجراف الفترة بين prebake وreflow، أو عمر ImAg منذ التصنيع، أو تآكل الـ stencil عبر الإنتاج. تواصل مع فريق هندسة التجميع لدينا مع بيانات 3D AXI الخاصة بك، وغالباً ما نستطيع تحديد السبب الجذري قبل طلب stencil جديد.
المراجع
- قبول فراغات SMT وفق IPC-A-610 Acceptability of Electronic Assemblies, Class 3.
- إرشادات منحنى reflow وأجواء النيتروجين من APTPCB High-Frequency SMT Assembly Control Plan (2026).
- متطلبات prebake الخاصة بالرطوبة وفق IPC-1601 Printed Board Handling and Storage Guidelines.
- متطلبات POFV وفق IPC-4761 Design Guide for Protection of Printed Board Via Structures.