Для обеспечения долгосрочной надежности сборки Ball Grid Array (BGA) необходим строгий неразрушающий контроль, особенно в части рентгеновских критериев для пустот в BGA и дефекта head-in-pillow (HiP). В отличие от видимых паяных соединений, контакты BGA скрыты под корпусом компонента, поэтому стандартный оптический контроль здесь недостаточен. Для инженеров и специалистов по качеству в APTPCB критически важно точно понимать пределы приемки и браковки, заданные стандартами IPC, чтобы исключать полевые отказы, вызванные термоциклической усталостью или прерывистым электрическим контактом. В этом руководстве описаны характерные рентгеновские признаки, измеримые пороги и меры управления процессом, необходимые для подтверждения целостности BGA.
Краткий ответ (30 секунд)
Для надежной сборки BGA рентгеновские критерии для пустот в BGA и дефекта head-in-pillow обычно опираются на стандарты IPC-7095 и IPC-A-610.
- Предел по пустотам: Для IPC класса 2 и класса 3 суммарная площадь пустот внутри одного паяного шара обычно не должна превышать 25% площади этого шара.
- Head-in-pillow (HiP): Этот дефект рассматривается как индикатор процесса и в общем случае не допускается. Он выглядит как явное разделение или отсутствие сплавления между шаром припоя и паяльной пастой, словно шар лежит на подушке.
- Обнаружение: Пустоты видны на 2D-рентгене в режиме просвечивания. Для HiP часто требуются наклонные 2D-снимки (2.5D) или 3D-ламинаграфия (CT), потому что вертикальное перекрытие может скрыть дефект при виде сверху.
- Критичное расположение: Пустоты на границе между паяным шаром и площадкой компонента считаются более опасными и часто ведут к браковке независимо от размера из-за риска роста трещин.
- Подтверждение: Системы автоматизированного рентгеновского контроля (AXI) должны быть откалиброваны так, чтобы различать безвредные макропустоты и критические планарные микропустоты.
Когда применяются рентгеновские критерии для пустот в BGA и дефекта head-in-pillow (и когда нет)
Понимание границ применения контроля позволяет направить ресурсы на реальные риски надежности, а не на косметические отклонения.
Когда эти критерии применяются:
- Сборка BGA и CSP: Любой компонент, у которого паяные соединения скрыты корпусом, требует рентгеновской проверки по этим критериям.
- Изделия с высокой надежностью: В автомобильной, аэрокосмической и медицинской электронике (IPC класс 3) термоциклирование может превратить пустоты в трещины.
- Валидация процесса: На этапе контроля первой статьи (FAI) для настройки профиля оплавления.
- Поиск причин прерывистых отказов: Когда плата проходит электрический тест, но отказывает при вибрации или тепловой нагрузке.
- Введение новых корпусов: При запуске QFN или LGA с крупными тепловыми площадками, где требования к пустотам немного отличаются, хотя физика процесса остается той же.
Когда эти критерии не применяются или трактуются иначе:
- Стандартные выводные компоненты: Рентген может проверить заполнение металлизированного отверстия, но критерии пустот для BGA нельзя напрямую переносить на соединения после пайки волной.
- Видимые крыловидные выводы: Здесь обычно предпочтителен автоматический оптический контроль (AOI); рентген нужен только для специальных задач, например оценки пяточного филета.
- Тепловые площадки QFN/LGA: Для крупных тепловых площадок пределы по пустотам часто мягче, иногда до 50% по отдельным соглашениям с заказчиком, чем для сигнальных шаров BGA.
- Применение подзаливки: После нанесения подзаливки рентгеновский контраст меняется, и поиск пустот усложняется; оценку нужно проводить до этой операции.
- Косметические поверхностные дефекты: Рентген просвечивает компонент насквозь, поэтому царапины на корпусе к этим критериям не относятся.
Правила и спецификации
В таблице ниже приведены технические параметры, по которым оценивают целостность BGA. Она переводит общие рентгеновские критерии для пустот в BGA и дефекта head-in-pillow в измеримые контрольные точки.
| Правило / параметр | Рекомендуемое значение / диапазон | Почему это важно | Как проверять | Что будет, если игнорировать |
|---|---|---|---|---|
| Суммарная доля пустот | < 25% площади рентгеновского изображения (IPC класс 2/3) | Крупные пустоты ухудшают тепловую и электрическую проводимость и ослабляют механическую прочность. | Расчет площади в ПО AXI. | Разрушение соединения при термоциклировании. |
| Наибольшая одиночная пустота | < 20% площади шара | Одна крупная полость создает значительную концентрацию напряжений. | Измерение диаметра крупнейшей области с пониженной плотностью. | Немедленный механический отказ при ударной нагрузке. |
| Признак head-in-pillow (HiP) | 0% (брак) | Указывает на отсутствие металлургической связи; соединение держится только за счет остатков флюса или механического прижатия. | Наклонный рентген 45-70° или анализ 3D-CT-срезов. | Прерывистые обрывы цепи в эксплуатации. |
| Диаметр паяного шара | ±15% от номинала по техническому листу | Отклонения указывают на растяжение из-за коробления или на чрезмерное сжатие. | Сравнительное измерение с эталонными шарами. | Непропаи или короткие замыкания. |
| Перемычка / короткое замыкание | 0 (не допускается) | Это прямой электрический отказ. | Плотное соединение между соседними площадками на рентгеновском снимке. | Мгновенный функциональный отказ. |
| Деформация угловых шаров | < 25% удлинения | Углы испытывают максимальную термонагрузку; удлинение говорит о чрезмерном короблении. | Геометрический анализ угловых шаров относительно центральных. | Cratering площадки или усталость припоя. |
| Межфазные пустоты | 0% (жесткий контроль) | Пустоты на границе с площадкой часто предвосхищают отказ типа Black Pad. | Высокократное рентгеновское увеличение с фокусом на плоскость площадки. | Катастрофический хрупкий излом. |
| Обедненное соединение | Объем > 75% от номинала | Недостаточный перенос пасты приводит к слабым соединениям. | Интегрирование уровней серого для объемной оценки. | Слабые соединения, чувствительные к вибрации. |
| Popcorn-эффект / разрыв | 0 случаев | Показывает, что влага внутри корпуса взорвалась во время оплавления. | Неровная, разорванная форма паяного шара. | Разрушение компонента и расслоение. |
| Выравнивание / смещение | < 25% ширины площадки | Смещение уменьшает площадь контакта и повышает риск перемычек. | Измерение расстояния между центрами шара и площадки. | Снижение надежности и возможные короткие замыкания. |
| Угол смачивания | Видимый галтельный переход, если он наблюдаем | Хорошее смачивание показывает корректную работу флюса и качество покрытия площадки. | 3D-реконструкция или микрошлиф. | Дефекты несмачивания и растекания назад. |
| Сферичность паяного шара | > 0.85 (отношение сторон) | Несферичная форма, если она не заложена конструктивно, говорит о неполном оплавлении или загрязнении. | ПО для анализа формы. | Плохое самоцентрирование во время оплавления. |
Этапы внедрения
Для внедрения надежного процесса контроля по рентгеновским критериям для пустот в BGA и дефекта head-in-pillow нужен системный подход. Только так можно получить точные и пригодные к действию данные.
Определить класс приемки: Установите, требуется ли изделию IPC класс 2 (стандартная надежность) или класс 3 (высокая производительность). От этого зависит строгость допустимого процента пустот.
- Действие: Обновить пороговые значения в ПО AXI.
- Проверка: Подтвердить соответствие требований заказчика определениям IPC.
Откалибровать рентгеновское оборудование: Перед сканированием напряжение трубки и ток мишени должны быть настроены под толщину платы и количество слоев.
- Действие: Прогнать эталонный образец или калибровочную пластину.
- Проверка: Убедиться в достаточном контрасте и разрешении изображения, например видны ли проводники шириной 2 mil.
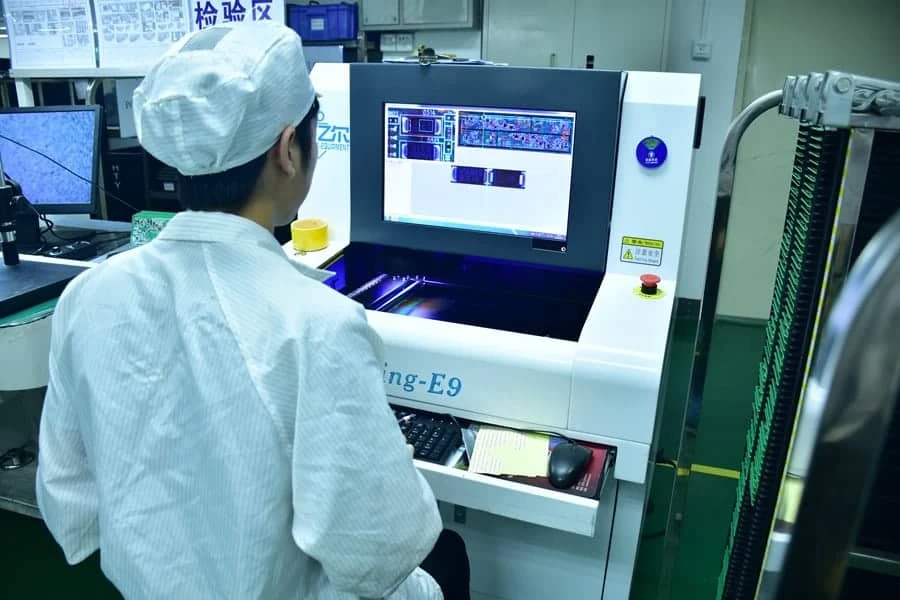
- Сформировать эталонное изображение:
Просканируйте заведомо годную плату, чтобы задать базовые значения оттенков серого для паяных соединений. Это помогает системе различать припой, медь и пустоты.
- Действие: Обучить систему AXI расположению компонентов по файлу размещения.
- Проверка: Проверить, что все выводы BGA распознаются корректно.

Выполнить 2D-сканирование сверху: Проведите быстрый обзорный контроль, чтобы выявить грубые дефекты, такие как перемычки, отсутствие шаров или крупные пустоты.
- Действие: Автоматически рассчитать процент пустот.
- Проверка: Пометить любой шар с площадью пустоты более 25%.
Выполнить наклонное или 3D-сканирование (критично для HiP): При виде сверху дефект head-in-pillow часто скрыт. Поэтому нужно наклонить детектор или повернуть образец.
- Действие: Проверить угловые шары и крупные корпуса BGA под углом 45-60 градусов.
- Проверка: Искать форму снеговика или разделительные линии внутри паяного шара.
Проанализировать расположение пустот: Если пустоты обнаружены, важно определить, находятся ли они в центре, что менее критично, или на границе площадки, что критично.
- Действие: При 3D-рентгене настроить глубину фокуса.
- Проверка: Браковать любую плату с планарными микропустотами на поверхности площадки.
Сопоставить результаты с профилем оплавления: Если дефекты найдены, их нужно привязать к расположению на плате.
- Действие: Проверить, не группируются ли дефекты в холодных или горячих зонах печи.
- Проверка: Скорректировать время выше ликвидуса (TAL), если пустоты носят системный характер.
Обеспечить регистрацию данных и прослеживаемость: Рентгеновские изображения и результаты приемки должны сохраняться вместе с серийным номером PCB.
- Действие: Экспортировать отчет в систему управления качеством.
- Проверка: Убедиться, что изображения можно поднять для будущих аудитов.
Виды дефектов и поиск причин
Если рентгеновские критерии для пустот в BGA и дефекта head-in-pillow не выполняются, это обычно указывает на проблему на более ранней стадии процесса. Ниже приведена карта симптомов и первопричин.
1. Симптом: высокий процент пустот (>25%)
- Причины: Летучие компоненты, запертые в пасте, слишком короткий профиль оплавления, окисленные площадки.
- Проверки: Проверить срок годности паяльной пасты; подтвердить длительность стадии выдержки.
- Исправление: Увеличить время в зоне выдержки, чтобы летучие вещества успели выйти до расплавления.
- Профилактика: Для изделий с высокой надежностью использовать вакуумное оплавление.
2. Симптом: head-in-pillow (HiP)
- Причины: Коробление компонента, недостаточный объем пасты, эффект подушки во время оплавления.
- Проверки: Измерить копланарность компонента; проверить, не забиты ли апертуры трафарета.
- Исправление: Использовать трафарет со ступенчатым увеличением толщины для большего нанесения пасты; скорректировать скорость охлаждения под CTE корпуса.
- Профилактика: Ввести строгий входной контроль PCBA, чтобы отбраковывать деформированные компоненты и платы.
3. Симптом: перемычки припоя
- Причины: Избыточный объем пасты, слишком большое усилие установки, растекание пасты.
- Проверки: Проверить толщину трафарета и уменьшение апертур, обычно требуется 10-15%.
- Исправление: Очистить нижнюю сторону трафарета; уменьшить усилие установки.
- Профилактика: Оптимизировать конструкцию трафарета с правильными отношениями сторон.
4. Симптом: несмачивание (разомкнутое соединение)
- Причины: Окисление площадок, просроченный флюс, недостаточный нагрев.
- Проверки: Проверить условия хранения PCB с учетом MSL; убедиться в корректной пиковой температуре.
- Исправление: Просушить PCB для удаления влаги; повысить пиковую температуру, не повреждая компоненты.
- Профилактика: Правильно использовать покрытия ENIG или OSP в пределах их срока хранения.
5. Симптом: шарики-сателлиты
- Причины: Влага в пасте, слишком быстрый нагрев.
- Проверки: Проверить влажность в помещении печати; подтвердить скорость нагрева ниже 3 °C/с.
- Исправление: Подкорректировать скорость разогрева; перед печатью довести пасту до комнатной температуры.
- Профилактика: Поддерживать строгие климатические условия в зоне SMT.
6. Симптом: popcorn-эффект
- Причины: Поглощение влаги корпусом BGA.
- Проверки: Проверить отслеживание Moisture Sensitivity Level (MSL).
- Исправление: Просушить компоненты по J-STD-033 перед сборкой.
- Профилактика: Хранить чувствительные компоненты в сухих шкафах или в азотной среде.
Конструкторские решения
Возможность выполнить рентгеновские критерии для пустот в BGA и дефекта head-in-pillow сильно зависит от конструкции PCB. Эти факторы нужно учитывать еще на этапе разводки, чтобы упростить и сборку, и контроль.
Тип площадки (SMD или NSMD):
- NSMD (Non-Solder Mask Defined): Обычно это более удачный выбор для BGA. Медная площадка меньше окна в маске, поэтому шар лучше обтекает медь, что улучшает механическое удержание и самоцентрирование.
- SMD (Solder Mask Defined): Маска перекрывает медь. Это может создавать концентрацию напряжений, откуда стартуют трещины, хотя при очень малом шаге такой вариант иногда применяют для снижения риска перемычек.
Технология переходных отверстий в площадке:
- Открытые vias в площадках BGA часто становятся причиной пустот. Припой уходит в via, оставляя обедненное соединение или захваченный воздух.
- Решение: Применять закрытые и заполненные vias (VIPPO) в площадках BGA. Это дает ровную поверхность и заметно снижает потери припоя и риск пустот.
Размещение и ориентация компонентов:
- Не размещайте тяжелые компоненты, например трансформаторы или экраны, вплотную к BGA. Разница в тепловой массе ведет к неравномерному нагреву, короблению и дефектам HiP.
- Обеспечьте вокруг BGA достаточный зазор для наклонного рентгеновского контроля. Высокие соседние компоненты могут перекрыть обзор и сделать 2.5D-контроль невозможным.
Конструкция трафарета:
- Для BGA с малым шагом квадратные апертуры со скругленными углами обычно лучше отдают пасту, чем круглые отверстия.
- Электрополированные трафареты улучшают перенос пасты и снижают риск недостатка припоя, который способствует появлению HiP.
Подробные рекомендации по разводке приведены в наших руководствах DFM.
FAQ
1. Чем отличается IPC класс 2 от класса 3 в части пустот BGA? В общем случае и класс 2, и класс 3 ограничивают пустоты значением 25% площади шара. Однако класс 3 для высоконадежных изделий может содержать более жесткие требования заказчика к расположению пустот, например полный запрет межфазных пустот, а также требует более строгой документации по процессу.
2. Может ли 2D-рентген обнаружить дефект head-in-pillow? Редко. На 2D-виде сверху шар и паста перекрываются и выглядят соединенными, даже если между ними есть вертикальный зазор. Чтобы увидеть разделяющий слой, нужен наклонный рентген или 3D-ламинаграфия.
3. Допускается ли ремонт, если BGA не прошел рентгеновский контроль? Да. Ремонт BGA является стандартной процедурой: компонент снимают, площадку очищают и припаивают новую деталь. Но многократный ремонт может повредить площадки. Поэтому APTPCB ограничивает число циклов ремонта для сохранения целостности платы.
4. Почему пустоты чаще возникают в центре шара? Основная причина заключается в дегазации флюса. Когда припой плавится от внешней поверхности к центру, летучие компоненты выталкиваются к середине, то есть в последнюю затвердевающую область. Центральные пустоты обычно менее опасны, чем пустоты на границе площадки.
5. Как финишное покрытие влияет на head-in-pillow? Окисленная поверхность, например состарившееся OSP, мешает пасте нормально смачивать площадку. В результате паста остается отделенной от шара. Покрытие ENIG обычно дает лучшее смачивание и снижает риск HiP, если отсутствует дефект Black Pad.
6. Что означает эффект снеговика на рентгеновском снимке? Это типичный визуальный признак дефекта head-in-pillow или неполного оплавления при наклонном просмотре. Паяный шар лежит на расплавленной пасте, но не сливается с ней, поэтому изображение напоминает снеговика.
7. Снижает ли оплавление в азоте количество пустот? Да. Азот уменьшает окисление паяемых поверхностей во время оплавления и улучшает смачивание. Лучшее смачивание помогает пузырькам газа легче выходить из расплавленного припоя и уменьшает суммарную долю пустот.
8. Может ли AOI заменить рентген для BGA? Нет. AOI работает только в пределах прямой видимости. Иногда он позволяет проверить крайние ряды выводов или положение компонента, но не видит соединения под корпусом BGA. Для BGA рентген обязателен.
9. Как влияет на стоимость 100% рентгеновский контроль? Полный рентгеновский контроль медленный и увеличивает стоимость. В массовом производстве обычно используют выборочный план, например по уровням AQL, либо проверяют только сложные BGA, а для остальных полагаются на валидацию процесса.
10. Как предотвратить HiP, вызванный короблением? Используйте материалы PCB с высокой Tg, балансируйте распределение меди в стеке, чтобы избежать изгиба, и оптимизируйте скорость охлаждения в профиле оплавления. Сплав с более низкой температурой, например SnBi, тоже может снизить термонапряжения, хотя меняет механические свойства.
11. Что такое пустота типа Champagne? Это особый тип межфазной пустоты, когда множество мелких полостей собирается в области интерметаллического слоя. Такой дефект очень опасен, потому что создает слабую плоскость разрушения и часто связан с проблемами покрытия.
12. Как APTPCB организует контроль BGA? Для NPI и сложных сборок мы используем продвинутые возможности 3D-рентгена. Дополнительно мы сочетаем их со SPI, чтобы предупреждать дефекты еще до установки компонента.
Связанные страницы и инструменты
- Услуги по производству PCB: Ознакомьтесь с нашими возможностями по выпуску многослойных и HDI-плат, подходящих для сборок BGA.
- Рентгеновский контроль: Узнайте, как мы проверяем скрытые паяные соединения, включая пустоты и HiP, при производстве PCBA.
- Связаться с нами: Получите техническую поддержку по вашим требованиям к надежности BGA.
- Руководства DFM: Скачайте наши правила проектирования для оптимизации платы под производство и контроль.
Глоссарий (ключевые термины)
| Термин | Определение |
|---|---|
| BGA (Ball Grid Array) | Корпус поверхностного монтажа для интегральных схем, в котором выводы выполнены в виде матрицы паяных шаров. |
| Head-in-pillow (HiP) | Дефект, при котором шар BGA лежит на паяльной пасте, но не сплавляется с ней в единое соединение. |
| Пустота | Воздушная или газовая полость, захваченная внутри паяного соединения. |
| Ламинаграфия | 3D-рентгеновская методика, формирующая послойные изображения PCB для контроля отдельных слоев. |
| Интерметаллическое соединение (IMC) | Химический слой между припоем и медной площадкой; он необходим для связи, но становится хрупким при чрезмерной толщине. |
| Копланарность | Максимальная разница по высоте между самым высоким и самым низким паяным шаром компонента; плохая копланарность приводит к непропаям. |
| Смачивание | Способность расплавленного припоя растекаться по металлической поверхности и сцепляться с ней. |
| Профиль оплавления | Кривая температура-время, которую PCB проходит в печи; критична для активации флюса и плавления припоя. |
| Высота зазора после пайки | Расстояние между нижней поверхностью корпуса и поверхностью PCB после пайки. |
| IPC-7095 | Отраслевой стандарт, специально описывающий проектирование и реализацию процесса сборки BGA. |
Заключение
Глубокое понимание рентгеновских критериев для пустот в BGA и дефекта head-in-pillow нужно не только для соблюдения стандарта, но и для защиты ресурса и безопасности конечного изделия. Если придерживаться ограничений IPC, применять 3D-контроль и понимать первопричины дефектов, можно существенно сократить количество полевых отказов, связанных со сборкой BGA.
В APTPCB эти процедуры контроля встроены в стандартный производственный поток. От строгого входного контроля до расширенного рентгеновского анализа мы добиваемся того, чтобы каждая плата соответствовала требуемому уровню надежности. Если вы работаете со сложными BGA-конструкциями или задачами по надежности, наша инженерная команда готова провести подробный технический разбор.
