Голая плата уже готова. Она прошла TDR-проверку импеданса, microsection-инспекцию и верификацию партии материала Rogers. Теперь она переходит в SMT-сборку, и именно на этом этапе появляется вторая группа отказов, которые изготовление самой платы предотвратить не может.
Сборка плат RO3003 технически сложнее стандартной сборки на FR-4 в четырех конкретных зонах: управление влажностью перед входом в линию, проектирование stencil для нанесения паяльной пасты на структуры via под thermal pad, атмосфера и температурный профиль reflow, а также постсборочная инспекция скрытых паяных соединений. Для каждой из этих зон существует четкая best practice. Стоит пропустить хотя бы одну, и это проявится как void под thermal pad, деламинация на гибридном интерфейсе PTFE/FR-4 или дефекты пайки, которые станут видны уже в первые сто тепловых циклов.
В этом материале подробно разобраны все четыре пункта: в чем проблема, как выглядит технологическое решение и какие критерии приемки применяются.
Четыре сборочные переменные, с которыми настройки FR-4 не справляются
Прежде чем переходить к отдельным этапам сборки, полезно точно понять, что именно в RO3003 делает стандартные параметры FR-4 недостаточными, не просто "иными", а прямо провоцирующими дефекты.
Поверхностное покрытие Immersion Silver. Большинство RF-оптимизированных плат RO3003 поставляются с покрытием ImAg. Это предпочтительный вариант, потому что тонкий ровный слой электромагнитно прозрачен на высоких частотах. В отличие от ENIG, ImAg тускнеет при воздействии сернистых соединений или повышенной температуры. Для него необходимы reflow в атмосфере азота и точный тепловой профиль, чего стандартные FR-4-линии с воздушным reflow не обеспечивают.
Чувствительность гибридной подложки к влаге. Хотя сам RO3003 почти не поглощает влагу (0,04 %), внутренние слои FR-4 в гибридной плате гигроскопичны. Влага, которая во время цикла reflow при 250°C мигрирует к интерфейсу склейки RO3003/FR-4, может мгновенно превратиться в пар и вызвать внутреннюю деламинацию. Поэтому протокол prebake должен учитывать именно слои FR-4, а не рассматривать плату как однородную конструкцию из одного материала.
Тепловые массивы POFV. Заполненные и затем перекрытые медью via под thermal pad RF-трансиверов создают специфическую SMT-проблему: паста, напечатанная поверх такого массива, может проваливаться в barrel во время reflow, если это не учтено в конструкции stencil aperture. В результате возникает void, который блокирует основной тепловой путь, и никакая доработка уже не восстановит теплопередачу. Еще на стадии проектирования способ заполнения и запайки via определяет, насколько плоской будет посадочная поверхность, а значит, и насколько равномерно распределится паста по массиву. Платы, у которых POFV cap plating не находится заподлицо с поверхностью pad, будут предсказуемо показывать void в зонах просадки независимо от геометрии stencil.
Более низкий предел пиковой температуры reflow. Тепловое расширение PTFE при температурах выше 250°C начинает нагружать интерфейс между матрицей PTFE и медным покрытием barrel via так, как это не происходит на FR-4-платах. Это ограничивает профиль reflow, как будет подробно показано ниже.
Понимание этих ограничений еще на этапе планирования сборки, а не после первого запуска 3D X-ray, и отличает высоковыходную сборку RO3003 от дорогой череды переделок.
Предварительная сушка по влаге: защита гибридного интерфейса до reflow
Физика паровой деламинации
Стандартное влагопоглощение FR-4 составляет примерно 0,1-0,5 % по массе после нахождения в обычных окружающих условиях. Если гибридная плата находилась на неконтролируемом складе, ехала в контейнере или просто несколько дней пролежала на входном контроле, внутренние слои FR-4 могут впитать влагу из воздуха через любой открытый край платы.
Во время reflow, когда температура платы проходит диапазон 200–250°C, поглощенная вода на интерфейсе FR-4/RO3003 превращается в пар. Объемное расширение при этом очень велико. Если пар не успеет выйти до затвердевания припоя и охлаждения платы, возникающее давление создаст пузыри деламинации по линии гибридного соединения, которые в сечении выглядят как разделение внешнего слоя RO3003 и сердечника FR-4.
Это дефект, который убивает надежность. Деламинированная плата может пройти все инспекции пайки. Она выйдет из строя по теплу, потому что интерфейс FR-4/RO3003 больше не остается механически непрерывным.
Протокол предварительной сушки
APTPCB выполняет prebake всех гибридных плат RO3003/FR-4 непосредственно перед входом в SMT-линию. Этот цикл выводит поглощенную влагу из слоев FR-4, не вызывая агрессивного окисления покрытия ImAg. Это компромисс по температуре и времени, который приходится отдельно характеризовать для каждого типа конструкции платы.
После завершения bake платы попадают в SMT-линию в течение нескольких минут. Повторное воздействие окружающего воздуха между bake и reflow снова приводит к набору влаги; эффект prebake теряется, если плата часами ждет при комнатной температуре до входа в линию.
Для программ, где окно между prebake и reflow невозможно строго контролировать, например если платы запекаются на одной площадке, а собираются на другой, самый безопасный подход - держать платы запечатанными в moisture barrier bags до самого входа в линию и планировать bake непосредственно перед placement, увязывая завершение bake со временем настройки автомата, а не с общим производственным расписанием.
Трафарет window-pane: устранение void под thermal pad
Почему сплошные апертуры на thermal pad дают сбой
Стандартная aperture stencil для thermal pad корпуса QFN печатает один непрерывный объем паяльной пасты по всей площади pad. Во время reflow химия flux активируется, очищает медную поверхность и должна дегазироваться через расплавленный припой. На большой плоской площадке с единым непрерывным пастовым отпечатком этому пару некуда выйти: он образует void под расплавом и остается запертым после затвердевания припоя.
На RO3003-платах с массивами POFV под thermal pad ситуация еще хуже: void непосредственно над колоннами via блокирует основной путь отвода тепла. Один крупный void над группой медных barrel может заметно повысить локальную температуру перехода относительно того, что было заложено в тепловом расчете. Потеря этого запаса напрямую бьет по надежности RFIC при термоциклировании.
Конструкция апертур типа window-pane
Stencil window-pane делит aperture thermal pad на сетку более мелких сегментов, разделенных свободными от пасты перемычками шириной обычно 0,15–0,20 мм. Принцип простой: во время reflow пары flux выходят через эти зазоры до того, как припой затвердеет. Небольшие пастовые отложения сливаются при плавлении припоя, но каналы отвода остаются открытыми достаточно долго, чтобы газ успел выйти.
Параметры window-pane для thermal pad структур на RO3003:
- Площадь отдельного сегмента aperture: ≤1,5 × 1,5 мм
- Ширина перемычки: 0,15–0,20 мм
- Общий coverage пасты: 50–80 % площади thermal pad
- Толщина stencil: 0,12–0,15 мм, в согласовании с соседними периферийными pad
Такая геометрия aperture в сочетании с reflow в азоте, описанным в следующем разделе, стабильно дает уровень voiding ниже 10 % на правильно спроектированных POFV-массивах. Если говорить точнее о числах: IPC-A-610 Class 3 устанавливает предел приемки на уровне 30 % суммарного voiding; внутренний предел APTPCB жестче и составляет 20 %. Значение "ниже 10 %" - это реальная process capability, достигаемая в серийном производстве с такой геометрией stencil, то есть фактический результат процесса, а не граница оценки.
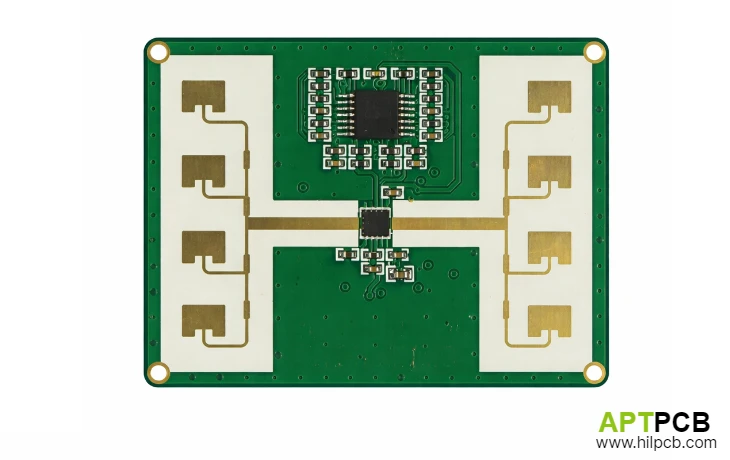
Reflow в азоте: атмосфера, профиль и температурные цели
Почему азот обязателен для сборки ImAg/RO3003
Воздушный reflow при температурах сборки RF-модулей вводит два механизма отказа:
Потускнение ImAg. Immersion Silver окисляется при повышенной температуре в кислородсодержащей атмосфере. Потускневшая поверхность ImAg теряет паяемость; припой смачивает неравномерно, что приводит к открытым соединениям или к зонам пайки с высоким содержанием void на pad, которые до reflow казались чистыми.
Окисление порошка припоя. Частицы паяльной пасты образуют оксидную пленку на этапе ramp, когда в атмосфере печи есть кислород. Эти пленки увеличивают вязкость припоя в reflow, уменьшают силу смачивания и способствуют образованию void во всех паяных соединениях, а не только под thermal pad.
Печи reflow APTPCB для RO3003 RF-модулей работают в чистой атмосфере азота при остаточном кислороде ниже 500 ppm. На таком уровне окисление поверхности ImAg на всем протяжении теплового цикла незначительно, а смачиваемость паяльной пасты заметно лучше, чем при воздушном reflow.
Профиль reflow для гибридных плат RO3003
| Этап | Целевое значение | Ограничение |
|---|---|---|
| Ramp предварительного нагрева | 1,5–2°C/секунда | Слишком быстро: термоудар по интерфейсу FR-4/RO3003 |
| Зона soak, активация flux | 150–180°C, 60–90 секунд | Недостаточно: неполная активация flux, образование void |
| Пиковая температура | 245–250°C | Максимум 260°C; более низкий пик снижает нагрузку на интерфейс PTFE/медь |
| Время выше liquidus, 183°C | 30–45 секунд | Дольше: больше теплового стресса; меньше: неполная коалесценция |
| Скорость охлаждения | ≤3°C/секунда | Быстрее: термоудар по линии гибридного соединения |
Пик 245–250°C ниже, чем 255–260°C, типичные для FR-4-линий. Это сделано намеренно: тепловое расширение PTFE выше 250°C начинает нагружать интерфейс между матрицей PTFE и медным покрытием barrel via. Более низкая пиковая температура при достаточном времени выше liquidus для полного слияния припоя обеспечивает лучшую долговременную надежность соединений на подложках RO3003.
По возможности число проходов reflow выше 220°C следует ограничивать двумя. Если переделка требует третьего прохода, целостность интерфейса PTFE/FR-4 нужно оценить до возврата платы в эксплуатацию.
Особенности размещения компонентов для RF-трансиверов
Копланарность thermal pad
RF IC в корпусах QFN и chip-scale обычно имеют открытый thermal pad, который должен равномерно контактировать с паяльным отложением над POFV. Копланарность корпуса, то есть разброс высоты выводов по корпусу, должна укладываться в высоту пастового отпечатка, чтобы thermal pad стабильно касался пасты.
Перед входом в линию нужно убедиться, что копланарность компонента находится в пределах 0,05 мм. Компоненты, выходящие за этот порог, дают неравномерный контакт по thermal pad и предсказуемые void в поднятых углах даже при правильной stencil window-pane.
Fine-pitch pad RF-разъемов
Во многих RF-модулях используются edge-launch RF-разъемы для тестового доступа. Обычно их pitch составляет 0,5 мм или меньше. На RO3003-платах с покрытием ImAg плоскостность покрытия становится преимуществом: тонкий планарный слой ImAg не создает перепада высоты, как это было бы у HASL. Такие fine-pitch структуры требуют SPI-контроля отпечатка паяльной пасты до установки компонентов, чтобы подтвердить объем пасты и совмещение еще до placement.
Underfill для жестких условий эксплуатации
RF-модули, работающие в жестких условиях - снаружи автомобиля, на уличных базовых станциях или в авиационных применениях, - испытывают уровни вибрации и теплового удара, которые могут превысить ресурс по усталости паяных соединений крупных BGA без underfill. Если на RO3003-платах используются BGA-компоненты, при выборе underfill нужно учитывать адгезию к поверхности ImAg и совместимость с диэлектриком RO3003, потому что не все составы достаточно хорошо смачивают PTFE-основанные подложки.
3D-рентгеновская инспекция: единственный способ увидеть то, что действительно важно
Что не видит AOI
После reflow стандартные камеры Automated Optical Inspection фотографируют сборку сверху. Для RF-трансиверов в корпусах QFN, у которых все пайки скрыты под корпусом, для BGA с полностью закрытыми шариками и для открытых thermal pad, видимых только через сам компонент, AOI не видит ничего существенного. Самые важные компоненты на высокочастотной RF-плате - как раз те, перед которыми AOI слепа.
2D-рентген улучшает ситуацию, но для структур POFV этого недостаточно: 2D-проекция накладывает в одно изображение медные via-колонны, слой припоя над ними и слои платы под ними. Изолированно измерить площадь void именно в слое припоя невозможно.
3D AXI с компьютерной томографией
Системы 3D Automated X-Ray Inspection от APTPCB строят высокоразрешающую объемную модель по многим угловым проекциям. Инженеры по качеству срезают точно плоскость слоя припоя, отделяя ее от via-меди сверху и слоев платы снизу, и измеряют:
- Общий суммарный процент void по thermal pad
- Размеры и положение отдельных void
- Близость void к колоннам POFV via
Критерии приемки voiding при сборке RO3003 в APTPCB:
| Критерий | IPC-A-610 Class 3 | APTPCB внутренний |
|---|---|---|
| Общий voiding thermal pad | ≤30% | ≤20% |
| Любой одиночный void | Не задано | ≤5% площади pad |
| Любой void над POFV thermal via | Не задано | Нулевая терпимость |
Критерий нулевой терпимости для void над thermal via отсутствует в IPC-A-610; это внутреннее требование APTPCB, основанное на тепловом моделировании. Void непосредственно над заполненной медной via-колонной разрывает основной тепловой путь от перехода RFIC к шасси. Результат - работа выше максимальной температуры перехода, сначала с постепенной компрессией усиления, а затем с отказом устройства. Никакой заложенный запас в конструкции не компенсирует разрушенный тепловой путь.
Инспекция первого изделия для программ сборки RO3003
Перед выпуском серийных партий APTPCB проводит First Article Inspection для проектов сборки RO3003. Для RF-модуля FAI включает:
- 100% 3D AXI всех bottom-terminated компонентов
- Microsection представительного набора соединений, thermal pad плюс периферийные pad
- Измерение теплового сопротивления по пути RFIC, если есть доступ для тестирования
- Документацию профиля reflow для конкретной комбинации платы и печи
- Данные SPI паяльной пасты из первого серийного цикла печати
Документация FAI становится baseline, относительно которой оценивается выборка серийных лотов. Если в производственной выборке растет тренд по voiding, именно данные FAI показывают, связано ли отклонение с работой stencil, объемом пасты или профилем печи, без необходимости каждый раз восстанавливать root cause с нуля.
Почему интеграция изготовления и сборки важна для RO3003
Самый надежный способ выполнять сборку RO3003 - не отделять ее от изготовления платы. Когда изготовление голой платы и SMT-сборка выполняются одной командой на одной площадке:
- время prebake контролируется тем же графиком, который управляет загрузкой линии
- срок хранения ImAg отслеживается с прямым знанием даты изготовления платы
- данные по планарности поверхности POFV из fabrication доступны инженеру по сборке, который проектирует stencil aperture
- результаты по voiding из 3D AXI напрямую возвращаются команде fabrication как индикатор производительности процесса
Когда fabrication и assembly разделены между двумя поставщиками, ответственность за проблемы с voiding распадается: сборщик объясняет их планарностью POFV или деградацией ImAg в транспортировке, изготовитель платы винит профиль reflow. Вся ответственность и задержка при этом ложатся на OEM.
Turnkey-сервис APTPCB охватывает Rogers RO3003 PCB fabrication и SMT assembly с общей DFM-документацией, совместным хранением на одной площадке и единой системой качества IATF 16949 для обоих этапов процесса.
Если в вашем проекте уже появились неожиданные void в производстве или вы оцениваете stencil design перед первым запуском прототипа, самый быстрый путь диагностики - сравнить срезы 3D AXI с baseline FAI и сопоставить их с журналами времени между prebake и reflow. Большинство устойчивых проблем voiding в программах RO3003 сводится к одной из трех переменных: дрейф интервала prebake/reflow, возраст ImAg с момента изготовления или износ stencil в серии. Свяжитесь с нашей инженерной командой по сборке и передайте данные 3D AXI - как правило, мы можем определить root cause еще до заказа нового stencil.
Источники
- Допустимость void в SMT по IPC-A-610 Acceptability of Electronic Assemblies, Class 3.
- Рекомендации по профилю reflow и атмосфере азота из APTPCB High-Frequency SMT Assembly Control Plan (2026).
- Требования к prebake по влаге по IPC-1601 Printed Board Handling and Storage Guidelines.
- Требования к POFV по IPC-4761 Design Guide for Protection of Printed Board Via Structures.