Punti Chiave
- Definizione: La qualità della scheda base per ottica co-packaged si riferisce all'integrità del segnale, alla stabilità termica e alla planarità meccanica del substrato PCB che ospita sia l'ASIC che il motore ottico.
- Metriche Critiche: La perdita di inserzione ad alte frequenze (112G/224G PAM4) e il controllo della deformazione (warpage) sono i due indicatori di qualità più significativi.
- Selezione dei Materiali: L'FR-4 standard è insufficiente; materiali a perdita ultra-bassa (come Megtron 8 o Rogers) sono obbligatori per le applicazioni CPO.
- Gestione Termica: La qualità è spesso determinata dalla capacità della scheda di dissipare il calore dall'ASIC senza influenzare i componenti ottici sensibili alla temperatura.
- Precisione di Fabbricazione: La registrazione degli strati e la precisione della profondità di backdrilling devono essere più rigorose rispetto ai requisiti standard IPC Classe 3.
- Validazione: I test devono andare oltre la continuità elettrica standard per includere misurazioni TDR (Time Domain Reflectometry) e VNA (Vector Network Analysis).
- Impatto sull'Assemblaggio: La planarità della scheda base determina direttamente la resa del processo di
assemblaggio della scheda base per ottica co-packaged.
Cosa significa realmente la qualità della scheda base per ottica co-packaged (ambito e limiti)
Per comprendere i requisiti specifici di questa tecnologia, dobbiamo prima definire l'ambito della qualità delle schede base per ottiche co-packaged. A differenza delle ottiche pluggable tradizionali, dove il ricetrasmettitore si trova sulla piastra frontale, le ottiche co-packaged (CPO) spostano il motore ottico sullo stesso substrato dell'ASIC dello switch. Questo cambiamento modifica radicalmente il ruolo della scheda base (PCB).
La scheda base non è più solo un supporto per l'alimentazione e i segnali a bassa velocità. Diventa parte integrante del collegamento ottico ad alta velocità. La qualità in questo contesto è definita dalla capacità della scheda di supportare velocità di trasmissione dati estreme (spesso 51,2 Tbps o superiori per chip) mantenendo la rigidità meccanica sotto significativo stress termico.
Presso APTPCB (APTPCB PCB Factory), definiamo la qualità delle schede base CPO attraverso tre lenti principali:
- Integrità del segnale: La capacità di trasmettere segnali ad alta frequenza su brevi distanze con attenuazione minima.
- Affidabilità termica: La capacità di gestire il flusso di calore da un ASIC ad alta potenza mantenendo le ottiche fresche.
- Stabilità meccanica: La resistenza alla deformazione durante il reflow, fondamentale per l'allineamento preciso delle fibre ottiche e degli interposer.
Se un produttore non può garantire un controllo rigoroso dell'impedenza e della planarità, la Co-packaged optics baseboard fallirà, indipendentemente dalla qualità dei chip montati su di essa.
Metriche importanti (come valutare la qualità)
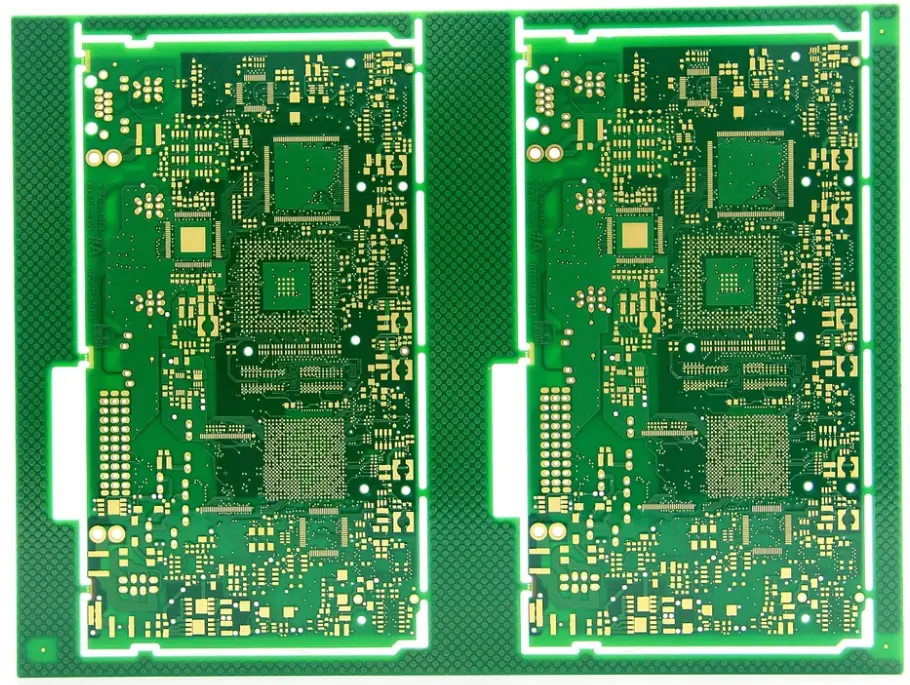
Basandosi sulla definizione dell'ambito, dobbiamo quantificare la qualità utilizzando punti dati specifici e misurabili. La seguente tabella illustra le metriche critiche utilizzate per valutare la qualità delle schede base con ottiche co-packaged.
| Metrica | Perché è importante | Intervallo tipico o fattori influenzanti | Come misurare |
|---|---|---|---|
| Perdita di Inserzione (IL) | Un'elevata perdita degrada il segnale prima che raggiunga il motore ottico, causando errori di bit. | < 0.8 dB/pollice @ 56 GHz (a seconda del materiale). | Analizzatore di Rete Vettoriale (VNA). |
| Impedenza Differenziale | Le disadattamenti causano riflessioni del segnale (perdita di ritorno), riducendo la larghezza di banda effettiva. | 85Ω o 100Ω ± 5% (più stretto dello standard ±10%). | TDR (Riflettometria nel Dominio del Tempo). |
| Deformazione della Scheda (Incurvamento/Torsione) | Una deformazione eccessiva impedisce il corretto posizionamento del grande ASIC e dei motori ottici durante l'assemblaggio. | < 0.5% (spesso < 0.1% per interposer CPO). | Interferometria Moiré a Ombra. |
| CTE (asse z) | Un'elevata espansione rompe i fori passanti placcati (PTH) e le microvie durante il ciclo termico. | < 40 ppm/°C (sotto Tg); La scelta del materiale è fondamentale. | TMA (Analisi Termomeccanica). |
| Precisione di Registrazione | Il disallineamento degli strati rovina il percorso del segnale nelle interconnessioni ad alta densità (HDI). | ± 25µm o migliore per costruzioni avanzate. | Ispezione a Raggi X. |
| Rugosità Superficiale | Il rame ruvido crea perdite per "effetto pelle" ad alte frequenze (100G+). | < 2µm (Rz); Utilizzare fogli di rame HVLP o VLP. | Profilometro / SEM. |
| Conducibilità Termica | Il calore deve allontanarsi dall'ASIC in modo efficiente per prevenire la degradazione ottica. | > 0,6 W/mK (dielettrico); L'equilibrio del rame è vitale. | Metodo del Flash Laser. |
| Transizione Vetrosa (Tg) | Determina la temperatura alla quale la scheda diventa meccanicamente instabile. | > 180°C (È richiesta un'alta Tg per l'assemblaggio senza piombo). | DSC (Calorimetria Differenziale a Scansione). |
Guida alla selezione per scenario (compromessi)
Una volta comprese le metriche, il passo successivo è selezionare i materiali e gli stackup giusti per la vostra applicazione specifica. Non esiste una soluzione "unica per tutti" per la qualità delle schede base per ottiche co-packaged. Scenari diversi richiedono la prioritizzazione di attributi diversi.
Scenario 1: Il Core ad Altissima Velocità (224G SerDes)
- Priorità: Integrità del Segnale.
- Compromesso: Il costo è secondario.
- Guida: È necessario utilizzare i materiali a più bassa perdita disponibili. I laminati standard ad alta velocità potrebbero non essere sufficienti. Cercare materiali con un Fattore di Dissipazione (Df) di 0,002 o inferiore.
- Materiale Consigliato: Panasonic Megtron 8 o laminati avanzati simili.
- Focus del Design: Le lunghezze di traccia più corte possibili e la retroforatura sono obbligatorie.
Scenario 2: Lo Switch per Data Center ad Alta Densità
- Priorità: Densità di Routing e Conteggio Strati.
- Compromesso: La complessità di produzione aumenta.
- Indicazioni: Queste schede superano spesso i 40 strati. La sfida è la registrazione. È necessario un produttore in grado di realizzare HDI avanzati (Interconnessione ad Alta Densità) con cicli di laminazione multipli.
- Focus di Progettazione: Utilizzare HDI Any-Layer o microvie impilate per instradare i segnali fuori dal denso ASIC BGA.
Scenario 3: L'Edge Aziendale Sensibile ai Costi
- Priorità: Equilibrio tra Prestazioni e Prezzo.
- Compromesso: Una perdita di inserzione leggermente superiore è accettabile per tracce più corte.
- Indicazioni: Si potrebbe utilizzare uno stackup ibrido. Utilizzare materiale costoso a bassa perdita per gli strati di segnale ad alta velocità e FR-4 standard per gli strati di alimentazione/massa per ridurre il costo totale della distinta base (BOM).
- Focus di Progettazione: Attenta pianificazione dello stackup per prevenire la deformazione dovuta a materiali misti (discrepanza CTE).
Scenario 4: L'Ambiente con Elevato Carico Termico
- Priorità: Dissipazione del Calore.
- Compromesso: Lo spazio di instradamento del segnale è ridotto dalle vie termiche.
- Indicazioni: La scheda base deve agire come diffusore di calore. Spessori di rame elevati (2oz o più) sugli strati interni aiutano, ma rendono più difficile l'incisione di linee sottili.
- Focus di Progettazione: Incorporare l'integrazione di monete (coin embedding) o ampie matrici di vie termiche sotto l'ASIC.
Scenario 5: Il Modulo Ottico Compatto
- Priorità: Miniaturizzazione.
- Compromesso: La riparabilità è quasi nulla.
- Guida: Richiede linee e spazi estremamente sottili (30µm/30µm). Questo spinge al limite la produzione sottrattiva di PCB e potrebbe richiedere il processo mSAP (Modified Semi-Additive Process).
- Focus del Design: Regole rigorose di
Co-packaged optics baseboard designriguardo agli anelli anulari e alle dimensioni dei pad.
Scenario 6: Prototipazione e Validazione R&S
- Priorità: Velocità di Fabbricazione.
- Compromesso: La disponibilità del materiale potrebbe dettare la costruzione.
- Guida: Utilizzare materiali disponibili a magazzino. Sebbene potrebbero non corrispondere perfettamente alle specifiche di produzione finali, consentono test logici funzionali.
- Focus del Design: Progettare con margini più ampi per accomodare la sostituzione del materiale, se necessario.
Dal design alla produzione (punti di controllo dell'implementazione)

La selezione dello scenario definisce la strategia, ma rigorosi punti di controllo durante il processo di produzione garantiscono la qualità finale della scheda base per ottiche co-packaged. Questa sezione descrive il percorso dal file digitale alla scheda fisica.
1. Verifica dello Stackup
- Raccomandazione: Convalidare i calcoli di impedenza utilizzando un risolutore di campo prima di iniziare la fabbricazione.
- Rischio: Spessore dielettrico errato porta a disadattamento di impedenza.
- Accettazione: I risultati del Calcolatore di Impedenza corrispondono al disegno di fabbricazione entro ±5%.
2. Preparazione del Materiale
- Raccomandazione: Cuocere i materiali per rimuovere l'umidità prima della laminazione.
- Rischio: Delaminazione o "macchie" (measling) durante la rifusione ad alta temperatura.
- Accettazione: Controlli del contenuto di umidità e rispetto delle linee guida di stoccaggio del produttore.
3. Imaging degli Strati Interni
- Raccomandazione: Utilizzare l'Imaging Diretto Laser (LDI) per larghezze di traccia inferiori a 3 mil.
- Rischio: L'esposizione tradizionale con pellicola non può risolvere le linee sottili richieste per il routing CPO.
- Accettazione: Ispezione Ottica Automatica (AOI) che non mostri interruzioni, cortocircuiti o difetti di "affossamento" (dish-down).
4. Laminazione e Registrazione
- Raccomandazione: Utilizzare sistemi di allineamento a raggi X per schede con un elevato numero di strati (20+ strati).
- Rischio: Il disallineamento strato-strato causa la rottura della perforazione, interrompendo le connessioni.
- Accettazione: Coupon di perforazione a raggi X che mostrano una registrazione entro la tolleranza (tipicamente < 2 mil).
5. Foratura e Svasatura (Backdrilling)
- Raccomandazione: Svasare (backdrill) tutti i via ad alta velocità per rimuovere i monconi.
- Rischio: I monconi dei via agiscono come antenne, causando grave risonanza e perdita di segnale.
- Accettazione: Analisi della sezione trasversale che verifica che la lunghezza del moncone sia inferiore a 6-8 mil (o come specificato).
6. Placcatura (Riempimento Via)
- Raccomandazione: Utilizzare VIPPO (Via-in-Pad Plated Over) per le aree BGA.
- Rischio: Le fossette nei pad causano vuoti nelle giunzioni di saldatura dell'ASIC.
- Accettazione: Requisiti di spessore della placcatura IPC Classe 3 (tipicamente media 25µm).
7. Applicazione della Finitura Superficiale
- Raccomandazione: ENEPIG o Argento ad Immersione sono preferiti per applicazioni ad alta frequenza.
- Rischio: L'ENIG può talvolta portare a "black pad" o a una maggiore perdita di inserzione a causa dello spessore del nichel.
- Accettazione: Misurazione XRF dello spessore di oro/palladio/nichel.
8. Test Elettrici
- Raccomandazione: Eseguire test Kelvin a 4 fili per le reti critiche.
- Rischio: I test standard a sonda volante potrebbero non rilevare difetti latenti ad alta resistenza.
- Accettazione: Superamento al 100% del confronto della netlist.
9. Misurazione della Deformazione (Warpage)
- Raccomandazione: Misurare la planarità a temperatura ambiente e a temperatura di rifusione.
- Rischio: La scheda si deforma durante l'assemblaggio, causando giunti aperti sul grande package ASIC.
- Accettazione: La deformazione soddisfa i criteri specifici della
Co-packaged optics baseboard checklist(solitamente < 0,1% per l'area ASIC).
10. Ispezione Visiva Finale
- Raccomandazione: Ispezionare sotto forte ingrandimento per rilevare l'invasione della maschera di saldatura sui pad.
- Rischio: La maschera sui pad impedisce una corretta saldatura.
- Accettazione: Conformità agli standard IPC-A-600 Classe 3.
Errori comuni (e l'approccio corretto)
Anche con un piano solido, possono verificarsi errori. Ecco le insidie comuni nelle Co-packaged optics baseboard best practices e come evitarle.
Errore 1: Ignorare l'Effetto della Trama della Fibra
- L'Errore: Utilizzare stili di trama in vetro standard (come 106 o 7628) per coppie differenziali ad alta velocità.
- La Conseguenza: Un ramo della coppia differenziale viaggia sul vetro, l'altro sulla resina, causando skew e degrado del segnale.
- La Soluzione: Specificare "vetro spalmato" o ruotare meccanicamente il design di 10 gradi rispetto alla trama del pannello.
Errore 2: Sottovalutare il bilanciamento del rame
- L'Errore: Progettare strati con una distribuzione del rame non uniforme (es. grandi colate di rame su un lato, tracce sparse sull'altro).
- La Conseguenza: Grave deformazione durante la laminazione e il reflow, rendendo la scheda inutilizzabile per l'assemblaggio CPO.
- La Soluzione: Utilizzare il "thieving" (rame fittizio) per bilanciare la densità del rame su tutti gli strati e lungo gli assi x/y.
Errore 3: Trascurare i via termici nella progettazione dei pad
- L'Errore: Posizionare i via termici troppo lontano dalla fonte di calore o coprirli in modo improprio.
- La Conseguenza: L'ASIC si surriscalda, limitando le prestazioni o danneggiando l'ottica vicina.
- La Soluzione: Implementare una fitta schiera di via riempiti e tappati direttamente sotto i pad termici dei componenti.
Errore 4: Eccessiva dipendenza dai valori Dk/Df del datasheet
- L'Errore: Utilizzare i valori Dk/Df "di marketing" da un datasheet per la simulazione.
- La Conseguenza: I risultati della simulazione non corrispondono alle prestazioni reali perché Dk/Df varia con la frequenza e il contenuto di resina.
- La Soluzione: Richiedere le tabelle Dk/Df specifiche per la frequenza esatta (es. 50GHz) e il contenuto di resina del prepreg utilizzato.
Errore 5: Scarso controllo della profondità del backdrill
- L'Errore: Specificare una profondità di backdrill troppo vicina allo strato interno funzionale.
- The Consequence: Il trapano taglia la traccia attiva, distruggendo la scheda.
- The Fix: Lasciare un margine di sicurezza (tipicamente 8-10 mil) tra la profondità target e lo strato funzionale, e scegliere un produttore con controllo della profondità ad alta precisione.
Mistake 6: Inadeguata Pulizia
- The Error: Consentire la contaminazione ionica sulla superficie della scheda.
- The Consequence: Migrazione elettrochimica (crescita di dendriti) sotto la spaziatura stretta dei componenti CPO, che porta a cortocircuiti.
- The Fix: Specificare test di pulizia ionica rigorosi (Rose Test o Cromatografia Ionica) oltre i requisiti standard.
Domande frequenti (FAQ)
A seguito degli errori comuni, ecco le risposte alle domande più frequenti riguardanti la qualità delle schede base per ottiche co-packaged.
Q1: Qual è la differenza principale tra una scheda di linea standard e una scheda base CPO? Una scheda di linea standard instrada i segnali alla piastra frontale (moduli collegabili). Una scheda base CPO instrada i segnali a un motore ottico montato direttamente accanto all'ASIC, richiedendo una densità molto più elevata e controlli più rigorosi sull'integrità del segnale.
Q2: Perché la planarità della superficie è così critica per il CPO? Gli assemblaggi CPO spesso utilizzano grandi interposer o metodi di attacco diretto. Se la scheda base non è piatta, le migliaia di punti di connessione (bump) non faranno contatto simultaneamente durante la rifusione, portando a circuiti aperti.
Q3: Posso usare FR-4 per le schede base per ottiche co-packaged? Generalmente, no. L'FR-4 standard ha una perdita di segnale eccessiva per le velocità di 112G o 224G utilizzate nel CPO. Sono necessari materiali a bassa perdita o a perdita ultra-bassa.
Q4: Come gestisce APTPCB i requisiti di backdrilling per il CPO? Utilizziamo macchine di foratura a profondità controllata con rilevamento elettrico per garantire che il moncone venga rimosso senza danneggiare la connessione interna.
Q5: Qual è il numero tipico di strati per queste schede? Tipicamente variano da 20 a oltre 40 strati, a seconda della capacità dello switch e della densità di routing.
Q6: Come testate l'integrità del segnale durante la produzione? Utilizziamo TDR (Time Domain Reflectometry) su coupon di test inclusi nel pannello di produzione per verificare l'impedenza. Per la perdita di inserzione, possono essere misurate strutture di test specifiche.
Q7: La scelta della finitura superficiale influisce sulla qualità del segnale? Sì. Il nichel nell'ENIG può aggiungere perdita a frequenze molto elevate. L'argento ad immersione o l'ENEPIG sono spesso preferiti per le loro migliori prestazioni sull'effetto pelle.
Q8: Quali informazioni sono necessarie per una revisione DFM di una scheda base CPO? Abbiamo bisogno dei file Gerber, dei file di foratura, della netlist IPC, dei requisiti di stackup, delle specifiche dei materiali e di eventuali vincoli speciali riguardanti la deformazione o il backdrilling.
Q9: Come influisce lo skew della trama del vetro sulle prestazioni del CPO? Ad alte velocità, la differenza nella costante dielettrica tra vetro e resina causa disallineamenti temporali (skew) nelle coppie differenziali. L'uso di vetro a trama diffusa aiuta a mitigare questo problema.
Q10: Qual è il tempo di consegna per la produzione di una scheda base CPO? A causa della complessità (cicli di laminazione, backdrilling, test), i tempi di consegna sono più lunghi rispetto alle schede standard, tipicamente 3-5 settimane a seconda della disponibilità del materiale.
Pagine e strumenti correlati
Per assistervi ulteriormente nel processo di progettazione e approvvigionamento, utilizzate queste risorse di APTPCB:
- Linee guida DFM: Regole dettagliate per la progettazione di schede ad alta velocità producibili.
- Calcolatore di impedenza: Verificate la larghezza e la spaziatura delle tracce prima di finalizzare lo stackup.
- Materiali PCB Rogers: Esplorate le opzioni di materiali ad alta frequenza adatti per applicazioni CPO.
Glossario (termini chiave)
Comprendere la terminologia è essenziale per specificare la qualità della baseboard per ottiche co-packaged.
| Termine | Definizione |
|---|---|
| ASIC | Application-Specific Integrated Circuit; il chip switch principale sulla baseboard. |
| Backdrilling | Il processo di foratura della porzione inutilizzata di un foro passante placcato (stub) per migliorare l'integrità del segnale. |
| CPO | Co-packaged Optics; integrazione di ottiche e silicio nello stesso package o sullo stesso substrato. |
| CTE | Coefficiente di Espansione Termica; quanto un materiale si espande quando riscaldato. Le discrepanze causano problemi di affidabilità. |
| Df (Fattore di Dissipazione) | Una misura di quanta energia del segnale viene persa come calore nel materiale dielettrico. Un valore inferiore è migliore. |
| Dk (Dielectric Constant) | Una misura della capacità di un materiale di immagazzinare energia elettrica; influisce sull'impedenza e sulla velocità del segnale. |
| HDI | Interconnessione ad alta densità; tecnologia PCB che utilizza microvias, vias cieche e vias interrate. |
| PAM4 | Modulazione di ampiezza di impulso a 4 livelli; uno schema di modulazione utilizzato per la trasmissione dati ad alta velocità (es. 112G). |
| SerDes | Serializzatore/Deserializzatore; un blocco funzionale che converte i dati paralleli in dati seriali per la trasmissione ad alta velocità. |
| Skew | La differenza di tempo tra l'arrivo di due segnali che dovrebbero essere sincroni (es. in una coppia differenziale). |
| Stub | La porzione inutilizzata di una via che agisce come un'antenna, causando riflessioni del segnale. |
| Tg (Glass Transition) | La temperatura alla quale la resina del PCB cambia da uno stato duro e vetroso a uno stato morbido e gommoso. |
| VIPPO | Via-in-Pad Plated Over; una tecnologia che consente di posizionare i vias direttamente nei pad dei componenti per risparmiare spazio. |
| Warpage | La deviazione dalla planarità del PCB, critica per l'assemblaggio di grandi package BGA. |
Conclusionee (prossimi passi)
Raggiungere un'elevata qualità della baseboard per ottiche co-packaged non è un caso; è il risultato di una selezione deliberata dei materiali, di un design preciso e di capacità di produzione avanzate. Man mano che le velocità dei dati salgono verso 1.6T e 3.2T, il margine di errore sulla baseboard svanisce. Il PCB non è più solo una struttura di supporto; è un componente attivo nella catena del segnale.
Per garantire il successo del tuo progetto, concentrati sulle metriche che contano: perdita di inserzione, stabilità dell'impedenza e planarità meccanica. Evita errori comuni come ignorare gli effetti della trama del vetro o sottovalutare i carichi termici.
Quando sei pronto a passare dal concetto alla produzione, APTPCB è pronta ad assisterti. Per una revisione DFM completa e un preventivo accurato, si prega di fornire:
- File Gerber completi (RS-274X).
- Stackup dettagliato con specifiche dei materiali (es. Megtron 7/8).
- File di foratura inclusi le definizioni di backdrill.
- Requisiti di impedenza e coupon di test.
- Specifiche di deformazione e tolleranza.
Collaborando con un produttore esperto, ti assicuri che il tuo Co-packaged optics baseboard design si traduca in un prodotto affidabile e ad alte prestazioni, pronto per le esigenze dei data center di prossima generazione.