Garantire l’affidabilità a lungo termine nell’assemblaggio Ball Grid Array (BGA) richiede controlli non distruttivi rigorosi, con particolare attenzione ai criteri a raggi X per i vuoti BGA e il difetto head-in-pillow (HiP). A differenza delle giunzioni di saldatura visibili, le connessioni BGA sono nascoste sotto il corpo del componente e rendono insufficiente la normale ispezione ottica. Per gli ingegneri e i responsabili qualità di APTPCB, comprendere con precisione i limiti di accettazione e rifiuto definiti dagli standard IPC è essenziale per prevenire guasti sul campo causati da fatica da ciclo termico o da contatti elettrici intermittenti. Questa guida illustra le firme radiografiche, le soglie di misura e i controlli di processo necessari per convalidare l’integrità del BGA.
Risposta rapida (30 secondi)
Per ottenere un assemblaggio BGA affidabile, i criteri a raggi X per i vuoti BGA e il difetto head-in-pillow seguono in genere gli standard IPC-7095 e IPC-A-610.
- Limite dei vuoti: Per IPC Classe 2 e Classe 3, l’area totale dei vuoti all’interno di una singola sfera di saldatura non dovrebbe superare il 25% dell’area complessiva della sfera.
- Head-in-pillow (HiP): Questo difetto è considerato un indicatore di processo ed è generalmente non accettabile. Appare come una separazione netta o una mancata coalescenza tra la sfera di saldatura e la pasta, come se la sfera fosse appoggiata su un cuscino.
- Rilevamento: I vuoti sono visibili in radiografia 2D in trasmissione. Il difetto HiP richiede spesso radiografia 2D inclinata (2,5D) oppure laminografia 3D (CT), perché la sovrapposizione verticale può nascondere il difetto in vista dall’alto.
- Posizione critica: I vuoti situati all’interfaccia tra la sfera di saldatura e il pad del componente sono più critici e spesso portano al rifiuto indipendentemente dalla dimensione, per il rischio di propagazione delle cricche.
- Convalida: I sistemi automatici di ispezione a raggi X (AXI) devono essere calibrati per distinguere i macrovuoti benigni dai microvuoti planari critici.
Quando si applicano i criteri a raggi X per i vuoti BGA e il difetto head-in-pillow (e quando no)
Comprendere bene l’ambito dell’ispezione permette di concentrare le risorse sui rischi reali di affidabilità, invece che su semplici anomalie estetiche.
Quando questi criteri si applicano:
- Assemblaggio BGA e CSP: Qualsiasi componente con giunzioni di saldatura nascoste dall’involucro richiede una verifica a raggi X secondo questi criteri.
- Prodotti ad alta affidabilità: In automotive, aerospazio e dispositivi medicali (IPC Classe 3), i cicli termici possono far evolvere i vuoti in cricche.
- Validazione del processo: Durante la fase di ispezione del primo articolo (FAI) per ottimizzare il profilo di rifusione.
- Analisi di guasti intermittenti: Quando una scheda supera il test elettrico ma fallisce sotto vibrazione o stress termico.
- Introduzione di nuovi involucri: Quando si introducono QFN o LGA con grandi pad termici, per i quali le regole sui vuoti cambiano leggermente ma la fisica resta simile.
Quando questi criteri non si applicano o cambiano:
- Componenti tradizionali a foro passante: I raggi X possono verificare il riempimento del foro metallizzato, ma i criteri dei vuoti per BGA non si trasferiscono direttamente alle giunzioni saldate a onda.
- Terminali visibili ad ala di gabbiano: In questo caso è normalmente preferibile l’ispezione ottica automatizzata (AOI); i raggi X sono eccessivi salvo controlli specifici come i talloni di saldatura.
- Pad termici QFN/LGA: I limiti di vuoto per ampie aree termiche sono spesso più permissivi, in alcuni casi fino al 50% secondo accordi cliente, rispetto alle sfere di segnale BGA.
- Applicazioni con riempimento sotto componente: Dopo l’applicazione di questo materiale, il contrasto radiografico cambia e la rilevazione dei vuoti diventa più complessa; i criteri vanno quindi applicati prima della dispensazione.
- Difetti superficiali estetici: I raggi X attraversano il componente, quindi i graffi sulla superficie dell’involucro non rientrano in questo set di criteri.
Regole e specifiche
La tabella seguente riassume i parametri tecnici usati per valutare l’integrità di un BGA. Traduce i criteri a raggi X per i vuoti BGA e il difetto head-in-pillow in punti di controllo misurabili.
| Regola / Parametro | Valore o intervallo consigliato | Perché conta | Come verificarlo | Se ignorato |
|---|---|---|---|---|
| Percentuale totale di vuoti | < 25% dell’area radiografica (IPC Classe 2/3) | I vuoti grandi riducono la conducibilità termica ed elettrica e indeboliscono la resistenza meccanica. | Algoritmo di calcolo area del software AXI. | Frattura della giunzione durante i cicli termici. |
| Vuoto singolo più grande | < 20% dell’area della sfera | Una singola bolla grande crea un forte punto di concentrazione degli sforzi. | Misurare il diametro della maggiore area a bassa densità. | Cedimento meccanico immediato sotto urto. |
| Firma head-in-pillow (HiP) | 0% (rifiuto) | Indica assenza di legame metallurgico; la giunzione è tenuta solo da residui di flussante o pressione meccanica. | Radiografia angolata a 45-70° o analisi di sezioni CT 3D. | Circuiti aperti intermittenti sul campo. |
| Diametro della sfera di saldatura | ±15% del valore nominale da scheda tecnica | Le variazioni indicano stiramento dovuto a imbarcamento o schiacciamento dovuto al carico. | Misura comparativa rispetto a sfere di riferimento. | Giunti aperti o cortocircuiti. |
| Ponte di saldatura / corto | 0 (non ammesso) | Provoca un guasto elettrico diretto. | Collegamento ad alta densità tra pad adiacenti nella radiografia. | Guasto funzionale immediato. |
| Distorsione delle sfere d’angolo | < 25% di allungamento | Gli angoli subiscono il massimo stress termico; l’allungamento segnala warpage eccessivo. | Analisi geometrica delle sfere d’angolo rispetto a quelle centrali. | Cratering del pad o fatica della saldatura. |
| Vuoti interfacciali | 0% (controllo rigoroso) | I vuoti all’interfaccia del pad sono precursori di guasti Black Pad. | Radiografia ad alto ingrandimento focalizzata sul piano del pad. | Frattura fragile catastrofica. |
| Giunto sottoalimentato | Volume > 75% del nominale | Un rilascio insufficiente di pasta porta a giunzioni deboli. | Integrazione dei livelli di grigio per stima volumetrica. | Giunzioni deboli soggette a vibrazioni. |
| Effetto popcorn / scoppio | 0 occorrenze | Indica che l’umidità intrappolata nell’involucro è esplosa durante la rifusione. | Forma irregolare e scoppiata della sfera. | Distruzione del componente e delaminazione. |
| Allineamento / offset | < 25% della larghezza del pad | Il disallineamento riduce l’area di contatto e aumenta il rischio di ponti. | Misurare la distanza centro-centro tra sfera e pad. | Affidabilità ridotta e possibili corti. |
| Angolo di bagnatura | Filetto visibile, se osservabile | Una buona bagnatura indica corretta attività del flussante e buona finitura del pad. | Ricostruzione 3D o microsezione. | Difetti di mancata bagnatura o dewetting. |
| Sfericità della sfera di saldatura | > 0,85 (rapporto d’aspetto) | Una sfera non sferica, se non prevista dal progetto, suggerisce rifusione incompleta o contaminazione. | Software di analisi della forma. | Scarso autoallineamento durante la rifusione. |
Fasi di implementazione
Per implementare un processo robusto di ispezione sui criteri a raggi X per i vuoti BGA e il difetto head-in-pillow serve un approccio sistematico. Solo così i dati raccolti risultano affidabili e utilizzabili.
Definire la classe di accettazione: Stabilire se il prodotto richiede IPC Classe 2 (affidabilità standard) o Classe 3 (alta prestazione). Questo determina quanto severa sarà la valutazione della percentuale di vuoti ammessa.
- Azione: Aggiornare le soglie del software AXI.
- Verifica: Confermare che le specifiche cliente coincidano con le definizioni IPC.
Calibrare l’impianto a raggi X: Prima della scansione, tensione del tubo e corrente target devono essere ottimizzate in base allo spessore del PCB e al numero di strati.
- Azione: Eseguire una scansione su un campione di riferimento o una piastra di calibrazione.
- Verifica: Controllare contrasto e risoluzione dell’immagine, ad esempio la visibilità di fili da 2 mil.
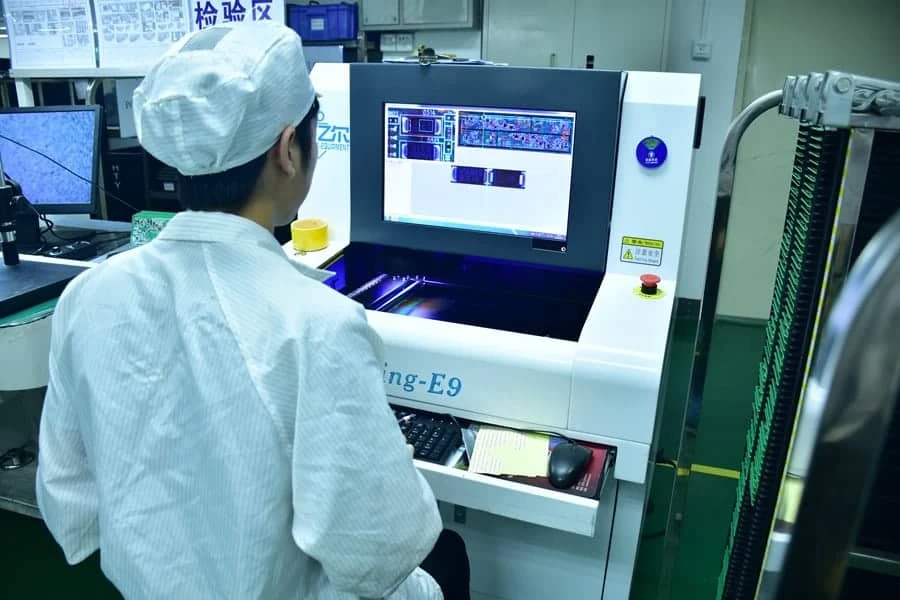
- Stabilire l’immagine di riferimento:
Scansionare una scheda nota come conforme per definire i valori base di scala di grigi delle giunzioni di saldatura. Questo aiuta il sistema a distinguere correttamente saldatura, rame e vuoti.
- Azione: Insegnare al sistema AXI le posizioni dei componenti dal file di posizionamento.
- Verifica: Verificare che tutti i pin BGA vengano identificati correttamente.

Eseguire una scansione 2D dall’alto: Effettuare una scansione rapida per individuare difetti macroscopici come ponti, sfere mancanti o vuoti molto estesi.
- Azione: Calcolare automaticamente le percentuali di vuoto.
- Verifica: Segnalare qualsiasi sfera con area di vuoto superiore al 25%.
Eseguire una scansione inclinata o 3D (fondamentale per HiP): La vista dall’alto spesso non mostra il difetto head-in-pillow. Occorre quindi inclinare il rivelatore o ruotare il campione.
- Azione: Ispezionare sfere d’angolo e involucri BGA di grandi dimensioni tra 45 e 60 gradi.
- Verifica: Cercare la forma a pupazzo di neve o linee di separazione nella sfera di saldatura.
Analizzare la posizione dei vuoti: Se vengono rilevati vuoti, bisogna distinguere se sono centrali, quindi meno critici, oppure all’interfaccia del pad, quindi critici.
- Azione: Regolare la profondità di fuoco quando si usa la radiografia 3D.
- Verifica: Scartare qualsiasi scheda con microvuoti planari sulla superficie del pad.
Correlare con il profilo di rifusione: Se compaiono difetti, vanno collegati alla loro posizione sulla scheda.
- Azione: Verificare se i difetti si concentrano nelle zone fredde o calde del forno.
- Verifica: Regolare il tempo sopra il liquidus (TAL) se il problema dei vuoti è sistemico.
Garantire registrazione dati e tracciabilità: Le immagini radiografiche e gli esiti di accettazione o rifiuto devono essere salvati con il numero seriale del PCB.
- Azione: Esportare il report nel sistema di gestione qualità.
- Verifica: Assicurarsi che le immagini siano recuperabili per audit futuri.
Modalità di guasto e risoluzione problemi
Quando i criteri a raggi X per i vuoti BGA e il difetto head-in-pillow non vengono rispettati, in genere c’è un problema in una fase precedente del processo. Questa guida aiuta a risalire dai sintomi alle cause radice.
1. Sintomo: alta percentuale di vuoti (>25%)
- Cause: Volatili intrappolati nella pasta, profilo di rifusione troppo corto, pad ossidati.
- Controlli: Verificare la scadenza della pasta saldante; controllare il tempo di permanenza termica del profilo.
- Correzione: Aumentare il tempo nella zona di permanenza termica per consentire ai volatili di uscire prima della fusione.
- Prevenzione: Usare forni di rifusione sotto vuoto per prodotti ad alta affidabilità.
2. Sintomo: head-in-pillow (HiP)
- Cause: Imbarcamento del componente, deposito insufficiente di pasta, effetto cuscino durante la rifusione.
- Controlli: Misurare la coplanarità del componente; verificare ostruzioni nelle aperture dello stencil.
- Correzione: Utilizzare uno stencil con rialzo locale di spessore per depositare più pasta; adeguare la velocità di raffreddamento al CTE dell’involucro.
- Prevenzione: Applicare un controllo in ingresso rigoroso per i PCBA, così da scartare componenti e schede deformati.
3. Sintomo: ponti di saldatura
- Cause: Eccesso di pasta, pressione di posizionamento troppo alta, slump della pasta.
- Controlli: Verificare lo spessore dello stencil e la riduzione delle aperture, in genere del 10-15%.
- Correzione: Pulire il lato inferiore dello stencil; ridurre la forza di posizionamento.
- Prevenzione: Ottimizzare il progetto dello stencil con rapporti d’aspetto corretti.
4. Sintomo: mancata bagnatura (giunto aperto)
- Cause: Ossidazione dei pad, flussante scaduto, calore insufficiente.
- Controlli: Verificare le condizioni di stoccaggio dei PCB rispetto a MSL; controllare la temperatura di picco.
- Correzione: Essiccare i PCB per rimuovere l’umidità; aumentare la temperatura di picco senza danneggiare i componenti.
- Prevenzione: Gestire correttamente finiture ENIG o OSP entro la loro vita utile.
5. Sintomo: pallinatura satellite
- Cause: Umidità nella pasta, rampa di salita troppo rapida.
- Controlli: Controllare l’umidità dell’area di stampa; verificare una rampa inferiore a 3 °C/s.
- Correzione: Regolare la rampa di riscaldamento; portare la pasta a temperatura ambiente prima della stampa.
- Prevenzione: Mantenere controlli ambientali rigorosi nell’area SMT.
6. Sintomo: effetto popcorn
- Cause: Assorbimento di umidità nel package BGA.
- Controlli: Verificare la tracciabilità del Moisture Sensitivity Level (MSL).
- Correzione: Essiccare i componenti secondo J-STD-033 prima dell’assemblaggio.
- Prevenzione: Conservare i componenti sensibili in armadi a secco o in atmosfera di azoto.
Scelte di progettazione
La possibilità di rispettare i criteri a raggi X per i vuoti BGA e il difetto head-in-pillow è fortemente influenzata dal progetto del PCB. Gli ingegneri dovrebbero considerare questi fattori già in fase di layout per facilitare assemblaggio e ispezione.
Definizione del pad (SMD vs. NSMD):
- NSMD (Non-Solder Mask Defined): In genere è la scelta preferita per i BGA. Il pad in rame è più piccolo dell’apertura della solder mask, quindi la sfera può avvolgere meglio il rame, migliorando presa meccanica e autoallineamento.
- SMD (Solder Mask Defined): La mask si sovrappone al rame. Questo può creare concentrazioni di stress da cui partono cricche, anche se in pitch molto fini viene talvolta usato per limitare i ponti.
Tecnologia dei via nel pad:
- I via aperti nei pad BGA sono una causa frequente di vuoti. La saldatura scende nel via, lasciando un giunto povero o aria intrappolata.
- Soluzione: Utilizzare via chiusi e riempiti (VIPPO) nei pad BGA. In questo modo si ottiene una superficie piana e si riducono in modo significativo sia la perdita di saldatura sia il rischio di vuoti.
Posizionamento e orientamento dei componenti:
- Evitare di collocare componenti pesanti, come trasformatori o schermature, immediatamente accanto ai BGA. Le diverse masse termiche causano riscaldamento irregolare, warpage e difetti HiP.
- Garantire spazio sufficiente attorno al BGA per l’ispezione radiografica inclinata. Componenti alti nelle vicinanze possono bloccare la visuale e rendere impossibile l’ispezione 2,5D.
Progetto dello stencil:
- Nei BGA a passo fine, le aperture quadrate con angoli arrotondati rilasciano in genere la pasta meglio delle aperture circolari.
- Gli stencil elettrolucidati migliorano il rilascio della pasta e riducono il rischio di saldatura insufficiente che contribuisce al difetto HiP.
Per indicazioni dettagliate sul layout, consultare le nostre linee guida DFM.
FAQ
1. Qual è la differenza tra IPC Classe 2 e Classe 3 per i vuoti BGA? In linea generale, sia la Classe 2 sia la Classe 3 limitano i vuoti al 25% dell’area della sfera. Tuttavia, la Classe 3, destinata a prodotti ad alta affidabilità, può prevedere requisiti cliente più severi sulla posizione dei vuoti, per esempio vietando quelli interfacciali, e richiede una documentazione di processo più rigorosa.
2. La radiografia 2D può rilevare il difetto head-in-pillow? Raramente. In una vista 2D dall’alto, la sfera di saldatura e il deposito di pasta si sovrappongono e sembrano uniti anche se tra i due esiste una separazione verticale. Per vedere questo strato di separazione serve una radiografia inclinata oppure la laminografia 3D.
3. È consentita la rilavorazione se un BGA non supera l’ispezione a raggi X? Sì. La rilavorazione BGA è una pratica standard che prevede la rimozione del componente, la pulizia del sito e la risaldatura di una nuova parte. Tuttavia, rilavorazioni ripetute possono danneggiare i pad. APTPCB limita quindi il numero di cicli di rilavorazione per proteggere l’integrità della scheda.
4. Perché i vuoti si formano soprattutto al centro della sfera? La causa principale è il degasaggio del flussante. Quando la saldatura fonde dall’esterno verso l’interno, i volatili vengono spinti verso il centro, che è l’ultima zona a solidificare. I vuoti centrali sono in genere meno dannosi di quelli all’interfaccia del pad.
5. In che modo la finitura superficiale influisce sul difetto head-in-pillow? Superfici ossidate, come un OSP invecchiato, impediscono alla pasta di bagnare correttamente il pad. La pasta rimane quindi separata dalla sfera. Una finitura ENIG offre di solito migliore bagnatura e minore rischio di HiP, purché non sia presente un difetto Black Pad.
6. Che cos’è l’effetto pupazzo di neve nella radiografia? È una firma visiva tipica di head-in-pillow o di rifusione incompleta osservata in vista inclinata. La sfera resta appoggiata sulla pasta rifusa senza fondersi con essa e ricorda per questo un pupazzo di neve.
7. La rifusione in azoto riduce i vuoti? Sì. L’azoto riduce l’ossidazione delle superfici di saldatura durante la rifusione e migliora la bagnatura. Una bagnatura migliore aiuta le bolle di gas a uscire più facilmente dal metallo fuso e riduce la percentuale totale di vuoti.
8. L’AOI può sostituire i raggi X per i BGA? No. L’AOI dipende dalla linea di vista. Può controllare talvolta i filetti esterni o il posizionamento del componente, ma non vede le giunzioni nascoste sotto il corpo del BGA. Per i BGA i raggi X restano indispensabili.
9. Qual è l’impatto di costo di un’ispezione a raggi X al 100%? Un’ispezione al 100% è lenta e aggiunge costo. Nella produzione di massa si usa spesso un piano di campionamento, per esempio con livelli AQL, oppure si ispezionano solo i BGA più complessi affidandosi alla validazione di processo per gli altri.
10. Come si previene il difetto HiP indotto dal warpage? Usare materiali PCB ad alta Tg, bilanciare la distribuzione del rame nello stack-up per evitare imbarcamenti e ottimizzare la velocità di raffreddamento del profilo di rifusione. Anche una lega a temperatura più bassa, come SnBi, può ridurre lo stress termico, pur cambiando le proprietà meccaniche.
11. Che cos’è un vuoto di tipo Champagne? È un tipo specifico di vuoto interfacciale in cui molte microcavità si concentrano sullo strato intermetallico. È molto pericoloso perché crea un piano di frattura debole ed è spesso associato a problemi di metallizzazione.
12. Come gestisce APTPCB l’ispezione dei BGA? Per NPI e assemblaggi complessi utilizziamo avanzate capacità di raggi X 3D. Le integriamo inoltre con lo SPI per prevenire i difetti ancora prima del posizionamento del componente.
Pagine correlate e strumenti
- Servizi di produzione PCB: Scoprite le nostre capacità per schede multistrato e HDI adatte agli assemblaggi BGA.
- Ispezione a raggi X: Scoprite come controlliamo giunzioni nascoste come vuoti e HiP durante l’assemblaggio PCBA.
- Contattaci: Richiedete supporto tecnico per i vostri requisiti specifici di affidabilità BGA.
- Linee guida DFM: Scaricate le nostre regole di progettazione per ottimizzare il layout per produzione e ispezione.
Glossario (termini chiave)
| Termine | Definizione |
|---|---|
| BGA (Ball Grid Array) | Package a montaggio superficiale per circuiti integrati in cui i collegamenti sono realizzati tramite una matrice di sfere di saldatura. |
| Head-in-pillow (HiP) | Difetto in cui la sfera BGA poggia sulla pasta saldante ma non si fonde in un’unica giunzione. |
| Vuoto | Presenza di una sacca d’aria o gas intrappolata all’interno di una giunzione saldata. |
| Laminografia | Tecnica radiografica 3D che genera sezioni del PCB per ispezionare strati specifici. |
| Composto intermetallico (IMC) | Strato chimico che si forma tra la saldatura e il pad in rame; essenziale per il legame, ma fragile se troppo spesso. |
| Coplanarità | Distanza massima tra la sfera più alta e quella più bassa di un componente; una coplanarità scarsa porta a giunti aperti. |
| Bagnatura | Capacità della saldatura fusa di distribuirsi su una superficie metallica e aderirvi. |
| Profilo di rifusione | Curva temperatura-tempo seguita dal PCB nel forno; è determinante per attivare il flussante e fondere la saldatura. |
| Stand-off | Distanza tra la base del componente e la superficie del PCB dopo la saldatura. |
| IPC-7095 | Standard industriale che guida in modo specifico il progetto e l’implementazione del processo di assemblaggio dei BGA. |
Conclusione
Padroneggiare i criteri a raggi X per i vuoti BGA e il difetto head-in-pillow non significa solo rispettare una norma, ma proteggere durata e sicurezza del prodotto finale. Applicando i limiti IPC, usando tecniche di ispezione 3D e comprendendo le cause radice dei difetti, gli ingegneri possono ridurre drasticamente i guasti sul campo legati ai BGA.
In APTPCB integriamo questi protocolli di ispezione nel nostro flusso standard. Dal controllo rigoroso in ingresso fino all’analisi radiografica avanzata, ci assicuriamo che ogni scheda raggiunga il livello di affidabilità richiesto. Se state affrontando progetti BGA complessi o problemi di affidabilità, il nostro team di ingegneria può supportarvi con una revisione tecnica completa.
