Lograr una union de soldadura correcta depende mucho menos de la suerte que de una buena gestion termica. En SMT, la diferencia entre un producto fiable y un fallo en campo suele estar directamente relacionada con el dominio de los fundamentos del perfil de reflow: tiempo de soak, pico y Delta-T.
En APTPCB (APTPCB PCB Factory) entendemos el perfil de reflow como la receta termica que sigue una PCB dentro del horno. Ese perfil define la rapidez con la que sube la temperatura, cuanto tiempo permanece activo el fundente y cual es la temperatura maxima que deben soportar los componentes. Si estos parametros se ajustan mal, aparecen soldaduras frias, tombstoning o incluso componentes danados.
Esta guia recorre desde las definiciones basicas hasta la solucion avanzada de problemas, para que sus disenos pasen del prototipo a la produccion en volumen con APTPCB de forma controlada.
Puntos clave
Antes de entrar en las metricas tecnicas, conviene fijar las ideas principales que permiten controlar la calidad del ensamblaje.
- La analogia de la receta: Un perfil de reflow es una curva de temperatura frente al tiempo. Debe ajustarse a las especificaciones del fabricante de la pasta de soldar y a los limites termicos de los componentes.
- Funcion del tiempo de soak: Esta etapa iguala la temperatura a lo largo de toda la PCB. Tambien permite que el fundente se active y limpie oxidos antes de que la soldadura funda.
- Temperatura pico: Es la temperatura maxima alcanzada. Debe ser lo bastante alta para formar una buena union intermetalica, pero no tanto como para provocar delaminacion en los componentes.
- Importancia de Delta-T ($\Delta$T): Este valor mide la diferencia de temperatura entre los puntos mas calientes y mas frios de la placa. Un Delta-T elevado genera soldadura desigual.
- La validacion es obligatoria: Un perfil no se adivina. Se necesita un perfilador termico con termopares fijados a la PCB real ya ensamblada.
- Control de vacios: Un perfilado correcto es esencial para
qfn reflow best practices to reduce voidsy para asegurar la fiabilidad a largo plazo.
Que significan realmente los fundamentos del perfil de reflow con tiempo de soak, pico y Delta-T (alcance y limites)
Sobre esta base, es necesario definir las zonas concretas del perfil termico para entender como interactuan entre si.
Un perfil SMT estandar de reflow se divide en cuatro zonas: precalentamiento, soak, reflow en pico y enfriamiento. Todas importan, pero la mayoria de los defectos aparece precisamente en la relacion entre la fase de soak, el pico y el Delta-T resultante.
La zona de soak
La zona de soak es la meseta de la curva termica, normalmente entre 150°C y 200°C en soldadura sin plomo. Su objetivo principal es la ecualizacion termica. En una tarjeta compleja, los grandes planos de cobre se calientan lentamente, mientras que las pequenas resistencias suben de temperatura con rapidez. El tiempo de soak permite que las zonas frias alcancen a las calientes antes de la fusion, reduciendo Delta-T. Ademas, ayuda a que los solventes volatiles de la pasta se evaporen de manera gradual.
La zona de pico (reflow)
Es la fase en la que sucede la fusion real. La temperatura supera el punto de liquidus de la aleacion. Para SAC305 sin plomo, el punto de fusion esta en torno a 217°C. La temperatura pico objetivo suele estar entre 235°C y 245°C. El tiempo por encima del punto de fusion se denomina Time Above Liquidus o TAL.
Delta-T ($\Delta$T)
Delta-T no es una zona, sino una medida de uniformidad. Es la diferencia de temperatura entre el componente mas frio, a menudo un BGA pesado o un conector, y el componente mas caliente, muchas veces un condensador pequeno, en un instante dado. Mantener Delta-T bajo ayuda a que todas las uniones entren en reflow al mismo tiempo y evita tombstoning y torsion.
Para ver como encajan estas fases en el proceso de ensamblaje completo, consulte tambien nuestra guia sobre ensamblaje SMT y THT.
Fundamentos del perfil de reflow: metricas clave para tiempo de soak, pico y Delta-T
Comprender los terminos es solo el primer paso. Despues hay que traducirlos a metricas concretas para evaluar la calidad del proceso.
Los ingenieros de proceso usan estos valores para verificar si el perfil esta dentro de especificacion. Salirse de estos rangos es una de las causas mas frecuentes de defectos de ensamblaje.
| Metrica | Por que importa | Rango tipico (sin plomo) | Como se mide |
|---|---|---|---|
| Tasa de rampa | Controla la velocidad de calentamiento de la PCB. Si es excesiva, provoca choque termico y salpicaduras de soldadura. | 1°C a 3°C por segundo | Perfilador termico con calculo de pendiente |
| Tiempo de soak | Permite activar el fundente y equilibrar la temperatura. Si es demasiado largo, agota el fundente; si es demasiado corto, deja puntos frios. | 60 a 120 segundos entre 150 y 200°C | Duracion entre dos puntos de temperatura |
| Temperatura pico | Garantiza humectacion y formacion intermetalica. Si es muy alta, dana piezas; si es baja, deja uniones frias. | 235°C a 250°C | Temperatura maxima registrada por cualquier termopar |
| Time Above Liquidus (TAL) | Influye en la estructura del grano de la soldadura. Si es muy largo, genera juntas mas fragiles. | 45 a 90 segundos | Tiempo por encima de 217°C |
| Delta-T ($\Delta$T) | Indica uniformidad termica. Un Delta-T alto aumenta el riesgo de reflow parcial. | < 10°C en el pico | Diferencia entre la sonda maxima y minima |
| Tasa de enfriamiento | Afecta la estructura del grano de soldadura. Un enfriamiento rapido genera granos mas finos y resistentes. | 2°C a 4°C por segundo | Pendiente de la curva de enfriamiento |
Como elegir los fundamentos del perfil de reflow con tiempo de soak, pico y Delta-T segun el escenario
Una vez entendidas las metricas, hay que adaptarlas al diseno concreto de la tarjeta, porque un solo perfil no sirve para todos los casos.
El perfil correcto depende en gran medida de la masa termica del PCB y de la sensibilidad de los componentes. Estos son algunos escenarios tipicos y el enfoque recomendado en cada uno.
Escenario 1: electronica de consumo sencilla
- Tipo de perfil: Ramp-to-Spike (RTS).
- Por que: Estas placas suelen tener una masa termica uniforme. Una subida lineal es mas rapida y castiga menos la pasta.
- Compensacion: Mayor productividad, pero menos tolerancia frente a variaciones de temperatura.
Escenario 2: placas industriales o de servidor de alta fiabilidad
- Tipo de perfil: Ramp-Soak-Spike (RSS).
- Por que: Estas placas mezclan capas pesadas de cobre y BGAs grandes con pasivos pequenos. Se necesita una zona de soak bien definida para reducir Delta-T.
- Compensacion: Ciclo mas largo, pero mucho mejor rendimiento de proceso.
Escenario 3: QFN y componentes de terminacion inferior
- Enfoque:
qfn reflow best practices to reduce voids. - Ajuste: Un tiempo de soak mas largo deja escapar los gases volatiles bajo el cuerpo del componente antes de que la soldadura selle la zona.
- Riesgo: Si la rampa es demasiado rapida, el gas queda atrapado y aparecen vacios.
Escenario 4: ensamblaje BGA de paso fino
- Enfoque:
bga voiding control: stencil, reflow, and x-ray criteria. - Ajuste: Es necesario controlar con precision la temperatura pico y la TAL. La bola BGA y la pasta deben fundir juntas de forma uniforme.
- Validacion: Requiere inspeccion por rayos X para comprobar humectacion y porcentaje de vacios.
Escenario 5: circuitos flexibles (FPC)
- Enfoque: Sensibilidad del material.
- Ajuste: Los materiales flexibles, como la poliimida, absorben el calor de forma distinta a FR4 y pueden requerir pallets de soporte. El perfil debe considerar tambien la masa termica del pallet.
- Enlace: Puede ampliar informacion en capacidades Flex PCB.
Escenario 6: ensamblaje a doble cara
- Enfoque: Retencion de componentes.
- Ajuste: En el segundo paso, lado B, no deben volver a fundirse los componentes pesados del lado A hasta el punto de desprenderse. Por eso el segundo perfil suele ser algo mas frio o usar un soporte diferente.
Fundamentos del perfil de reflow: puntos de control de implementacion para tiempo de soak, pico y Delta-T
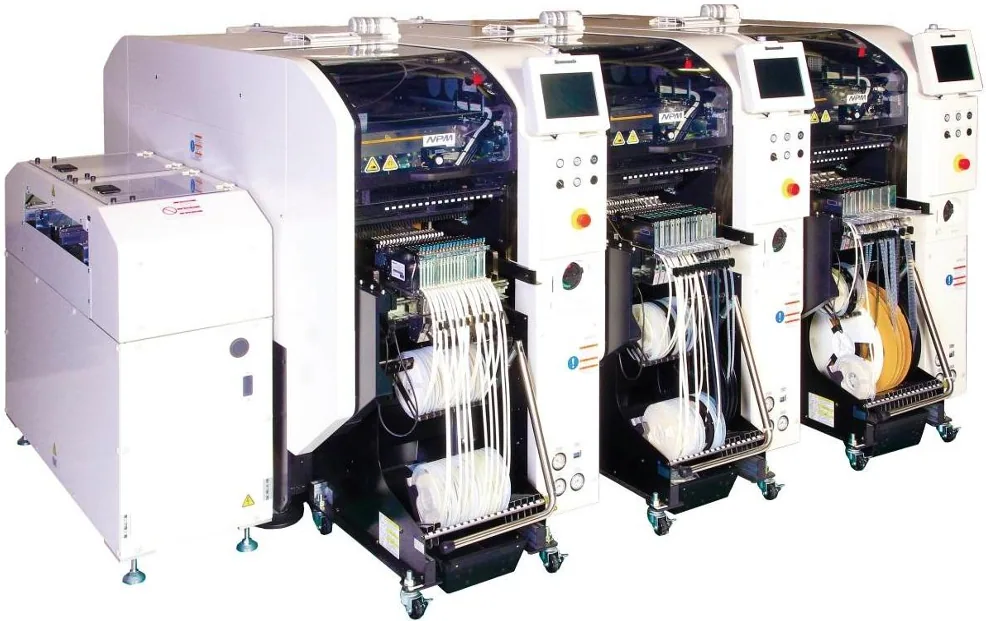
Seleccionar un perfil es teoria. Llevarlo a produccion exige un proceso disciplinado y paso a paso.
En APTPCB seguimos un protocolo estricto para garantizar que el perfil teorico coincida con el comportamiento real de la placa.
- Revision de datos de la pasta: Obtenga la hoja tecnica de la pasta concreta, por ejemplo SAC305 o SnPb. Anote temperatura de activacion y punto de fusion.
- Auditoria de componentes: Identifique el componente mas sensible termicamente, por ejemplo un conector plastico, y el de mayor masa termica, como blindajes o BGAs.
- Colocacion de termopares: Fije entre 3 y 6 termopares en una Golden Board.
- Ubicacion 1: borde de entrada del PCB.
- Ubicacion 2: centro de un BGA grande, perforando por detras si es necesario.
- Ubicacion 3: cuerpo de un componente sensible.
- Ubicacion 4: pequeno pasivo, el punto que mas rapido se calienta.
- Configuracion del horno: Introduzca temperaturas iniciales por zona y velocidad de transportador segun el escenario elegido, RTS o RSS.
- Ejecucion del perfilador: Haga pasar la Golden Board por el horno.
- Analisis de Delta-T: Revise la diferencia de temperatura durante soak y en el pico. Si Delta-T supera 10°C, ajuste la duracion de soak o la velocidad del transportador.
- Verificacion de TAL: Asegurese de que el punto mas frio permanezca al menos 45 segundos por encima del liquidus.
- Verificacion del pico: Confirme que el punto mas caliente no exceda la especificacion de los componentes, normalmente 260°C.
- Bloqueo de receta: Guarde la configuracion del horno como programa maestro para esa referencia de ensamblaje.
- First Article Inspection (FAI): Procese una placa de produccion y revise con inspeccion AOI y rayos X.
Fundamentos del perfil de reflow: errores comunes con tiempo de soak, pico y Delta-T
Incluso con un proceso definido, aparecen fallos. Identificar estos errores habituales acelera mucho el diagnostico.
1. Efecto graping
- Sintoma: Las particulas de soldadura parecen un racimo de uvas en lugar de una union lisa.
- Causa: El tiempo de soak fue demasiado largo o la temperatura demasiado alta. El fundente se agoto antes de la fase de reflow y el polvo de soldadura se oxido en vez de coalescer.
- Correccion: Reducir el tiempo de soak o pasar a una pasta con mayor actividad.
2. Tombstoning (efecto Manhattan)
- Sintoma: Un componente pequeno se levanta sobre un extremo.
- Causa: Calentamiento desigual, con Delta-T alto entre ambos pads. Uno funde antes y tira del componente hacia arriba.
- Correccion: Aumentar el tiempo de soak para igualar temperaturas antes de la fusion.
3. Perlas o bolas de soldadura
- Sintoma: Aparecen pequenas bolas de soldadura junto a resistencias o condensadores chip.
- Causa: Una rampa inicial demasiado agresiva hace hervir el solvente y lo expulsa junto con soldadura.
- Correccion: Reducir la pendiente de precalentamiento.
4. Vacios en BGAs y QFNs
- Sintoma: Grandes bolsas de aire visibles bajo rayos X.
- Causa: TAL insuficiente o temperatura pico demasiado baja, que impiden la salida de gases.
- Correccion: Optimizar el perfil para
bga voiding control: stencil, reflow, and x-ray criteria. Un ligero aumento de TAL puede ayudar.
5. Delaminacion de la placa
- Sintoma: Ampollas o separacion de capas en el PCB.
- Causa: La temperatura pico supero el Tg o la temperatura de descomposicion del material, o habia humedad atrapada en la placa.
- Correccion: Hornear los PCB antes del reflow para eliminar humedad o bajar la temperatura pico.
6. Soldaduras frias
- Sintoma: Juntas mates, granuladas y con mala conexion electrica.
- Causa: La temperatura pico fue demasiado baja o la TAL demasiado corta. La soldadura nunca humecto por completo el pad.
- Correccion: Subir la temperatura de pico o reducir la velocidad del transportador.
Fundamentos del perfil de reflow: FAQ sobre tiempo de soak, pico y Delta-T
Estas son algunas respuestas a preguntas frecuentes sobre el impacto del perfilado en costes y logistica de fabricacion.
P: Como afecta la optimizacion del perfil de reflow al coste total de ensamblaje? R: El perfilado consume tiempo de ingenieria, pero reduce el coste de mala calidad. Un perfil deficiente provoca retrabajo, desecho y fallos en campo. Ajustarlo bien desde el inicio reduce el coste total por unidad al mejorar el First Pass Yield.
P: El perfil de reflow afecta al plazo de entrega? R: En nuevos productos o NPI, el perfilado anade unas horas a la preparacion inicial. Sin embargo, en pedidos repetitivos la receta ya guardada permite producir de inmediato. En general no cambia de forma significativa el plazo estandar.
P: Como influyen los diferentes materiales de PCB en el tiempo de soak requerido? R: Los materiales con alta conductividad termica, como los Metal Core PCB, disipan el calor con rapidez. Por eso necesitan un aporte termico mas agresivo o tiempos de soak mas largos que el FR4 convencional para alcanzar la misma temperatura de reflow.
P: Que metodos de prueba se usan para validar el perfil? R: El metodo principal es un perfilador termico tipo KIC o DATAPAQ que viaja a traves del horno. Como validacion secundaria se usan microsecciones de juntas, destructivas, o inspeccion por rayos X, no destructiva, para verificar humectacion y vacios.
P: Cuales son los criterios de aceptacion de un buen perfil? R: El perfil debe mantenerse dentro de la ventana de proceso definida por el fabricante de la pasta, como Alpha o Indium, y por IPC J-STD-020. Los criterios clave incluyen una TAL de 45 a 90 s, temperatura pico de 235 a 250°C y una tasa de rampa inferior a 3°C/s.
P: Puedo usar el mismo perfil para ensamblaje con plomo y sin plomo? R: No, en absoluto. La soldadura con plomo SnPb funde cerca de 183°C, mientras que la soldadura sin plomo SAC305 lo hace alrededor de 217°C. Si se usa un perfil con plomo en placas sin plomo, no habra reflow real. Si se usa un perfil sin plomo en placas con plomo, pueden sobrecalentarse los componentes.
P: Como influye el tiempo de soak en la actividad del fundente? R: El fundente limpia oxidos. Si la fase de soak es demasiado larga o demasiado caliente, el fundente se activa y se quema antes de que funda la soldadura. El metal queda expuesto a reoxidacion y aparecen defectos como head-in-pillow en BGAs.
P: Por que Delta-T es mayor en placas grandes? R: Las placas grandes muestran mayor variacion en densidad de cobre y masa de componentes. Ademas, la distancia fisica entre el borde y el centro introduce mas retardo termico, lo que aumenta Delta-T.
Recursos sobre fundamentos del perfil de reflow con tiempo de soak, pico y Delta-T
Para comprender mejor el ecosistema del ensamblaje PCB, explore tambien estos recursos relacionados de APTPCB:
- Ensamblaje SMT frente a THT: Para entender donde encaja el reflow en el flujo general de ensamblaje.
- Ensamblaje BGA y QFN: Desafios especificos de los componentes con terminaciones inferiores.
- Inspeccion por rayos X: Como verificamos las soldaduras ocultas despues del reflow.
- Guias DFM: Consejos de diseno para facilitar el perfilado y ensamblaje de su placa.
Glosario de fundamentos del perfil de reflow: tiempo de soak, pico y Delta-T
Esta es una referencia rapida de los terminos tecnicos usados en el perfilado termico.
| Termino | Definicion |
|---|---|
| Liquidus | Temperatura a la que la aleacion de soldadura se vuelve completamente liquida, aproximadamente 217°C en SAC305. |
| Solidus | Temperatura a la que la aleacion de soldadura esta completamente solida. |
| Eutectico | Aleacion en la que liquidus y solidus coinciden; se funde y solidifica de forma instantanea, por ejemplo Sn63Pb37. |
| TAL (Time Above Liquidus) | Tiempo durante el cual la junta de soldadura permanece en estado liquido. Es critico para la humectacion. |
| Delta-T ($\Delta$T) | Diferencia maxima de temperatura entre dos puntos de la PCB en un instante concreto. |
| Zona de soak | Parte del perfil donde la temperatura se mantiene relativamente estable para igualar termicamente la placa. |
| Tasa de rampa | Velocidad a la que cambia la temperatura, medida en °C por segundo. |
| Fundente | Agente quimico dentro de la pasta que elimina oxidos y favorece la humectacion. |
| Humectacion | Capacidad de la soldadura fundida para extenderse sobre el pad metalico y adherirse a el. |
| Capa intermetalica | Union formada entre la soldadura y el pad de cobre, esencial para la conexion electrica. |
| Termopar | Sensor usado para medir temperatura en puntos concretos de la PCB durante el perfilado. |
| Horno de reflow | Maquina con varias zonas de calentamiento usada para fundir la pasta de soldar. |
| Vacios | Aire o gas atrapado dentro de una junta de soldadura, debilitandola. |
| Tombstoning | Defecto por el que un componente queda levantado sobre un pad debido a fuerzas de humectacion desiguales. |
Conclusion (siguientes pasos)
Dominar los fundamentos del perfil de reflow con tiempo de soak, pico y Delta-T es el puente entre un diseno funcional y un producto fiable. Requiere equilibrio entre quimica, fisica y control preciso del equipo. Un perfil bien ajustado reduce vacios, evita choque termico y garantiza que cada union, desde la resistencia mas pequena hasta el BGA mas grande, sea mecanica y electricamente robusta.
En APTPCB, tratamos el perfilado como una ciencia critica y no como una tarea secundaria. Tanto si esta prototipando un equipo IoT complejo como si esta escalando electronica automotriz, nuestro equipo de ingenieria valida cada receta termica antes de iniciar la produccion.
Listo para pasar a fabricacion? Al enviar sus datos para revision DFM o cotizacion, incluya:
- Archivos Gerber: Incluidas las capas de pasta.
- BOM: Para identificar la masa termica de los componentes.
- Planos de ensamblaje: Indicando cualquier orientacion especial de componentes.
- Stackup PCB: Para estimar la conductividad termica.
- Requisitos especiales: Por ejemplo, marcas concretas de pasta o requisitos IPC Class 3.
Contactenos para que su proximo proyecto arranque con precision termica desde el primer lote.