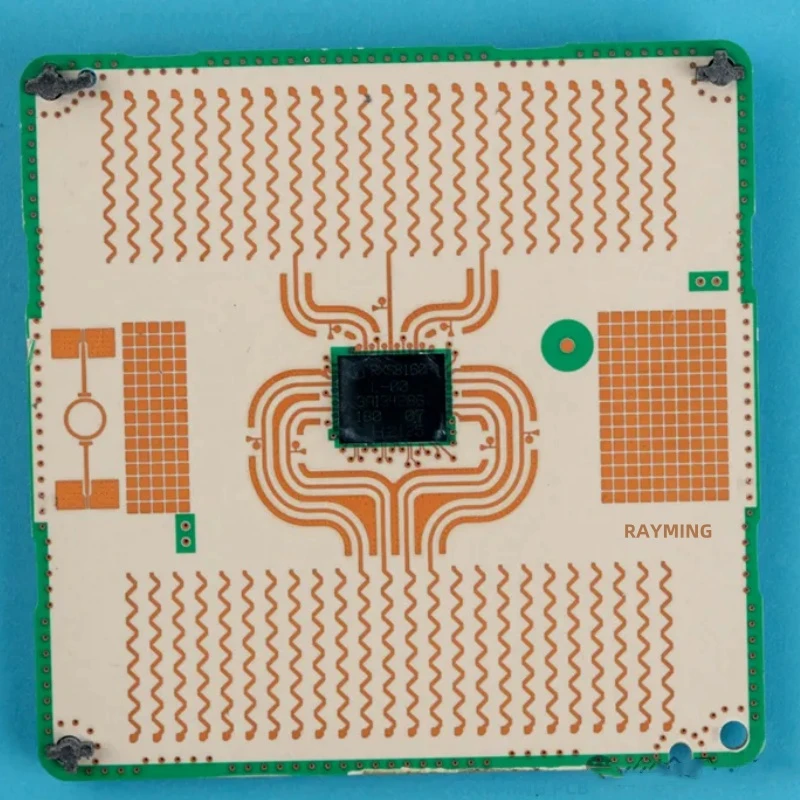
Cómputo
Acelerador de cómputo
BGA de 0.3 mm con boundary-scan, underfill y registros de reflow al vacío.
Boundary-scanUnderfillVacuum

PASO 0.3 MM • 01005 • CONTROL DE VOIDS
DFM, esténcil/pasta, colocación ±25 µm, reflow en nitrógeno, seguimiento AXI/void, underfill y retrabajo controlado mantienen las uniones ocultas confiables desde pilotos hasta volumen.
Combinamos controles de proceso con datos de inspección para que cada unión oculta salga con evidencia.
Soporte de via-in-pad, PoP y microvías rellenas de cobre.
Visión + soporte de vacío mantienen CpK ≥1.33.
Ajustes de esténcil/pasta/perfil + tiempo de vacío.
COBERTURA
Cada etapa—DFM, esténcil, colocación, reflow, inspección, underfill y retrabajo—es coordinada por el mismo equipo para sostener el rendimiento y controlar los ciclos de retrabajo.
DFM y huellas
Diseño de pads, holgura de máscara, relleno via-in-pad y balance de cobre para limitar la deformación.
Esténcil y pasta
Esténciles step/nano de 80–120 µm, pasta Tipo 5/6 y tooling de soporte aseguran ventanas de impresión.
Colocación y reflow
Colocación ±25 µm, soporte de vacío y reflow en nitrógeno con ΔT ≤5 °C usando termopares.
Inspección y retrabajo
AOI 3D, AXI por muestreo, reportes de void, underfill, staking y retrabajo ≤3 ciclos documentado.

GUÍA
Puertas definidas mantienen estables las construcciones BGA/QFN densas desde la recepción hasta el retrabajo.
Recepción del paquete
Reunir planos, stacks de pads, especificaciones de pasta y objetivos de void.
Ajuste de proceso
Selección de esténcil/pasta, colocación y simulaciones de reflow.
Corrida de producción
SMT con 100% SPI/AOI, soporte de vacío y reflow en nitrógeno.
Inspección y analítica
AXI, reportes de void, análisis iónico y tableros SPC.
Underfill y retrabajo
Ejecución de underfill/staking y retrabajo ≤3 ciclos con post-AXI.
PORTAFOLIO
Construcciones con uniones ocultas que ejecutamos cada trimestre con control de void y límites de retrabajo documentados.
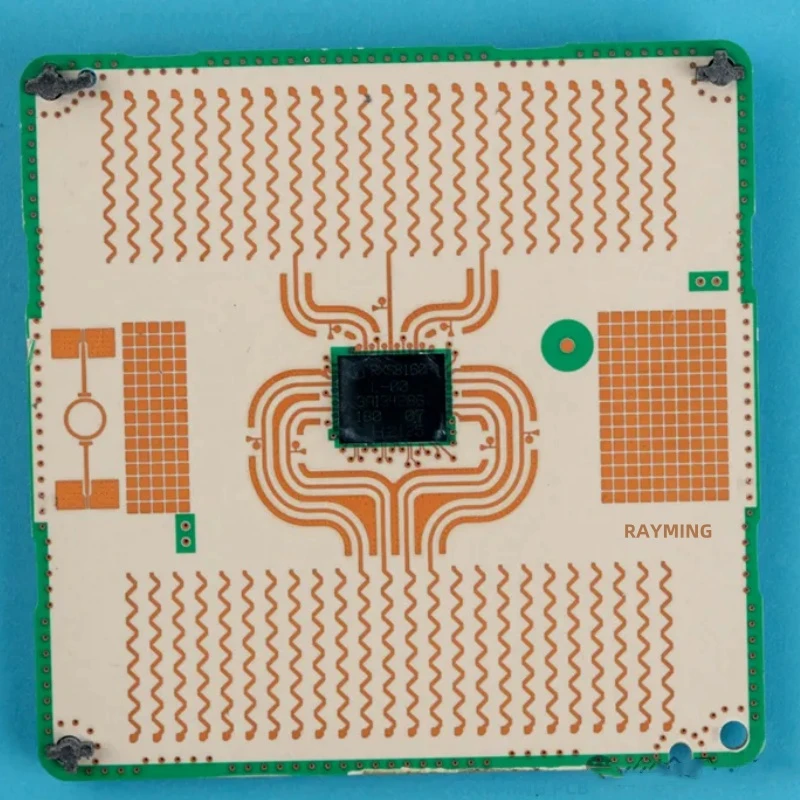



CAPACIDADES
Herramientas, fixtures y analítica dimensionadas para el éxito de uniones ocultas.
Laboratorios dedicados de reflow, AXI, underfill y retrabajo con control de humedad.



CALIDAD
Inspección en línea, AXI y analítica de voids hacen visibles las uniones ocultas.
Verificación de área ratio, SPC de altura de pasta y bucles de retroalimentación de la impresora.
Muestreo AXI y reportes C-SAM/void con objetivos <10% BTC.
≤3 ciclos con preparación del sitio, impresión de pasta y verificación post-AXI.
BGAs de alta densidad con boundary-scan, underfill y trazabilidad de retrabajo.
Limpieza, AOI/AXI y registros de retrabajo para dispositivos Clase II/III.
Datos de void/hi-pot y evidencia PPAP-ready para ECUs e inversores.
Módulos RF apantallados con reflow controlado y metas de void.
Everything you need to know about HDI PCB technology
Sube tus archivos para recibir un plan de DFM, proceso e inspección para uniones ocultas.