Garantizar la fiabilidad a largo plazo en el ensamblaje Ball Grid Array (BGA) exige ensayos no destructivos rigurosos, con especial atención a los criterios de rayos X para vacíos en BGA y head-in-pillow (HiP). A diferencia de las uniones de soldadura visibles, las conexiones BGA quedan ocultas bajo el cuerpo del componente, por lo que la inspección óptica convencional no resulta suficiente. Para los ingenieros y responsables de calidad de APTPCB, comprender con precisión los límites de aceptación y rechazo definidos por las normas IPC es fundamental para evitar fallas en campo causadas por fatiga térmica cíclica o por contactos eléctricos intermitentes. Esta guía detalla las firmas radiográficas, los umbrales de medición y los controles de proceso necesarios para validar la integridad del BGA.
Respuesta rápida (30 segundos)
Para lograr un ensamblaje BGA confiable, los criterios de rayos X para vacíos en BGA y head-in-pillow suelen alinearse con IPC-7095 e IPC-A-610.
- Límite de vacíos: En IPC Clase 2 y Clase 3, el área total de vacíos dentro de una sola esfera de soldadura no debería superar el 25% del área total de la esfera.
- Head-in-pillow (HiP): Este defecto se considera un indicador de proceso y, por lo general, no es aceptable. Se manifiesta como una separación clara o una falta de coalescencia entre la esfera de soldadura y la pasta, como si la esfera descansara sobre una almohada.
- Detección: Los vacíos son visibles en radiografía 2D por transmisión. El HiP suele requerir rayos X 2D en ángulo (2.5D) o laminografía 3D (CT), porque la superposición vertical puede ocultar el defecto en una vista superior.
- Ubicación crítica: Los vacíos situados en la interfaz entre la esfera de soldadura y el pad del componente son más críticos y a menudo motivan rechazo sin importar su tamaño, debido al riesgo de propagación de grietas.
- Validación: Los sistemas automatizados de inspección por rayos X (AXI) deben calibrarse para distinguir entre macrovacíos benignos y microvacíos planares críticos.
Cuándo se aplican los criterios de rayos X para vacíos en BGA y head-in-pillow (y cuándo no)
Entender el alcance de la inspección permite concentrar recursos en riesgos reales de fiabilidad y no en anomalías puramente cosméticas.
Cuándo se aplican estos criterios:
- Ensamblaje de BGA y CSP: Cualquier componente con uniones de soldadura ocultas bajo el encapsulado requiere validación por rayos X con estos criterios.
- Productos de alta fiabilidad: En automoción, aeroespacial y equipos médicos (IPC Clase 3), los ciclos térmicos pueden hacer que los vacíos evolucionen hacia grietas.
- Validación del proceso: Durante la fase de inspección de primer artículo (FAI) para ajustar el perfil de refusión.
- Análisis de fallas intermitentes: Cuando una tarjeta supera la prueba eléctrica pero falla bajo vibración o esfuerzo térmico.
- Introducción de nuevos encapsulados: Al incorporar QFN o LGA con grandes pads térmicos, donde las reglas sobre vacíos cambian ligeramente aunque la física siga siendo similar.
Cuándo estos criterios no aplican o cambian:
- Componentes convencionales de orificio pasante: Los rayos X pueden revisar el llenado del barril metalizado, pero los criterios de vacíos de BGA no se trasladan directamente a uniones soldadas por ola.
- Terminales de ala de gaviota visibles: Aquí suele ser preferible la inspección óptica automatizada (AOI); los rayos X son excesivos salvo para verificaciones puntuales como el talón de soldadura.
- Pads térmicos de QFN/LGA: Los límites de vacíos sobre grandes planos térmicos suelen ser más amplios, incluso hasta el 50% en algunos acuerdos específicos, que en las bolas de señal de un BGA.
- Aplicaciones con relleno inferior: Una vez aplicado este material, el contraste radiográfico cambia y la detección de vacíos se vuelve más compleja; los criterios deben aplicarse antes de dispensarlo.
- Defectos superficiales cosméticos: Los rayos X atraviesan la pieza, por lo que los rayones en la superficie del encapsulado no pertenecen a este conjunto de criterios.
Reglas y especificaciones
La siguiente tabla resume los parámetros técnicos usados para evaluar la integridad de un BGA. Convierte los criterios de rayos X para vacíos en BGA y head-in-pillow en puntos medibles de inspección.
| Regla / Parámetro | Valor o rango recomendado | Por qué importa | Cómo verificarlo | Si se ignora |
|---|---|---|---|---|
| Porcentaje total de vacíos | < 25% del área radiográfica (IPC Clase 2/3) | Los vacíos grandes reducen la conductividad térmica y eléctrica y debilitan la resistencia mecánica. | Algoritmo de cálculo de área del software AXI. | Fractura de la unión durante ciclos térmicos. |
| Mayor vacío individual | < 20% del área de la esfera | Una sola burbuja grande crea una concentración significativa de esfuerzos. | Medir el diámetro de la mayor zona de baja densidad. | Falla mecánica inmediata ante choque. |
| Firma de head-in-pillow (HiP) | 0% (rechazo) | Indica ausencia de unión metalúrgica; la conexión queda sostenida solo por residuos de flux o presión mecánica. | Radiografía angular de 45-70° o análisis de cortes CT 3D. | Circuitos abiertos intermitentes en campo. |
| Diámetro de la esfera de soldadura | ±15% del valor nominal de la hoja de datos | Las variaciones revelan estiramiento por alabeo o aplastamiento por carga. | Medición comparativa frente a esferas de referencia. | Uniones abiertas o cortocircuitos. |
| Puente de soldadura / corto | 0 (no permitido) | Provoca una falla eléctrica directa. | Enlace de alta densidad entre pads adyacentes en la imagen de rayos X. | Falla funcional inmediata. |
| Distorsión de bolas de esquina | < 25% de elongación | Las esquinas sufren el mayor esfuerzo térmico; la elongación indica alabeo excesivo. | Análisis geométrico de bolas de esquina frente a bolas centrales. | Cratering del pad o fatiga de la soldadura. |
| Vacíos interfaciales | 0% (control estricto) | Los vacíos en la interfaz del pad son precursores de fallas tipo Black Pad. | Radiografía de alta magnificación enfocada en el plano del pad. | Fractura frágil catastrófica. |
| Unión con falta de soldadura | Volumen > 75% del nominal | Una liberación insuficiente de pasta genera uniones débiles. | Integración de escala de grises para estimación volumétrica. | Uniones débiles sensibles a vibración. |
| Efecto popcorn / estallido | 0 ocurrencias | Indica que la humedad atrapada en el encapsulado explotó durante la refusión. | Forma irregular y reventada de la esfera. | Destrucción del componente y delaminación. |
| Alineación / offset | < 25% del ancho del pad | El desalineado reduce el área de contacto y aumenta el riesgo de puenteo. | Medir la distancia centro a centro entre esfera y pad. | Menor fiabilidad y posibles cortos. |
| Ángulo de humectación | Filete visible si es observable | Una buena humectación indica actividad correcta del flux y acabado adecuado del pad. | Reconstrucción 3D o corte metalográfico. | Defectos de no humectación o deshumectación. |
| Esfericidad de la bola de soldadura | > 0.85 (relación de aspecto) | Una bola no esférica, salvo diseño intencional, sugiere una refusión incompleta o contaminación. | Software de análisis de forma. | Mala autoalineación durante la refusión. |
Pasos de implementación
Implementar un proceso sólido de inspección para los criterios de rayos X de vacíos en BGA y head-in-pillow requiere un enfoque sistemático. Así se garantiza que los datos obtenidos sean precisos y accionables.
Definir la clase de aceptación: Determine si el producto debe cumplir IPC Clase 2 (fiabilidad estándar) o Clase 3 (alto desempeño). Esto define qué tan estricto será el límite permitido de vacíos.
- Acción: Actualizar los umbrales del software AXI.
- Verificación: Confirmar que las especificaciones del cliente coinciden con las definiciones IPC.
Calibrar el equipo de rayos X: Antes de escanear, ajuste el voltaje del tubo y la corriente objetivo según el espesor del PCB y el número de capas.
- Acción: Ejecutar una muestra de referencia o una placa de calibración.
- Verificación: Comprobar contraste y resolución de la imagen, por ejemplo si se distinguen hilos de 2 mil.
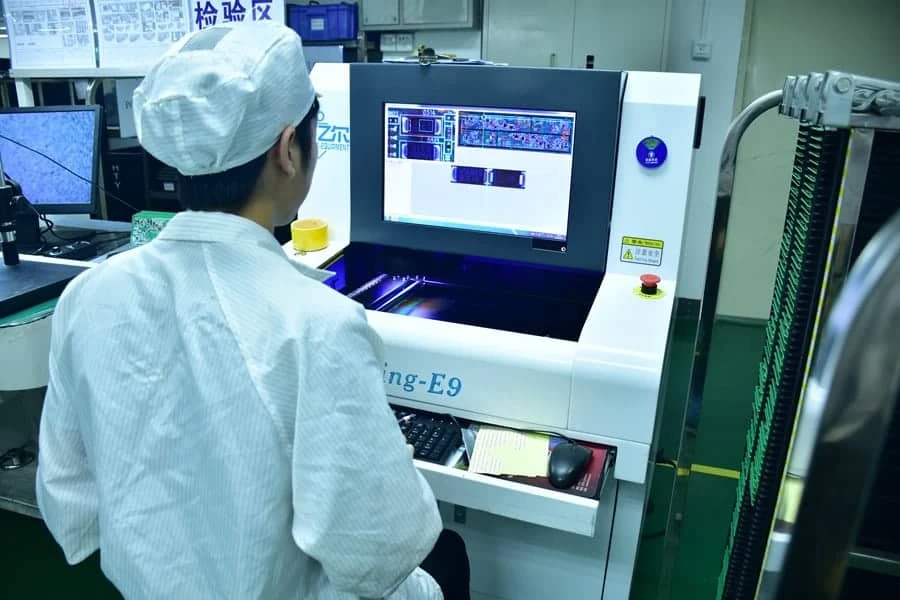
- Establecer la imagen de referencia:
Escanee una tarjeta comprobada como buena para fijar los valores base de escala de grises en las uniones de soldadura. Esto ayuda al sistema a diferenciar soldadura, cobre y vacíos.
- Acción: Enseñar al sistema AXI la posición de componentes a partir del archivo de colocación.
- Verificación: Verificar que todos los pines BGA sean identificados correctamente.

Ejecutar un escaneo 2D en vista superior: Realice un barrido rápido para detectar defectos gruesos como puentes, bolas faltantes o vacíos masivos.
- Acción: Calcular automáticamente los porcentajes de vacío.
- Verificación: Marcar cualquier esfera con más de 25% de área vacía.
Ejecutar escaneo inclinado o 3D (crítico para HiP): Las vistas superiores pasan por alto el head-in-pillow. Es necesario inclinar el detector o rotar la muestra.
- Acción: Inspeccionar bolas de esquina y encapsulados BGA grandes entre 45 y 60 grados.
- Verificación: Buscar la forma de muñeco de nieve o líneas de separación dentro de la esfera.
Analizar la ubicación del vacío: Si se detectan vacíos, determine si están en la zona central, menos crítica, o en la interfaz del pad, que sí es crítica.
- Acción: Ajustar la profundidad de enfoque cuando se use rayos X 3D.
- Verificación: Rechazar cualquier tarjeta con microvacíos planares sobre la superficie del pad.
Correlacionar con el perfil de refusión: Si aparecen defectos, relaciónelos con su ubicación en la tarjeta.
- Acción: Revisar si los defectos se concentran en zonas frías o calientes del horno.
- Verificación: Ajustar el tiempo sobre liquidus (TAL) si el problema de vacíos es sistémico.
Asegurar registro de datos y trazabilidad: Las imágenes de rayos X y el resultado de aceptación o rechazo deben guardarse enlazados al número de serie del PCB.
- Acción: Exportar el informe al sistema de gestión de calidad.
- Verificación: Asegurar que las imágenes puedan recuperarse para auditorías futuras.
Modos de falla y resolución de problemas
Cuando no se cumplen los criterios de rayos X para vacíos en BGA y head-in-pillow, normalmente existe una falla en alguna etapa previa del proceso. La siguiente guía ayuda a rastrear los síntomas hasta su causa raíz.
1. Síntoma: porcentaje de vacíos alto (>25%)
- Causas: Volátiles atrapados en la pasta, perfil de refusión demasiado corto, pads oxidados.
- Comprobaciones: Revisar la fecha de vencimiento de la pasta; verificar el tiempo de estabilización térmica del perfil.
- Corrección: Aumentar el tiempo en la zona de estabilización térmica para que los volátiles salgan antes de la fusión.
- Prevención: Usar hornos de refusión al vacío en productos de alta fiabilidad.
2. Síntoma: head-in-pillow (HiP)
- Causas: Alabeo del componente, depósito insuficiente de pasta, efecto almohada durante la refusión.
- Comprobaciones: Medir la coplanaridad del componente; revisar bloqueos en las aperturas del esténcil.
- Corrección: Utilizar un esténcil con aumento local de espesor para depositar más pasta; ajustar la velocidad de enfriamiento según el CTE del encapsulado.
- Prevención: Implantar un control de entrada estricto para PCBA que descarte componentes y placas deformados.
3. Síntoma: puentes de soldadura
- Causas: Exceso de pasta, presión de colocación demasiado alta, slump de la pasta.
- Comprobaciones: Revisar espesor del esténcil y reducción de aperturas, normalmente del 10 al 15%.
- Corrección: Limpiar la cara inferior del esténcil; reducir la fuerza de colocación.
- Prevención: Optimizar el diseño del esténcil con relaciones de aspecto adecuadas.
4. Síntoma: no humectación (unión abierta)
- Causas: Oxidación de pads, flux vencido, calor insuficiente.
- Comprobaciones: Revisar condiciones de almacenamiento del PCB respecto a MSL; verificar la temperatura pico.
- Corrección: Hornear los PCB para eliminar humedad; aumentar la temperatura pico sin dañar componentes.
- Prevención: Usar acabados ENIG u OSP con manejo correcto y dentro de su vida útil.
5. Síntoma: bolitas satélite
- Causas: Humedad en la pasta, rampa de calentamiento demasiado rápida.
- Comprobaciones: Revisar la humedad ambiental en la sala de impresión; confirmar una rampa menor de 3 °C/s.
- Corrección: Ajustar la rampa de subida; asegurar que la pasta alcance temperatura ambiente antes de imprimir.
- Prevención: Mantener controles ambientales estrictos en el área SMT.
6. Síntoma: efecto popcorn
- Causas: Absorción de humedad en el encapsulado BGA.
- Comprobaciones: Revisar el seguimiento del Moisture Sensitivity Level (MSL).
- Corrección: Hornear los componentes según J-STD-033 antes del ensamblaje.
- Prevención: Guardar componentes sensibles en gabinetes secos o en atmósfera de nitrógeno.
Decisiones de diseño
La capacidad de cumplir los criterios de rayos X para vacíos en BGA y head-in-pillow depende en gran medida del diseño del PCB. Conviene considerar estos factores ya en la fase de layout para facilitar tanto el ensamblaje como la inspección.
Definición del pad (SMD frente a NSMD):
- NSMD (Non-Solder Mask Defined): Suele ser la opción preferida para BGA. El pad de cobre es más pequeño que la abertura de máscara, lo que permite que la bola envuelva mejor el cobre y mejore el anclaje mecánico y la autoalineación.
- SMD (Solder Mask Defined): La máscara solapa el cobre. Esto puede crear concentraciones de esfuerzo donde se inician grietas, aunque a veces se usa en pitch muy fino para limitar puentes.
Tecnología de vías en pad:
- Las vías abiertas dentro de pads BGA son una causa frecuente de vacíos. La soldadura se drena hacia la vía, dejando una unión pobre o aire atrapado.
- Solución: Utilizar vías taponadas y rellenas (VIPPO) en los pads BGA. Así se obtiene una superficie plana y se reducen de forma importante la pérdida de soldadura y el riesgo de vacíos.
Colocación y orientación de componentes:
- Evite ubicar componentes pesados, como transformadores o blindajes, justo al lado de los BGA. La diferencia de masa térmica provoca calentamiento desigual, alabeo y defectos HiP.
- Deje espacio suficiente alrededor del BGA para la inspección por rayos X en ángulo. Los componentes altos cercanos pueden bloquear la visión y hacer inviable la inspección 2.5D.
Diseño del esténcil:
- En BGA de paso fino, las aperturas cuadradas con esquinas redondeadas suelen liberar la pasta mejor que las circulares.
- Los esténciles electropulidos mejoran la transferencia de pasta y reducen el riesgo de falta de soldadura que contribuye al HiP.
Para recomendaciones detalladas de layout, consulte nuestras guías DFM.
FAQ
1. ¿Qué diferencia hay entre IPC Clase 2 y Clase 3 respecto a los vacíos en BGA? En general, tanto la Clase 2 como la Clase 3 limitan los vacíos al 25% del área de la bola. Sin embargo, la Clase 3, orientada a alta fiabilidad, puede incluir requisitos específicos del cliente más estrictos sobre la ubicación de los vacíos, por ejemplo prohibiendo los interfaciales, y exige un control documental de proceso más riguroso.
2. ¿La radiografía 2D puede detectar un defecto head-in-pillow? Rara vez. En una vista 2D superior, la bola de soldadura se superpone con el depósito de pasta y ambos parecen unidos aunque exista separación vertical. Para ver esa capa de separación se necesita radiografía inclinada o laminografía 3D.
3. ¿Se permite retrabajo si un BGA falla en la inspección por rayos X? Sí. El retrabajo de BGA es un proceso estándar que implica retirar el componente, limpiar el sitio y volver a soldar una pieza nueva. Aun así, retrabajar varias veces puede dañar los pads. APTPCB limita por ello los ciclos de retrabajo para proteger la integridad de la tarjeta.
4. ¿Por qué los vacíos aparecen sobre todo en el centro de la bola? La causa principal es el desgasificado del flux. A medida que la soldadura se funde de afuera hacia adentro, los volátiles son empujados hacia el centro, la última zona en solidificar. Los vacíos centrales suelen ser menos dañinos que los vacíos en la interfaz del pad.
5. ¿Cómo afecta el acabado superficial al head-in-pillow? Las superficies oxidadas, como un OSP envejecido, impiden que la pasta humecte bien el pad. La pasta queda separada de la bola. Un acabado ENIG suele ofrecer mejor humectación y menor riesgo de HiP, siempre que no exista un defecto Black Pad.
6. ¿Qué es el efecto muñeco de nieve en rayos X? Es una firma visual típica de un head-in-pillow o de una refusión insuficiente observada en ángulo. La bola se posa sobre la pasta ya fundida sin fusionarse con ella y por eso recuerda a un muñeco de nieve.
7. ¿La refusión en nitrógeno reduce los vacíos? Sí. El nitrógeno reduce la oxidación de las superficies de soldadura durante la refusión y mejora la humectación. Una mejor humectación ayuda a que las burbujas de gas escapen del metal fundido y disminuye el porcentaje total de vacíos.
8. ¿La AOI puede reemplazar a los rayos X en BGA? No. La AOI depende de la línea de visión. Puede inspeccionar en algunos casos el perímetro exterior o la colocación del componente, pero no ve las uniones ocultas bajo el cuerpo del BGA. En estos casos la radiografía es obligatoria.
9. ¿Qué impacto de costo tiene una inspección por rayos X al 100%? La inspección al 100% es lenta y encarece el proceso. En producción masiva es habitual usar un plan de muestreo, por ejemplo basado en AQL, o inspeccionar solo los BGA más complejos y apoyarse en la validación de proceso para el resto.
10. ¿Cómo evito el HiP causado por alabeo? Use materiales de PCB con Tg alta, equilibre la distribución de cobre en el apilado para evitar deformaciones y optimice la velocidad de enfriamiento del perfil de refusión. Una aleación de menor temperatura como SnBi también puede reducir el esfuerzo térmico, aunque cambia las propiedades mecánicas.
11. ¿Qué es un vacío tipo Champagne? Es un tipo específico de vacío interfacial en el que muchas microcavidades se agrupan en la capa intermetálica. Es muy peligroso porque crea un plano de fractura débil y suele estar relacionado con problemas de recubrimiento.
12. ¿Cómo maneja APTPCB la inspección de BGA? Para NPI y ensamblajes complejos utilizamos capacidades avanzadas de rayos X 3D. Además, las combinamos con SPI para prevenir defectos antes incluso de colocar el componente.
Páginas relacionadas y herramientas
- Servicios de fabricación de PCB: Conozca nuestras capacidades para placas multicapa y HDI adecuadas para ensamblajes BGA.
- Inspección por rayos X: Vea cómo inspeccionamos uniones ocultas como vacíos y HiP durante el ensamblaje PCBA.
- Contáctenos: Solicite soporte técnico para sus requisitos específicos de fiabilidad en BGA.
- Guías DFM: Descargue nuestras reglas de diseño para optimizar el layout para fabricación e inspección.
Glosario (términos clave)
| Término | Definición |
|---|---|
| BGA (Ball Grid Array) | Encapsulado de montaje superficial para circuitos integrados en el que las conexiones se realizan mediante una matriz de esferas de soldadura. |
| Head-in-pillow (HiP) | Defecto en el que la bola BGA se apoya sobre la pasta de soldadura pero no coalesce en una sola unión. |
| Vacío | Bolsa de aire o gas atrapada dentro de una unión soldada. |
| Laminografía | Técnica radiográfica 3D que genera cortes seccionales del PCB para inspeccionar capas específicas. |
| Compuesto intermetálico (IMC) | Capa química formada entre la soldadura y el pad de cobre; es necesaria para la unión, pero se vuelve frágil si crece demasiado. |
| Coplanaridad | Distancia máxima entre la esfera más alta y la más baja de un componente; una coplanaridad deficiente favorece uniones abiertas. |
| Humectación | Capacidad de la soldadura fundida para extenderse sobre una superficie metálica y adherirse a ella. |
| Perfil de refusión | Curva de temperatura frente al tiempo que sigue el PCB dentro del horno; es crítica para activar el flux y fundir la soldadura. |
| Altura de separación | Distancia entre la cara inferior del componente y la superficie del PCB después del soldado. |
| IPC-7095 | Norma de la industria que guía específicamente el diseño y la implementación del proceso de ensamblaje para BGA. |
Conclusión
Dominar los criterios de rayos X para vacíos en BGA y head-in-pillow no consiste solo en cumplir una norma, sino en proteger la vida útil y la seguridad del producto final. Al aplicar los límites IPC, utilizar técnicas de inspección 3D y comprender las causas raíz de los defectos, los ingenieros pueden reducir de forma drástica las fallas en campo relacionadas con BGA.
En APTPCB integramos estos protocolos de inspección en nuestro flujo estándar. Desde un control de entrada estricto hasta análisis radiográficos avanzados, nos aseguramos de que cada tarjeta alcance el nivel de fiabilidad requerido. Si está trabajando con diseños BGA complejos o con retos de fiabilidad, nuestro equipo de ingeniería puede apoyarle con una revisión técnica completa.
