La placa desnuda ya esta terminada. Ha superado la prueba TDR de impedancia, la inspeccion microseccional y la verificacion del lote de material Rogers. Ahora entra en SMT, y ese proceso introduce un segundo conjunto de modos de fallo que la fabricacion por si sola no puede evitar.
El ensamblaje de PCB RO3003 es tecnicamente mas exigente que el ensamblaje estandar sobre FR-4 en cuatro areas concretas: gestion de humedad antes de entrar en linea, diseño del stencil de pasta de soldadura para estructuras de via bajo thermal pad, atmosfera y perfil de temperatura en reflow, e inspeccion posterior de uniones de soldadura ocultas. Cada una tiene una practica recomendada bien definida. Si se omite una sola, aparecen vacios bajo el thermal pad, delaminacion en la interfaz hibrida PTFE/FR-4 o fallos de soldadura que se manifiestan en los primeros cien ciclos termicos.
Esta guia cubre las cuatro con detalle: cual es el problema, como es la solucion de proceso y cuales son los criterios de aceptacion.
Cuatro variables de ensamblaje que los ajustes FR-4 no pueden manejar
Antes de revisar los pasos individuales del ensamblaje, conviene entender con precision que tiene RO3003 que hace inadecuados los parametros estandar de FR-4, no solo "distintos", sino capaces de inducir fallos.
Acabado superficial de plata por inmersion. La mayoria de las placas RO3003 optimizadas para RF llegan con acabado ImAg, la opcion preferida porque su deposito fino y plano es electromagneticamente transparente a altas frecuencias. A diferencia de ENIG, ImAg se empaña cuando se expone a compuestos de azufre o a temperaturas elevadas. Requiere reflow en atmosfera de nitrogeno y un perfil termico preciso que las lineas FR-4 de reflow en aire no proporcionan.
Sensibilidad a la humedad del sustrato hibrido. Aunque el propio RO3003 apenas absorbe humedad (0.04%), las capas internas de FR-4 de una placa hibrida son higroscopicas. La humedad que migra a la interfaz de union RO3003/FR-4 durante un ciclo de reflow a 250°C puede convertirse bruscamente en vapor y causar delaminacion interna. Los protocolos de prehorneado deben atender las capas FR-4, no tratar la placa como si fuera de un solo material.
Arreglos termicos POFV. Las vias rellenadas y metalizadas por encima bajo los thermal pads de los transceptores RF crean un reto SMT muy concreto: la pasta impresa sobre el arreglo puede colapsar hacia los barriles durante el reflow si el diseño de aperturas del stencil no lo contempla. La consecuencia es un vacio que bloquea la ruta termica principal y que no puede recuperarse con retrabajo. Ya en fase de diseño, la forma de rellenar y tapar la via determina lo plana que queda la superficie de apoyo, y eso afecta directamente la uniformidad del deposito de pasta sobre el arreglo. Las placas cuya metalizacion de tapa POFV no queda a ras del pad mostraran vacios previsibles en las zonas deprimidas, independientemente de la geometria del stencil.
Techo de temperatura pico mas bajo en reflow. El comportamiento de expansion termica del PTFE por encima de 250°C empieza a tensionar la interfaz entre la matriz de PTFE y el metalizado del barril de cobre de la via de una forma que no aparece en FR-4. Eso limita el perfil de reflow como se describe mas abajo.
Entender estas restricciones al planificar el ensamblaje, y no despues del primer barrido de rayos X 3D, es lo que separa un ensamblaje RO3003 de alto rendimiento de una cadena costosa de retrabajos.
Prehorneado por humedad: proteger la interfaz hibrida antes del reflow
La fisica de la delaminacion por vapor
La absorcion tipica de humedad del FR-4 es aproximadamente del 0.1% al 0.5% en peso tras la exposicion a condiciones ambientales normales. En una placa hibrida que ha pasado tiempo en un almacen sin control, ha viajado en contenedor o simplemente ha permanecido varios dias en inspeccion de entrada, las capas internas de FR-4 pueden absorber humedad del aire a traves de cualquier canto expuesto.
Durante el reflow, cuando la placa atraviesa el rango de 200–250°C, el agua absorbida en la interfaz de union FR-4/RO3003 se transforma en vapor. La expansion volumetrica es enorme. Si ese vapor no escapa antes de que la soldadura solidifique y la placa se enfrie, la presion resultante crea ampollas de delaminacion en la linea de union hibrida, visibles en corte transversal como una separacion entre la capa externa de RO3003 y el nucleo de FR-4.
Este es un defecto que acaba con la fiabilidad. La placa delaminada puede pasar toda la inspeccion de soldadura. Falla termicamente porque la interfaz FR-4/RO3003 deja de ser mecanicamente continua.
Protocolo de prehorneado
APTPCB prehornea todas las placas hibridas RO3003/FR-4 inmediatamente antes de su entrada en la linea SMT. El ciclo de horneado extrae la humedad absorbida por las capas de FR-4 sin oxidar agresivamente el acabado ImAg, un equilibrio tiempo/temperatura que debe caracterizarse para cada tipo de construccion.
Tras completarse el horneado, las placas entran en la linea SMT en cuestion de minutos. Si entre el horneado y el reflow vuelven a exponerse al aire ambiente, reabsorben humedad; el valor del prehorneado se consume si las placas esperan horas a temperatura ambiente antes de entrar en linea.
En programas donde no puede controlarse la ventana entre prehorneado y reflow, por ejemplo cuando las placas se hornean en una instalacion y se ensamblan en otra, el enfoque mas seguro es mantenerlas selladas en bolsas de barrera de humedad hasta la entrada en linea y programar el horneado justo antes de la colocacion, coordinando el final del horneado con el tiempo de setup de maquina y no con la orden de trabajo general.
Diseño de stencil window-pane: eliminar vacios en thermal pads
Por que falla un stencil de apertura completa sobre thermal pads
Una apertura de stencil estandar para el thermal pad de un QFN imprime un unico deposito continuo de soldadura que cubre toda el area del pad. Durante el reflow, la quimica del flux en la pasta se activa, limpia la superficie de cobre y necesita desgasificar a traves de la soldadura fundida. En un pad grande y plano con un solo deposito continuo, ese vapor no tiene por donde salir: nuclea en forma de vacios bajo el charco fundido y queda atrapado cuando la soldadura solidifica.
En placas RO3003 con arreglos POFV bajo el thermal pad, la situacion empeora: los vacios situados justo sobre columnas de via bloquean la via principal de extraccion termica. Un solo vacio grande sobre un conjunto de barriles de cobre puede elevar de forma notable la temperatura local de union por encima de lo previsto en el diseño termico. Esa perdida de margen afecta directamente la fiabilidad del RFIC bajo ciclado termico.
Diseño de apertura window-pane
El stencil window-pane divide la apertura del thermal pad en una rejilla de segmentos mas pequeños separados por nervios libres de pasta, normalmente de 0.15–0.20mm. El principio es simple: durante el reflow, el vapor del flux escapa por esas aberturas antes de que la soldadura solidifique. Los pequenos depositos se fusionan al fundirse la soldadura, pero los canales de escape permanecen abiertos el tiempo suficiente para que salga el gas.
Parametros window-pane para estructuras de thermal pad en RO3003:
- Area de cada segmento individual: ≤1.5 × 1.5mm
- Ancho del nervio: 0.15–0.20mm
- Cobertura total de pasta: 50–80% del area del thermal pad
- Espesor del stencil: 0.12–0.15mm, coherente con los pads perifericos adyacentes
Esta geometria de apertura, combinada con el reflow en atmosfera de nitrogeno de la siguiente seccion, produce de forma consistente un vaciado inferior al 10% en thermal pads sobre arreglos POFV bien diseñados. Para precisar las cifras: IPC-A-610 Clase 3 fija el limite de aceptacion en un 30% de vaciado agregado; el limite interno de APTPCB es mas estricto, del 20%. La cifra por debajo del 10% es la capacidad real de proceso conseguida en produccion con esta geometria, es decir, lo que entrega el proceso y no el umbral con el que se juzga.
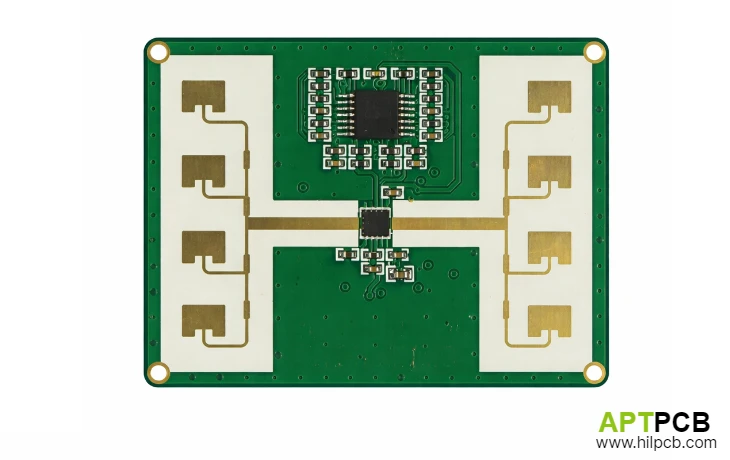
Reflow con nitrogeno: atmosfera, perfil y objetivos de temperatura
Por que el nitrogeno es obligatorio para ensamblajes ImAg/RO3003
El reflow en aire a temperaturas de ensamblaje de modulos RF introduce dos mecanismos de fallo:
Empañamiento de ImAg. La plata por inmersion se oxida a temperatura elevada en una atmosfera con oxigeno. Una superficie ImAg empañada pierde soldabilidad; la soldadura no moja de forma uniforme y aparecen juntas abiertas o cobertura con alto nivel de vacios sobre pads que parecian limpios antes del reflow.
Oxidacion del polvo de soldadura. Las particulas de la pasta desarrollan peliculas de oxido durante la rampa cuando la atmosfera del horno contiene oxigeno. Estas peliculas aumentan la viscosidad de la soldadura en reflow, reducen la fuerza de humectacion y fomentan la formacion de vacios en todas las uniones, no solo en los thermal pads.
Los hornos de reflow de APTPCB para modulos RF RO3003 trabajan en atmosfera de nitrogeno puro con oxigeno residual por debajo de 500 ppm. A ese nivel, la oxidacion de la superficie ImAg es despreciable en todo el ciclo termico y la humectacion de la pasta es claramente mejor que en reflow con aire.
Perfil de reflow para placas hibridas RO3003
| Etapa | Objetivo | Restriccion |
|---|---|---|
| Rampa de precalentamiento | 1.5–2°C/segundo | Si sube demasiado rapido: choque termico a la interfaz FR-4/RO3003 |
| Zona de soak, activacion del flux | 150–180°C, 60–90 segundos | Insuficiente: activacion incompleta del flux y formacion de vacios |
| Temperatura pico | 245–250°C | Maximo 260°C; un pico mas bajo reduce la tension en la interfaz PTFE/cobre |
| Tiempo sobre liquidus, 183°C | 30–45 segundos | Mas tiempo: mayor estres termico; menos tiempo: coalescencia incompleta |
| Velocidad de enfriamiento | ≤3°C/segundo | Mas rapida: choque termico a la linea de union hibrida |
El pico de 245–250°C es inferior a los 255–260°C habituales en lineas FR-4. La reduccion es deliberada: el comportamiento de expansion del PTFE por encima de 250°C empieza a tensionar la interfaz entre la matriz de PTFE y el metalizado del barril de cobre de la via. Un pico mas bajo, con tiempo suficiente sobre liquidus para una coalescencia completa, ofrece mejor fiabilidad a largo plazo en las uniones sobre sustratos RO3003.
Siempre que sea posible, los pases multiples de reflow por encima de 220°C deben limitarse a dos. Si un retrabajo exige un tercer pase, debe evaluarse la integridad de la interfaz PTFE/FR-4 antes de devolver la placa al servicio.
Consideraciones de colocacion de componentes para transceptores RF
Coplanaridad del thermal pad
Los CI RF en encapsulado QFN o chip-scale suelen tener un thermal pad expuesto que debe hacer contacto uniforme con el deposito POFV. La coplanaridad del encapsulado, es decir, la variacion de altura entre terminales, debe mantenerse dentro de la altura del deposito de pasta para que el thermal pad contacte de forma consistente.
Antes de entrar en linea, verifique que la coplanaridad del componente esta dentro de 0.05mm. Los componentes que superan ese umbral generan contacto desigual en el thermal pad, con vacios previsibles en la o las esquinas elevadas incluso cuando el diseño window-pane del stencil es correcto.
Pads de conectores RF de paso fino
Muchos modulos RF incluyen conectores edge-launch para acceso de prueba. Suelen tener un pitch de 0.5mm o menor. En placas RO3003 con acabado ImAg, la planitud del acabado es una ventaja: la capa fina y plana de ImAg no crea la variacion de altura que produciria HASL. Estas estructuras de paso fino requieren inspeccion SPI del deposito de pasta antes de la colocacion, para confirmar volumen y registro antes de montar cualquier componente.
Consideraciones de underfill en entornos severos
Los modulos RF que trabajan en entornos severos, como exterior automotriz, estaciones base al aire libre o aplicaciones aerotransportadas, sufren niveles de vibracion y tasas de choque termico que pueden superar la vida a fatiga de las uniones de grandes BGA sin underfill. Cuando se utilizan BGA sobre placas RO3003, la seleccion del underfill debe considerar la adhesion al acabado ImAg y la compatibilidad con el dielectrico RO3003, porque no todas las formulaciones humectan adecuadamente sustratos basados en PTFE.
Inspeccion 3D por rayos X: la unica forma de ver lo que importa
Lo que AOI no ve
Tras el reflow, las camaras AOI estandar fotografian el ensamblaje desde arriba. En transceptores RF QFN, donde todas las juntas quedan ocultas bajo el cuerpo del componente; en BGA, donde las bolas quedan completamente encerradas; y en thermal pads expuestos visibles solo a traves del componente, AOI no ve nada relevante. Precisamente los componentes mas criticos de una placa RF de alta frecuencia son aquellos ante los que AOI esta ciego.
Los rayos X 2D mejoran la situacion, pero no bastan para estructuras POFV: una proyeccion 2D aplasta en una sola imagen las columnas de cobre de las vias, la capa de soldadura superior y las capas de la placa inferiores. No es posible medir de manera aislada el area de vacio de la capa de soldadura.
3D AXI con tomografia computarizada
Los sistemas 3D Automated X-Ray Inspection de APTPCB reconstruyen un modelo volumetrico de alta resolucion a partir de proyecciones multiangulo. Los ingenieros de calidad cortan exactamente el plano de la capa de soldadura, aislado del cobre de via por encima y de las capas de placa por debajo, y miden:
- Porcentaje total agregado de vacio sobre el thermal pad
- Dimensiones y posicion de vacios individuales
- Cercania de cada vacio a columnas de via POFV
Criterios de aceptacion de vacios para ensamblaje RO3003 en APTPCB:
| Criterio | IPC-A-610 Clase 3 | APTPCB interno |
|---|---|---|
| Vaciado total del thermal pad | ≤30% | ≤20% |
| Cualquier vacio individual | No especificado | ≤5% del area del pad |
| Cualquier vacio sobre una via termica POFV | No especificado | Tolerancia cero |
El criterio de tolerancia cero para vacios sobre vias termicas no aparece en IPC-A-610, sino que es una exigencia especifica de APTPCB derivada de simulacion termica. Un vacio directamente sobre una columna de cobre rellena corta la via principal de extraccion de calor desde la union del RFIC al chasis. El resultado es operar por encima de la temperatura maxima de union, primero con compresion gradual de ganancia y despues con fallo del dispositivo. Ningun margen de diseño compensa una ruta termica rota.
Inspeccion de primer articulo para programas de ensamblaje RO3003
Antes de liberar las series de produccion, APTPCB realiza una First Article Inspection en los programas de ensamblaje RO3003. En un modulo RF, la FAI incluye:
- 100% de 3D AXI en todos los componentes bottom-terminated
- Microseccion de un conjunto representativo de uniones de soldadura, thermal pad mas pads perifericos
- Medicion de resistencia termica en la ruta del RFIC, si el acceso de prueba lo permite
- Documentacion del perfil de reflow para esa combinacion especifica de placa y horno
- Datos SPI de pasta de soldadura del primer ciclo de impresion de produccion
La documentacion FAI se convierte en la referencia contra la que se mide el muestreo de los lotes de produccion. Si la tendencia de vacios empeora en produccion, los datos FAI permiten identificar si la desviacion esta en el rendimiento del stencil, en el volumen de pasta o en el perfil del horno, sin tener que reconstruir la causa raiz desde cero.
Por que importa integrar fabricacion y ensamblaje para RO3003
La forma mas fiable de ejecutar el ensamblaje de una RO3003 es no separarlo de la fabricacion. Cuando la fabricacion de la placa desnuda y el SMT se realizan por el mismo equipo y en la misma instalacion:
- el tiempo del prehorneado queda controlado por el mismo calendario que gestiona la carga de linea
- la vida util de ImAg se gestiona con conocimiento directo de la fecha de fabricacion de la placa
- los datos de planaridad superficial POFV de fabricacion estan disponibles para el ingeniero de ensamblaje que diseña las aperturas del stencil
- los resultados de vaciado por 3D AXI retroalimentan directamente al equipo de fabricacion como indicador de rendimiento del proceso
Cuando fabricacion y ensamblaje se reparten entre dos proveedores, la responsabilidad por los fallos de vaciado se fragmenta: el ensamblador los atribuye a la planaridad POFV o a degradacion de ImAg durante el envio; el fabricante de la placa culpa al perfil de reflow. El OEM absorbe la responsabilidad y el retraso.
El servicio turnkey de APTPCB cubre desde la fabricacion de PCB Rogers RO3003 hasta el ensamblaje SMT con documentacion DFM compartida, almacenamiento co-ubicado y un unico sistema IATF 16949 que cubre ambas etapas del proceso.
Si su programa ya ha encontrado vacios inesperados en produccion, o si esta evaluando el diseño del stencil antes del primer prototipo, la via diagnostica mas rapida es comparar los cortes 3D AXI con la linea base FAI y cruzarlos con los registros del intervalo entre prehorneado y reflow. La mayoria de los problemas persistentes de vaciado en programas RO3003 se remontan a una de tres variables: deriva en el intervalo prehorneado-reflow, antigüedad de ImAg desde fabricacion o desgaste del stencil durante produccion. Contacte con nuestro equipo de ingenieria de ensamblaje con sus datos 3D AXI y normalmente podremos identificar la causa raiz antes de pedir un stencil nuevo.
Referencias
- Aceptacion de vacios SMT segun IPC-A-610 Acceptability of Electronic Assemblies, Class 3.
- Guias de perfil de reflow y atmosfera de nitrogeno del APTPCB High-Frequency SMT Assembly Control Plan (2026).
- Requisitos de prehorneado por humedad segun IPC-1601 Printed Board Handling and Storage Guidelines.
- Requisitos POFV segun IPC-4761 Design Guide for Protection of Printed Board Via Structures.