Garantir la fiabilité à long terme d'un assemblage Ball Grid Array (BGA) impose des contrôles non destructifs rigoureux, en particulier autour des critères radiographiques pour les vides BGA et le head-in-pillow (HiP). Contrairement aux joints de soudure visibles, les connexions BGA sont cachées sous le boîtier du composant, ce qui rend l'inspection optique classique insuffisante. Pour les ingénieurs et responsables qualité chez APTPCB, il est essentiel de maîtriser les limites d'acceptation et de rejet définies par les normes IPC afin d'éviter les défaillances terrain causées par la fatigue thermique ou des coupures électriques intermittentes. Ce guide détaille les signatures radiographiques, les seuils de mesure et les contrôles de procédé nécessaires pour valider l'intégrité d'un BGA.
Réponse rapide (30 secondes)
Pour obtenir un assemblage BGA fiable, les critères radiographiques pour les vides BGA et le head-in-pillow s'appuient généralement sur IPC-7095 et IPC-A-610.
- Limite de vides : En IPC classe 2 et classe 3, la surface totale des vides dans une même bille de soudure ne doit généralement pas dépasser 25 % de la surface totale de la bille.
- Head-in-pillow (HiP) : Ce défaut est considéré comme un indicateur de procédé et reste généralement non acceptable. Il se manifeste par une séparation nette ou une absence de coalescence entre la bille et la pâte à braser, comme si la bille reposait sur un coussin.
- Détection : Les vides apparaissent sur une radiographie 2D en transmission. Le HiP demande souvent une radiographie 2D inclinée (2,5D) ou une laminographie 3D (CT), car le recouvrement vertical peut masquer le défaut dans une vue de dessus.
- Zone critique : Les vides placés à l'interface entre la bille et le pad du composant sont plus critiques et justifient souvent un rejet quelle que soit leur taille, en raison du risque de propagation de fissures.
- Validation : Les systèmes d'inspection radiographique automatisée (AXI) doivent être calibrés pour distinguer les macrovides bénins des microvides planaires critiques.
Quand les critères radiographiques pour les vides BGA et le head-in-pillow s'appliquent (et quand ils ne s'appliquent pas)
Bien définir le périmètre d'inspection permet de concentrer les moyens sur les vrais risques de fiabilité plutôt que sur des défauts purement esthétiques.
Quand ces critères s'appliquent :
- Assemblage BGA et CSP : Tout composant dont les joints sont cachés sous le boîtier doit être validé par rayons X selon ces critères.
- Produits à haute fiabilité : En automobile, aéronautique ou médical (IPC classe 3), les cycles thermiques peuvent faire évoluer les vides en fissures.
- Validation de procédé : Pendant la phase d'inspection du premier article (FAI) pour ajuster le profil de refusion.
- Analyse de pannes intermittentes : Lorsqu'une carte passe le test électrique mais échoue sous vibration ou sous contrainte thermique.
- Introduction de nouveaux boîtiers : Lorsqu'on introduit des QFN ou des LGA à grands pads thermiques, avec des règles de vide légèrement différentes mais une physique similaire.
Quand ces critères ne s'appliquent pas ou s'interprètent autrement :
- Composants traversants standard : Les rayons X peuvent vérifier le remplissage des trous métallisés, mais les critères de vides BGA ne se transposent pas directement aux joints brasés à la vague.
- Broches visibles en aile de mouette : L'inspection optique automatisée (AOI) reste ici plus adaptée ; les rayons X ne sont utiles que pour des vérifications particulières comme les talons de soudure.
- Pads thermiques QFN/LGA : Les limites de vides sur de grandes surfaces thermiques sont souvent plus souples, parfois jusqu'à 50 % selon l'accord client, que pour les billes de signal d'un BGA.
- Applications avec résine de remplissage sous boîtier : Une fois cette résine déposée, le contraste radiographique change et la détection des vides devient plus difficile ; l'évaluation doit donc être faite avant l'encapsulation.
- Défauts cosmétiques de surface : Les rayons X traversent le composant ; les rayures sur le boîtier ne relèvent pas de ce jeu de critères.
Règles et spécifications
Le tableau suivant résume les paramètres techniques utilisés pour évaluer l'intégrité d'un BGA. Il transforme les critères radiographiques pour les vides BGA et le head-in-pillow en points de contrôle mesurables.
| Règle / Paramètre | Valeur ou plage recommandée | Pourquoi c'est important | Comment vérifier | Si c'est ignoré |
|---|---|---|---|---|
| Pourcentage total de vides | < 25 % de la surface radiographique (IPC classe 2/3) | De grands vides réduisent la conduction thermique et électrique et affaiblissent la tenue mécanique. | Calcul de surface par le logiciel AXI. | Rupture du joint lors des cycles thermiques. |
| Plus grand vide unitaire | < 20 % de la surface de la bille | Une grosse bulle unique crée une forte concentration de contraintes. | Mesurer le diamètre de la plus grande zone de faible densité. | Défaillance mécanique immédiate sous choc. |
| Signature head-in-pillow (HiP) | 0 % (rejet) | Elle indique l'absence de liaison métallurgique ; le joint n'est maintenu que par des résidus de flux ou une pression mécanique. | Radiographie inclinée à 45-70° ou analyse de coupe CT 3D. | Coupures intermittentes en service. |
| Diamètre de la bille de soudure | ±15 % de la valeur nominale de la fiche technique | Les variations traduisent un étirement dû au gauchissement ou un écrasement sous charge. | Mesure comparative avec des billes de référence. | Ouvertures de joints ou courts-circuits. |
| Pont de soudure / court-circuit | 0 (aucun admis) | C'est une défaillance électrique directe. | Liaison dense entre pads adjacents sur la radiographie. | Défaillance fonctionnelle immédiate. |
| Déformation des billes d'angle | < 25 % d'allongement | Les coins subissent la contrainte thermique la plus élevée ; l'allongement signale un gauchissement excessif. | Analyse géométrique des billes d'angle par rapport aux billes centrales. | Cratering de pad ou fatigue de soudure. |
| Vides interfaciaux | 0 % (contrôle strict) | Les vides au niveau de l'interface pad/soudure annoncent souvent un défaut de type Black Pad. | Radiographie à fort grossissement focalisée sur le plan du pad. | Rupture fragile catastrophique. |
| Joint sous-alimenté | Volume > 75 % du nominal | Un dépôt insuffisant de pâte à braser donne des liaisons fragiles. | Intégration de niveaux de gris pour estimation volumique. | Joints faibles sensibles aux vibrations. |
| Effet popcorn / éclatement | 0 occurrence | Indique qu'une humidité piégée dans le boîtier a explosé pendant la refusion. | Forme irrégulière et éclatée de la bille. | Destruction du composant et délaminage. |
| Alignement / décalage | < 25 % de la largeur du pad | Un décalage réduit la surface de contact et augmente le risque de pontage. | Mesurer l'écart centre à centre entre bille et pad. | Fiabilité réduite et courts-circuits possibles. |
| Angle de mouillage | Congé visible si observable | Un bon mouillage confirme une activité de flux correcte et une finition de pad adaptée. | Reconstruction 3D ou coupe micrographique. | Défauts de non-mouillage ou de démouillage. |
| Sphéricité de la bille | > 0,85 (rapport d'aspect) | Une bille non sphérique, si ce n'est pas voulu par conception, signale une refusion incomplète ou une contamination. | Logiciel d'analyse de forme. | Mauvais auto-alignement pendant la refusion. |
Étapes de mise en œuvre
Mettre en place un contrôle robuste pour les critères radiographiques des vides BGA et du head-in-pillow demande une démarche structurée. C'est ce qui garantit des données fiables et directement exploitables.
Définir la classe d'acceptation : Déterminez si le produit relève de l'IPC classe 2 (fiabilité standard) ou de la classe 3 (haute performance). Cela fixe le niveau d'exigence sur le pourcentage de vides admissible.
- Action : Mettre à jour les seuils du logiciel AXI.
- Vérification : Confirmer que les exigences client correspondent bien aux définitions IPC.
Calibrer l'équipement radiographique : Avant le scan, la tension du tube et le courant cible doivent être adaptés à l'épaisseur du PCB et au nombre de couches.
- Action : Lancer un échantillon de référence ou une plaque de calibration.
- Vérification : Contrôler le contraste et la résolution de l'image, par exemple la visibilité de fils de 2 mil.
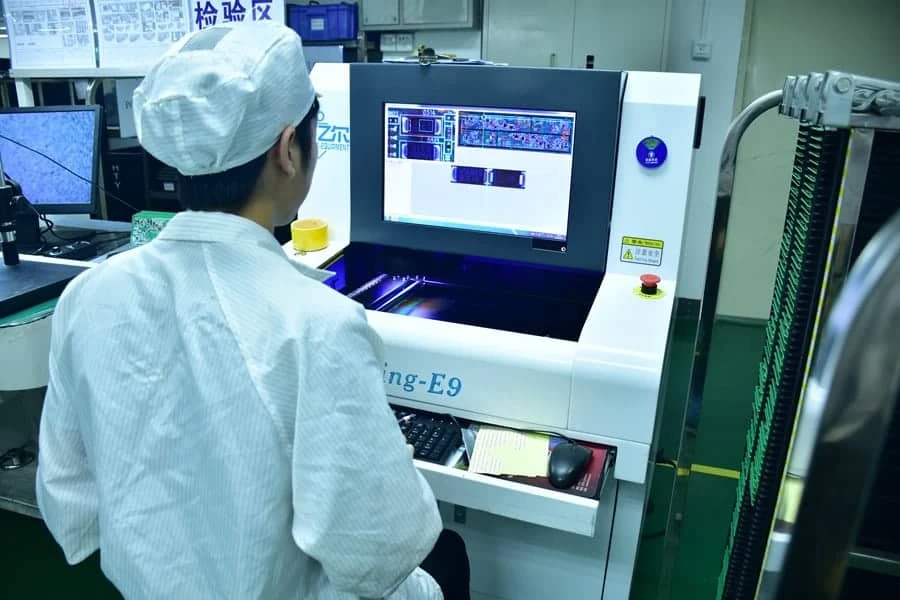
- Établir l'image de référence :
Scannez une carte connue comme conforme afin d'établir les valeurs de gris de référence des joints de soudure. Le logiciel pourra ainsi différencier correctement la soudure, le cuivre et les vides.
- Action : Enseigner au système AXI les positions de composants à partir du fichier de placement.
- Vérification : Vérifier que toutes les broches BGA sont correctement reconnues.

Réaliser un scan 2D en vue de dessus : Effectuez un contrôle rapide pour détecter les défauts grossiers comme les ponts, les billes manquantes ou les vides massifs.
- Action : Calculer automatiquement les pourcentages de vides.
- Vérification : Signaler toute bille dépassant 25 % de surface de vide.
Réaliser un scan incliné ou 3D (indispensable pour le HiP) : Une vue verticale passe souvent à côté d'un head-in-pillow. Il faut donc incliner le détecteur ou faire pivoter l'échantillon.
- Action : Inspecter les billes d'angle et les grands boîtiers BGA entre 45 et 60 degrés.
- Vérification : Rechercher une forme de bonhomme de neige ou des lignes de séparation dans la bille.
Analyser l'emplacement des vides : Lorsqu'un vide est détecté, il faut déterminer s'il est central, donc moins critique, ou situé à l'interface du pad, donc critique.
- Action : Ajuster la profondeur de focalisation en radiographie 3D.
- Vérification : Rejeter toute carte présentant des microvides planaires sur la surface du pad.
Corréler avec le profil de refusion : Si des défauts apparaissent, reliez-les à leur position sur la carte.
- Action : Vérifier si les défauts se concentrent dans les zones froides ou chaudes du four.
- Vérification : Ajuster le temps au-dessus du liquidus (TAL) si le taux de vides est systémique.
Assurer l'enregistrement des données et la traçabilité : Les images radiographiques et les décisions bon/mauvais doivent être conservées avec le numéro de série du PCB.
- Action : Exporter le rapport vers le système de management de la qualité.
- Vérification : S'assurer que les images sont retrouvables lors d'audits ultérieurs.
Modes de défaillance et dépannage
Si les critères radiographiques pour les vides BGA et le head-in-pillow ne sont pas respectés, la cause se situe généralement dans une étape amont du procédé. Cette grille aide à relier les symptômes aux causes racines.
1. Symptôme : fort pourcentage de vides (>25 %)
- Causes : Matières volatiles piégées dans la pâte, profil de refusion trop court, pads oxydés.
- Contrôles : Vérifier la date limite de la pâte à braser ; confirmer la durée de palier du profil.
- Correction : Allonger la zone de palier thermique afin de laisser les volatils s'échapper avant la fusion.
- Prévention : Utiliser des fours de refusion sous vide pour les produits à haute fiabilité.
2. Symptôme : head-in-pillow (HiP)
- Causes : Gauchissement du composant, dépôt de pâte insuffisant, effet de coussin pendant la refusion.
- Contrôles : Mesurer la coplanéité du composant ; vérifier l'obstruction des ouvertures de pochoir.
- Correction : Employer un pochoir à surépaisseur locale pour déposer plus de pâte ; ajuster la vitesse de refroidissement pour l'aligner avec le CTE du boîtier.
- Prévention : Mettre en place un contrôle d'entrée strict des PCBA afin d'écarter les composants et cartes déformés.
3. Symptôme : ponts de soudure
- Causes : Excès de pâte, pression de pose trop élevée, affaissement de la pâte.
- Contrôles : Vérifier l'épaisseur du pochoir et la réduction d'ouverture, généralement de 10 à 15 %.
- Correction : Nettoyer la face inférieure du pochoir ; réduire la force de placement.
- Prévention : Optimiser le design du pochoir avec les bons rapports d'aspect.
4. Symptôme : non-mouillage (joint ouvert)
- Causes : Oxydation des pads, flux périmé, chaleur insuffisante.
- Contrôles : Vérifier les conditions de stockage des PCB en lien avec le MSL ; contrôler la température de pointe.
- Correction : Étuvage des PCB pour éliminer l'humidité ; hausse mesurée de la température de pointe sans endommager les composants.
- Prévention : Employer correctement les finitions ENIG ou OSP dans leur durée de stockage utile.
5. Symptôme : billes satellites
- Causes : Humidité dans la pâte, montée en température trop rapide.
- Contrôles : Contrôler l'humidité de la salle d'impression ; vérifier une rampe inférieure à 3 °C/s.
- Correction : Ajuster la rampe de chauffe ; laisser la pâte revenir à température ambiante avant impression.
- Prévention : Maintenir des conditions environnementales strictes en zone SMT.
6. Symptôme : effet popcorn
- Causes : Absorption d'humidité par le boîtier BGA.
- Contrôles : Vérifier la traçabilité du Moisture Sensitivity Level (MSL).
- Correction : Étuvage des composants selon J-STD-033 avant assemblage.
- Prévention : Stocker les composants sensibles en armoire sèche ou sous atmosphère azotée.
Choix de conception
La capacité à respecter les critères radiographiques pour les vides BGA et le head-in-pillow dépend fortement de la conception du PCB. Les ingénieurs doivent intégrer les points suivants dès la phase de layout pour faciliter l'assemblage et l'inspection.
Définition des pads (SMD ou NSMD) :
- NSMD (Non-Solder Mask Defined) : Généralement préféré pour les BGA. Le pad cuivre est plus petit que l'ouverture du vernis épargne, ce qui permet à la bille d'envelopper le cuivre et améliore l'ancrage mécanique comme l'auto-alignement.
- SMD (Solder Mask Defined) : Le masque recouvre partiellement le cuivre. Cela peut créer des concentrations de contraintes où les fissures démarrent, même si cette approche est parfois retenue pour des pas très fins afin de limiter les ponts.
Technologie des vias dans pad :
- Des vias ouverts dans les pads BGA provoquent fréquemment des vides. La soudure descend dans le via, laissant un joint sous-alimenté ou de l'air piégé.
- Solution : Utiliser des vias bouchés et remplis (VIPPO) dans les pads BGA. On obtient ainsi une surface plane qui limite fortement la perte de soudure et le risque de vides.
Placement et orientation des composants :
- Éviter de placer des composants lourds, comme des transformateurs ou des blindages, juste à côté des BGA. La différence de masse thermique entraîne alors des échauffements inégaux, donc du gauchissement et des défauts HiP.
- Prévoir suffisamment de dégagement autour du BGA pour l'inspection radiographique inclinée. Des composants hauts peuvent bloquer la vue et rendre l'inspection 2,5D impossible.
Conception du pochoir :
- Sur les BGA à pas fin, les ouvertures carrées à coins arrondis libèrent souvent mieux la pâte que les ouvertures circulaires.
- Les pochoirs électropolis améliorent le relargage de pâte et réduisent ainsi le risque d'insuffisance de soudure favorisant le HiP.
Pour des recommandations détaillées de mise en page, consultez nos directives DFM.
FAQ
1. Quelle est la différence entre l'IPC classe 2 et la classe 3 pour les vides BGA ? Dans les grandes lignes, les deux classes limitent les vides à 25 % de la surface de la bille. La classe 3, destinée aux produits à haute fiabilité, peut toutefois imposer des exigences client plus strictes sur l'emplacement des vides, par exemple l'absence totale de vides interfaciaux, ainsi qu'une documentation de procédé plus rigoureuse.
2. La radiographie 2D peut-elle détecter un head-in-pillow ? Très rarement. En vue de dessus 2D, la bille et le dépôt de pâte se superposent et semblent soudés, même s'ils sont séparés verticalement. Une vue inclinée ou une laminographie 3D est nécessaire pour voir la couche de séparation.
3. La retouche est-elle autorisée si un BGA échoue au contrôle radiographique ? Oui. La retouche BGA est un procédé standard qui consiste à retirer le composant, nettoyer l'empreinte puis ressouder une pièce neuve. En revanche, des retouches répétées peuvent endommager les pads. APTPCB limite donc le nombre de cycles de reprise pour préserver l'intégrité de la carte.
4. Pourquoi les vides apparaissent-ils surtout au centre de la bille ? Le dégazage du flux est la cause principale. Lorsque la soudure fond de l'extérieur vers l'intérieur, les gaz sont poussés vers le centre, qui est la dernière zone à se solidifier. Les vides centraux sont généralement moins pénalisants que ceux situés à l'interface du pad.
5. Quel effet la finition de surface a-t-elle sur le head-in-pillow ? Des surfaces oxydées, comme un OSP vieilli, empêchent la pâte à braser de mouiller correctement le pad. La pâte reste alors séparée de la bille. Une finition ENIG offre en général un meilleur mouillage et réduit le risque de HiP, à condition qu'il n'y ait pas de défaut Black Pad.
6. Qu'est-ce que l'effet bonhomme de neige en radiographie ? Il s'agit d'une signature visuelle typique d'un head-in-pillow ou d'une refusion incomplète observée sous angle. La bille repose sur la pâte refondue sans fusionner avec elle, ce qui évoque la tête posée sur le corps d'un bonhomme de neige.
7. La refusion sous azote réduit-elle les vides ? Oui. L'azote limite l'oxydation des surfaces de soudure pendant la refusion et améliore le mouillage. Un meilleur mouillage aide les bulles de gaz à s'échapper du métal en fusion, ce qui réduit le pourcentage total de vides.
8. L'AOI peut-elle remplacer la radiographie pour les BGA ? Non. L'AOI dépend d'une ligne de visée. Elle peut parfois contrôler les rangées externes ou le positionnement du composant, mais elle ne voit pas les joints situés sous le boîtier BGA. La radiographie reste indispensable.
9. Quel est l'impact coût d'une inspection radiographique à 100 % ? Une inspection radiographique à 100 % est lente et coûteuse. En production de volume, on met souvent en place un plan d'échantillonnage, par exemple selon un niveau AQL, ou l'on réserve l'inspection systématique aux BGA complexes en s'appuyant sur la validation de procédé pour le reste.
10. Comment éviter le HiP dû au gauchissement ? Utilisez des matériaux PCB à Tg élevée, équilibrez la répartition du cuivre dans l'empilement pour limiter le cintrage et optimisez la vitesse de refroidissement du profil de refusion. Un alliage à plus basse température comme le SnBi peut aussi réduire les contraintes thermiques, au prix d'autres propriétés mécaniques.
11. Qu'est-ce qu'un vide de type Champagne ? C'est un type particulier de vide interfacial où de nombreuses microcavités se regroupent au niveau de la couche intermétallique. Ce défaut est très dangereux car il crée un plan de rupture fragile, souvent lié à des problèmes de métallisation.
12. Comment APTPCB gère-t-il l'inspection BGA ? Pour les projets NPI et les assemblages complexes, nous utilisons des capacités avancées de radiographie 3D. Nous les combinons avec le SPI afin d'empêcher les défauts avant même la pose du composant.
Pages connexes et outils
- Services de fabrication de PCB : Découvrez nos capacités pour les cartes multicouches et HDI adaptées aux assemblages BGA.
- Inspection radiographique : Découvrez comment nous contrôlons les joints cachés, comme les vides et le HiP, pendant l'assemblage PCBA.
- Nous contacter : Obtenez une assistance technique pour vos exigences de fiabilité BGA.
- Directives DFM : Téléchargez nos règles de conception pour optimiser votre layout pour la fabrication et l'inspection.
Glossaire (termes clés)
| Terme | Définition |
|---|---|
| BGA (Ball Grid Array) | Boîtier CMS pour circuits intégrés dans lequel les connexions sont assurées par une matrice de billes de soudure. |
| Head-in-pillow (HiP) | Défaut dans lequel la bille BGA repose sur la pâte à braser sans former un joint unique après refusion. |
| Vide | Présence d'une poche d'air ou de gaz piégée à l'intérieur d'un joint de soudure. |
| Laminographie | Technique radiographique 3D produisant des coupes de la carte pour inspecter des couches spécifiques. |
| Composé intermétallique (IMC) | Couche chimique formée entre la soudure et le pad cuivre ; indispensable à l'adhérence mais fragile si elle devient trop épaisse. |
| Coplanéité | Écart maximal entre la bille la plus haute et la plus basse d'un composant ; une mauvaise coplanéité favorise les joints ouverts. |
| Mouillage | Aptitude d'une soudure fondue à s'étaler sur une surface métallique et à s'y lier. |
| Profil de refusion | Courbe température/temps suivie par le PCB dans le four ; elle conditionne l'activation du flux et la fusion de la soudure. |
| Hauteur de dégagement | Distance entre le dessous du composant et la surface du PCB après soudage. |
| IPC-7095 | Norme industrielle dédiée au design et à la mise en œuvre du procédé d'assemblage des BGA. |
Conclusion
Maîtriser les critères radiographiques pour les vides BGA et le head-in-pillow ne consiste pas seulement à respecter une norme, mais à protéger la durée de vie et la sécurité du produit final. En appliquant les limites IPC, en utilisant des techniques d'inspection 3D et en comprenant les causes profondes des défauts, les ingénieurs peuvent presque éliminer les défaillances terrain liées aux BGA.
Chez APTPCB, ces protocoles de contrôle font partie intégrante de notre flux standard. Du contrôle strict des entrants jusqu'à l'analyse radiographique avancée, nous veillons à ce que chaque carte atteigne le niveau de fiabilité attendu. Si vous travaillez sur des conceptions BGA complexes ou sur des enjeux de fiabilité, notre équipe d'ingénierie peut vous accompagner avec une revue technique complète.
