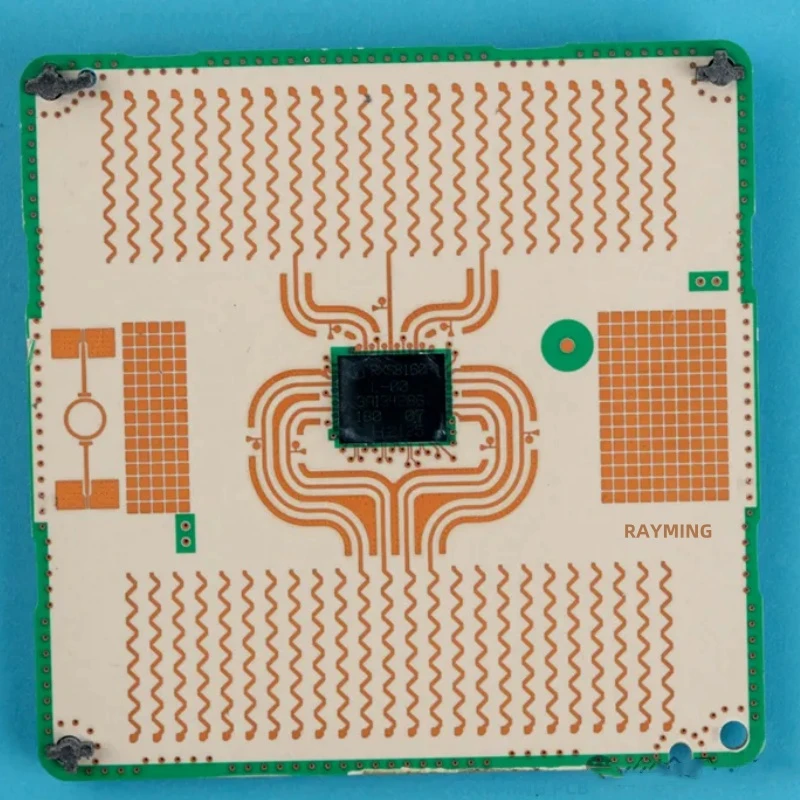
Compute
Accélérateur compute
BGA 0.3 mm avec boundary-scan, underfill et logs de refusion sous vide.
Boundary-scanUnderfillVacuum

0.3 MM PITCH • 01005 • VOID CONTROL
DFM, stencil/paste, placement ±25 µm, refusion azote, suivi AXI/voids, underfill et rework contrôlé pour garantir la fiabilité des joints cachés en pilotes comme en volume.
Nous combinons contrôle process et données d’inspection pour livrer des joints cachés avec preuves.
Support via-in-pad, PoP et microvias cuivre remplies.
Vision + support vacuum assurent CpK ≥1.33.
Tuning stencil/paste/profil + vacuum dwell.
COUVERTURE
Chaque gate — DFM, stencil, placement, refusion, inspection, underfill, rework — est piloté par la même équipe pour stabiliser le yield et contrôler les cycles de reprise.
DFM & land pattern
Revue pad design, mask clearance, via-in-pad fills et équilibrage cuivre pour limiter le warpage.
Stencil & pâte
Area ratio, step-stencil, pâte Type 5/6 et boucles feedback SPI stabilisent les dépôts.
Placement & refusion
Placement ±25 µm, support vacuum, refusion azote ΔT ≤5 °C avec thermocouples.
Inspection & rework
3D AOI, AXI en échantillonnage, rapports voids, underfill, staking et procédures rework ≤3 cycles.

PLAYBOOK
Des gates définis stabilisent les builds BGA/QFN haute densité, de l’intake au rework.
Intake package
Collecter drawings, pad stacks, specs pâte et objectifs de voids.
Tuning process
Sélection stencil/pâte, placement et simulations de refusion.
Production
SMT avec 100% SPI/AOI, support vacuum et refusion azote.
Inspection & analytics
AXI, rapports voids, contrôles ioniques et dashboards SPC.
Underfill & rework
Exécuter underfill/staking et rework contrôlé ≤3 cycles avec post-AXI.
PORTFOLIO
Builds à joints cachés que nous produisons chaque trimestre avec contrôle voids et limites de rework documentés.
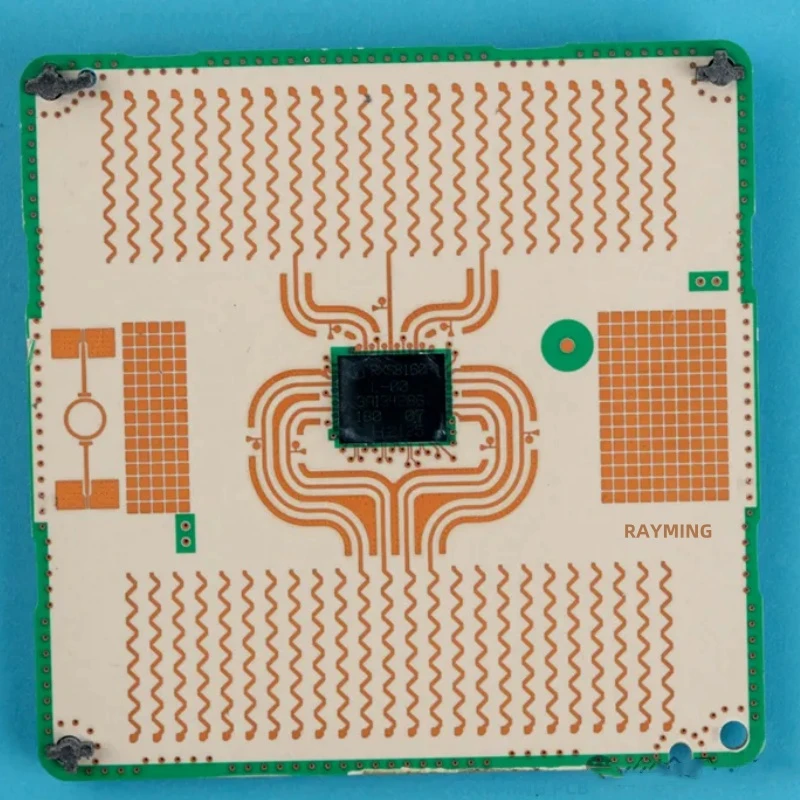



CAPABILITIES
Outils, outillages et analytics dimensionnés pour réussir les joints cachés.
Lignes dédiées refusion, AXI, underfill et rework avec contrôle d’humidité.



QUALITÉ
Inspection inline, AXI et analytique des voids rendent visibles les joints cachés.
Vérifications area ratio, SPC hauteur de pâte et boucles feedback machine.
Échantillonnage AXI et rapports C-SAM/voids avec objectifs BTC <10%.
≤3 cycles avec préparation site, impression pâte et vérification post-AXI.
BGAs haute densité avec boundary-scan, underfill et traçabilité rework.
Propreté, AOI/AXI et logs rework pour devices Class II/III.
Données void/hi-pot et preuves PPAP-ready pour ECUs et inverters.
Modules RF shielded avec refusion maîtrisée et objectifs de voids.
Everything you need to know about HDI PCB technology
Téléchargez vos fichiers pour recevoir un plan DFM, process et inspection pour les joints cachés.