La carte nue est terminee. Elle a deja passe les essais TDR d'impedance, l'inspection microsection et la verification de lot matiere Rogers. Elle entre maintenant en assemblage SMT, et ce processus introduit une seconde serie de modes de defaillance que la fabrication de la carte seule ne peut pas prevenir.
L'assemblage d'un PCB RO3003 est techniquement plus exigeant qu'un assemblage FR-4 standard dans quatre domaines precis : la gestion de l'humidite avant l'entree en ligne, la conception du pochoir de pate a braser pour les structures de vias sous thermal pad, l'atmosphere et le profil thermique de refusion, et l'inspection apres assemblage des joints de soudure caches. Chacun de ces points a sa bonne pratique clairement definie. En en sautant un seul, on voit apparaitre du voiding sous le thermal pad, de la delamination a l'interface hybride PTFE/FR-4, ou des defauts de soudure qui se manifestent dans les cent premiers cycles thermiques.
Ce guide couvre les quatre en detail : le probleme, la solution process et les criteres d'acceptation.
Quatre variables d'assemblage que les reglages FR-4 ne savent pas gerer
Avant de traiter les etapes d'assemblage une par une, il est utile de comprendre precisement ce qui rend RO3003 incompatible avec les parametres FR-4 standards, non pas simplement "different", mais reellement generateur de defauts.
Finition de surface Immersion Silver. La plupart des cartes RO3003 optimisees RF arrivent avec une finition ImAg, choix privilegie car le depot est fin, plat et electromagnetiquement transparent a haute frequence. Contrairement a l'ENIG, l'ImAg ternit sous l'effet de composes soufres ou de temperatures elevees. Elle exige une atmosphere de refusion a l'azote et un profil thermique precis que les lignes FR-4 classiques en refusion air ne fournissent pas.
Sensibilite a l'humidite du substrat hybride. Meme si le RO3003 lui-meme n'absorbe presque pas d'humidite (0,04 %), les couches internes FR-4 d'une carte hybride sont hygroscopiques. L'humidite qui migre jusqu'a l'interface de collage RO3003/FR-4 pendant un cycle de refusion a 250°C peut se transformer brutalement en vapeur et provoquer une delamination interne. Les protocoles de pre-cuisson doivent donc traiter les couches FR-4, et non la carte comme une unite monomatiere.
Reseaux de vias thermiques POFV. Les vias remplis puis recouverts de cuivre sous les thermal pads de transceivers RF posent un defi SMT bien precis : la pate imprimee au-dessus du reseau peut s'effondrer dans les futs lors de la refusion si le dessin des ouvertures du pochoir n'en tient pas compte. La consequence est un vide qui bloque le chemin thermique principal, qu'aucune reprise ne pourra restaurer. Des la phase de conception, la facon dont le via est rempli et cappe conditionne la planete de la surface d'appui, et donc l'uniformite du depot de pate sur le reseau. Les cartes dont le cap plating POFV n'est pas affleurant avec la surface du pad montreront des vides previsibles dans les zones en creux, quelle que soit la geometrie du pochoir.
Plafond de temperature de refusion plus bas. Le comportement de dilatation thermique du PTFE au-dessus de 250°C commence a solliciter l'interface entre la matrice PTFE et la metallisation cuivre du fut de via d'une maniere qui n'existe pas sur des cartes FR-4. Le profil de refusion se trouve donc contraint, comme detaille plus loin.
Comprendre ces contraintes des la preparation de l'assemblage, et non apres le premier passage en rayons X 3D, est ce qui fait la difference entre un assemblage RO3003 a haut rendement et une succession couteuse de reprises.
Pre-cuisson anti-humidite : proteger l'interface hybride avant refusion
La physique de la delamination par vapeur
Le taux d'absorption standard d'humidite du FR-4 est d'environ 0,1 a 0,5 % en masse apres exposition a des conditions ambiantes normales. Sur une carte hybride ayant sejourne dans un entrepot non controle, voyage en conteneur ou simplement attendu plusieurs jours en controle d'entree, les couches internes FR-4 peuvent absorber de l'humidite depuis l'air par n'importe quel chant de carte expose.
Pendant la refusion, lorsque la carte traverse la plage 200–250°C, l'eau absorbee a l'interface FR-4/RO3003 se transforme en vapeur. L'expansion volumique est considerable. Si cette vapeur ne peut pas s'echapper avant la solidification de la soudure et le refroidissement de la carte, la pression cree des cloques de delamination sur la ligne de collage hybride, visibles en coupe comme une separation entre la couche externe RO3003 et le noyau FR-4.
Il s'agit d'un defaut qui condamne la fiabilite. La carte delaminee peut pourtant passer toutes les inspections de soudure. Elle echoue thermiquement parce que l'interface FR-4/RO3003 n'est plus mecaniquement continue.
Protocole de pre-cuisson
APTPCB pre-cuit toutes les cartes hybrides RO3003/FR-4 immediatement avant leur entree sur ligne SMT. Le cycle de cuisson chasse l'humidite absorbee des couches FR-4 sans oxyder agressivement la finition ImAg, un compromis temps/temperature qui doit etre caracterise pour chaque type de construction.
Apres cuisson, les cartes entrent en ligne SMT en quelques minutes. Toute re-exposition a l'air ambiant entre cuisson et refusion reintroduit de l'humidite ; le benefice du pre-bake est consomme si les cartes attendent des heures a temperature ambiante avant l'entree en ligne.
Pour les programmes ou la fenetre entre pre-cuisson et refusion ne peut pas etre maitrisee, par exemple lorsque les cartes sont cuites sur un site et assemblees sur un autre, l'approche la plus sure consiste a conserver les cartes scellees dans leurs Moisture Barrier Bags jusqu'a l'entree en ligne et a programmer la cuisson juste avant la pose, en synchronisant la fin de cuisson avec le temps de reglage machine plutot qu'avec l'ordre de fabrication global.
Pochoir window-pane : eliminer les vides sous thermal pad
Pourquoi les pochoirs a ouverture pleine echouent sur les thermal pads
Une ouverture de pochoir standard pour un thermal pad de QFN imprime un depot unique et continu de pate a braser sur toute la surface du pad. Pendant la refusion, la chimie du flux s'active, nettoie la surface cuivre et doit degazer a travers la soudure fondue. Sur un pad large et plan avec un seul depot continu, cette vapeur de flux n'a aucun chemin de sortie : elle nuclee en vides sous le bain fondu et reste piegee quand la soudure se resolidifie.
Sur les cartes RO3003 avec reseaux POFV sous le thermal pad, la situation empire : les vides directement au-dessus des colonnes de vias bloquent le chemin principal d'extraction thermique. Un seul gros vide au-dessus d'un groupe de futs de vias cuivre peut faire monter sensiblement la temperature locale de jonction au-dela de ce qu'avait prevu le design thermique. Cette perte de marge affecte directement la fiabilite du RFIC sous cyclage thermique.
Conception d'ouverture window-pane
Le pochoir window-pane divise l'ouverture du thermal pad en une grille de petits segments separes par des bandes sans pate, generalement larges de 0,15 a 0,20mm. Le principe est simple : pendant la refusion, la vapeur du flux s'echappe par ces ouvertures avant que la soudure ne se resolidifie. Les multiples petits depots fusionnent quand la soudure fond, mais les canaux d'echappement restent ouverts suffisamment longtemps pour laisser sortir le gaz.
Parametres window-pane pour structures de thermal pad RO3003 :
- Surface d'un segment d'ouverture individuel : ≤1,5 × 1,5mm
- Largeur des bandes : 0,15–0,20mm
- Taux total de couverture de pate : 50–80 % de la surface du thermal pad
- Epaisseur de pochoir : 0,12–0,15mm, coherente avec les pads peripheriques adjacents
Cette geometrie d'ouverture, combinee a la refusion sous azote de la section suivante, produit de facon reguliere un voiding inferieur a 10 % sur les thermal pads au-dessus de reseaux POFV bien concus. Pour etre precis sur les chiffres : l'IPC-A-610 Classe 3 fixe la limite d'acceptation a 30 % de voiding cumule ; le seuil interne APTPCB est plus strict a 20 %. Le niveau inferieur a 10 % correspond a la capacite reelle du process atteinte en production avec cette geometrie de pochoir : c'est ce que le process delivre, pas la limite de jugement.
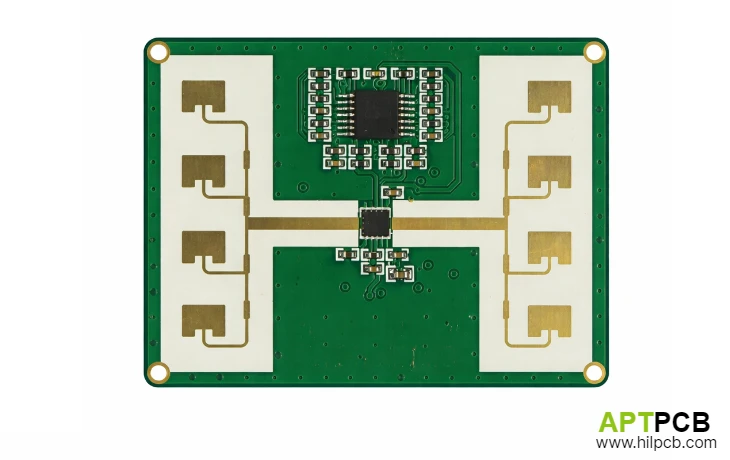
Refusion sous azote : atmosphere, profil et cibles de temperature
Pourquoi l'azote est requis pour l'assemblage ImAg/RO3003
Une refusion a l'air aux temperatures d'assemblage des modules RF introduit deux mecanismes de defaillance :
Ternissement de l'ImAg. La finition Immersion Silver s'oxyde a temperature elevee en atmosphere oxygenee. Une surface ImAg ternie perd en brasabilite ; la soudure ne mouille plus de facon uniforme, ce qui produit soit des joints ouverts, soit une couverture de soudure fortement vides sur des pads qui semblaient pourtant propres avant refusion.
Oxydation de la poudre de soudure. Les particules de pate a braser developpent des films d'oxyde pendant la rampe lorsque l'atmosphere du four contient de l'oxygene. Ces films augmentent la viscosite de la soudure pendant la refusion, diminuent la force de mouillage et favorisent la formation de vides dans toutes les soudures, pas uniquement sous les thermal pads.
Les fours de refusion APTPCB pour modules RF RO3003 fonctionnent sous atmosphere d'azote pur avec un taux d'oxygene residuel inferieur a 500 ppm. A ce niveau, l'oxydation de la surface ImAg est negligeable sur tout le cycle thermique, et le mouillage de la pate est nettement meilleur qu'en refusion a l'air.
Profil de refusion pour cartes hybrides RO3003
| Etape | Cible | Contrainte |
|---|---|---|
| Rampe de prechauffage | 1,5–2°C/seconde | Trop rapide : choc thermique sur l'interface FR-4/RO3003 |
| Zone de soak, activation du flux | 150–180°C, 60–90 secondes | Insuffisant : activation incomplete du flux, creation de vides |
| Temperature de pic | 245–250°C | Maximum 260°C ; un pic plus bas reduit les contraintes a l'interface PTFE/cuivre |
| Temps au-dessus du liquidus, 183°C | 30–45 secondes | Plus long : plus de contrainte thermique ; plus court : coalescence incomplete |
| Vitesse de refroidissement | ≤3°C/seconde | Plus rapide : choc thermique sur la ligne de collage hybride |
Le pic de 245–250°C est plus bas que les 255–260°C frequents sur lignes FR-4. Cette reduction est intentionnelle : au-dessus de 250°C, la dilatation thermique du PTFE commence a solliciter l'interface entre la matrice PTFE et le cuivre du fut de via. Un pic plus bas, avec un temps suffisant au-dessus du liquidus pour assurer une coalescence complete, donne une meilleure fiabilite a long terme des joints sur substrats RO3003.
Il faut, autant que possible, limiter a deux les passages de refusion au-dessus de 220°C. Si une reprise impose un troisieme passage, l'integrite de l'interface PTFE/FR-4 doit etre evaluee avant remise en service.
Considerations de placement des composants pour transceivers RF
Coplanarite du thermal pad
Les CI RF en boitier QFN ou chip-scale possedent generalement un thermal pad expose qui doit entrer en contact uniforme avec le depot de soudure POFV. La coplanarite du boitier, c'est-a-dire la variation de hauteur entre les terminaisons du composant, doit rester dans la hauteur du depot de pate pour garantir un contact coherent du thermal pad.
Avant l'entree en ligne, verifiez que la coplanarite du composant reste dans 0,05mm. Au-dela de ce seuil, le contact sur le thermal pad devient non uniforme, avec des vides previsibles au(x) coin(s) releve(s), meme si le pochoir window-pane est correctement dessine.
Pads de connecteurs RF a pas fin
De nombreux modules RF integrent des connecteurs RF edge-launch pour l'acces de test. Leur pas est typiquement de 0,5mm ou moins. Sur des cartes RO3003 avec finition ImAg, la planete du revetement est un avantage : le depot ImAg, fin et plan, ne cree pas les variations de hauteur qu'un HASL introduirait. Ces structures a pas fin imposent une inspection SPI du depot de pate avant placement afin de confirmer le volume et l'alignement avant de poser le moindre composant.
Considerations d'underfill pour environnements severes
Les modules RF fonctionnant dans des environnements severes, exterieur automobile, station de base outdoor ou applications aeroportees, subissent des niveaux de vibration et des gradients de choc thermique qui peuvent depasser la duree de vie en fatigue des grosses soudures BGA sans underfill. Lorsque des composants BGA sont utilises sur des cartes RO3003, le choix du materiau d'underfill doit prendre en compte son adhesion sur la surface ImAg et sa compatibilite avec le dielectrique RO3003, car toutes les formulations n'humectent pas correctement les substrats a base de PTFE.
Inspection RX 3D : la seule facon de voir ce qui compte
Ce que l'AOI ne voit pas
Apres refusion, les systemes d'AOI standard photographient l'assemblage par le dessus. Pour des transceivers RF QFN, dont toutes les soudures sont cachees sous le boitier, pour des BGA dont les billes sont entierement enfermees, et pour des thermal pads exposes mais visibles uniquement au travers du composant, l'AOI ne voit rien d'utile. Les composants les plus critiques d'une carte RF haute frequence sont justement ceux auxquels l'AOI est aveugle.
La radiographie 2D constitue un progres, mais elle reste insuffisante pour les structures POFV : une projection 2D ecrase dans une seule image les colonnes de cuivre des vias, la couche de soudure qui les recouvre et les couches de carte situees en dessous. Il devient impossible de mesurer de facon isolee la surface de vide dans la couche de soudure.
3D AXI avec tomographie calculee
Les systemes 3D Automated X-Ray Inspection d'APTPCB reconstruisent un modele volumique haute resolution a partir de projections multi-angles. Les ingenieurs qualite decoupent exactement le plan de la couche de soudure, isole du cuivre des vias au-dessus et des couches de carte en dessous, et mesurent :
- Le pourcentage total de vide cumule sur le thermal pad
- Les dimensions et la position des vides individuels
- La proximite des vides avec les colonnes de vias POFV
Criteres d'acceptation du voiding d'assemblage RO3003 chez APTPCB :
| Critere | IPC-A-610 Classe 3 | APTPCB interne |
|---|---|---|
| Voiding total du thermal pad | ≤30% | ≤20% |
| Tout vide individuel | Non specifie | ≤5% de la surface du pad |
| Tout vide au-dessus d'une via thermique POFV | Non specifie | Tolerance zero |
Le critere de tolerance zero pour les vides au-dessus de vias thermiques n'apparait pas dans l'IPC-A-610. C'est une exigence specifique APTPCB issue de la simulation thermique. Un vide directement au-dessus d'une colonne de cuivre remplie coupe le chemin principal d'evacuation de chaleur entre la jonction RFIC et le chassis. Le resultat est un fonctionnement au-dessus de la temperature maximale de jonction, d'abord avec compression de gain progressive puis avec defaillance du composant. Aucune marge de conception ne peut compenser un chemin thermique rompu.
First Article Inspection pour les programmes d'assemblage RO3003
Avant de liberer les series de production, APTPCB realise une First Article Inspection sur les programmes d'assemblage RO3003. Pour un module RF, la FAI comprend :
- 100 % de 3D AXI sur tous les composants bottom-terminated
- Une microsection d'un ensemble representatif de joints, thermal pad plus pads peripheriques
- Une mesure de resistance thermique sur le chemin du RFIC, si l'acces de test le permet
- La documentation du profil de refusion pour la combinaison carte/four concernee
- Les donnees SPI de pate a braser du premier cycle d'impression de production
La documentation FAI devient la reference utilisee pour juger les echantillonnages des lots de production. Si les tendances de voiding se degradent en production, les donnees FAI permettent d'identifier si l'ecart vient du pochoir, du volume de pate ou du profil four, sans devoir reconstruire l'analyse de cause racine depuis zero.
Pourquoi l'integration fabrication + assemblage compte pour RO3003
La facon la plus fiable d'executer l'assemblage d'une carte RO3003 est de ne pas le separer de la fabrication. Lorsque la fabrication de la carte nue et l'assemblage SMT sont realises par la meme equipe dans la meme usine :
- le timing de pre-cuisson est pilote par le meme planning que le chargement de ligne
- la duree de vie de l'ImAg est geree avec connaissance directe de la date de fabrication de la carte
- les donnees de planarite de surface POFV issues de la fabrication sont disponibles pour l'ingenieur assemblage qui dessine les ouvertures de pochoir
- les resultats de voiding en 3D AXI remontent directement a l'equipe fabrication comme indicateur de performance process
Quand fabrication et assemblage sont repartis entre deux fournisseurs, la responsabilite des defauts de voiding se fragmente : l'assembleur l'attribue a la planarite POFV ou a une degradation de l'ImAg pendant le transport ; le fabricant de la carte l'impute au profil de refusion. L'OEM conserve la responsabilite et le retard planning.
Le service turnkey d'APTPCB couvre la fabrication de PCB Rogers RO3003 jusqu'a l'assemblage SMT, avec documentation DFM partagee, stockage co-localise et systeme qualite IATF 16949 unique couvrant les deux etapes du process.
Si votre programme a deja rencontre un voiding inattendu en production, ou si vous evaluez le dessin du pochoir avant le premier prototype, le diagnostic le plus rapide consiste a comparer les coupes 3D AXI a la baseline FAI et a les croiser avec les enregistrements de delai entre pre-cuisson et refusion. La plupart des problemes persistants de voiding sur programmes RO3003 remontent a l'une de trois variables : derive de l'intervalle pre-bake/refusion, age de l'ImAg depuis fabrication ou usure du pochoir en production. Contactez notre equipe d'ingenierie d'assemblage avec vos donnees 3D AXI, et nous pouvons generalement identifier la cause racine avant meme qu'un nouveau pochoir soit commande.
References
- Acceptation des vides SMT selon IPC-A-610 Acceptability of Electronic Assemblies, Class 3.
- Recommandations de profil de refusion et d'atmosphere azote issues du APTPCB High-Frequency SMT Assembly Control Plan (2026).
- Exigences de pre-cuisson humidite selon IPC-1601 Printed Board Handling and Storage Guidelines.
- Exigences POFV selon IPC-4761 Design Guide for Protection of Printed Board Via Structures.