Lagenaufbau mit geringer Wärmeleitfähigkeit: Definition, Anwendungsbereich und Zielgruppe dieses Leitfadens
Bei der überwiegenden Mehrheit der Leiterplattendesigns besteht das Ziel darin, Wärme so schnell wie möglich abzuleiten. Ein spezialisiertes Ingenieurwesen erfordert jedoch genau das Gegenteil: einen Lagenaufbau mit geringer Wärmeleitfähigkeit. Diese Designstrategie ist entscheidend, wenn das Ziel darin besteht, empfindliche Komponenten thermisch von der Umgebung oder von anderen Teilen der Schaltung zu isolieren. Dies ist am häufigsten in kryogenen Anwendungen, Quantencomputing-Hardware, präzisions-ofen-kontrollierten Oszillatoren (OCXOs) und Infrarotsensor-Arrays der Fall, wo Wärmeleckagen Signalrauschen oder Systemausfall bedeuten.
Dieses Playbook richtet sich an Hardware-Ingenieure, Wärme-Architekten und Einkaufsleiter, die Leiterplatten spezifizieren und beschaffen müssen, die als Wärmesperren fungieren. Im Gegensatz zu Standard-FR4-Leiterplatten, bei denen Kupferflächen maximiert werden, erfordert ein Lagenaufbau mit geringer Wärmeleitfähigkeit kontraintuitive Designentscheidungen – wie die Minimierung von Kupferquerschnitten, die Verwendung spezifischer Harzsysteme und den Einsatz komplexer Routing-Strategien wie thermischer Mäander. Bei APTPCB (APTPCB PCB Factory) sehen wir oft, dass Designs nicht aufgrund von Problemen mit der elektrischen Konnektivität fehlschlagen, sondern weil die Wärmeleckrate höher war, als das Kühlbudget zuließ. Dieser Leitfaden geht über die grundlegende Theorie hinaus und bietet ein beschaffungsbereites Rahmenwerk. Er behandelt, wie Spezifikationen zur Begrenzung von Wärmebrücken definiert werden, wie diese Leiterplatten vor der Massenproduktion validiert werden und wie Lieferanten auditiert werden, um sicherzustellen, dass sie die empfindlichen Materialien handhaben können, die oft für hochisolierende Schaltungen erforderlich sind.
Wann ein Aufbau mit geringer Wärmeleitfähigkeit verwendet werden sollte (und wann ein Standardansatz besser ist)
Das Verständnis des Wärmepfades ist der erste Schritt bei der Entscheidung, ob ein spezialisierter Aufbau notwendig ist. Wärme in einer Leiterplatte wandert hauptsächlich durch die Kupferschichten (die eine Wärmeleitfähigkeit von ~385 W/m·K haben) und nicht durch das dielektrische Material (typischerweise 0,25–0,35 W/m·K). Ein Aufbau mit geringer Wärmeleitfähigkeit ist erforderlich, wenn der standardmäßige Wärmefluss durch Strom- und Masseebenen das thermische Gleichgewicht des Systems stören würde.
Verwenden Sie einen Aufbau mit geringer Wärmeleitfähigkeit, wenn:
- Kryogene Systeme: Sie eine Kryostat-Durchführungs-Leiterplatte entwerfen, bei der die Elektronik Raumtemperatur (300K) und kryogene Zonen (4K oder niedriger) überbrückt. Übermäßige Wärmeleitung verdampft flüssiges Helium oder überlastet Kryokühler.
- Präzisionssensorik: Sie ein Layout für extrem rauscharme Auslesung für Bolometer oder IR-Sensoren implementieren, bei dem thermische Schwankungen als Rauschen im Datenstrom erscheinen.
- Thermische Isolation: Sie müssen eine Komponente auf einer stabilen hohen Temperatur halten (z. B. einen Heizer oder Sensor), ohne die umgebende Steuerlogik zu erwärmen.
- Vakuumumgebungen: Konvektion ist nicht vorhanden, was bedeutet, dass die Wärmeleitung durch die Leiterplatte der primäre Wärmeübertragungsmechanismus ist, der gedrosselt werden muss.
Bleiben Sie bei einem Standard-Lagenaufbau, wenn:
- Hohe Leistungsdichte: Wenn die Komponenten erhebliche Eigenwärme erzeugen (Watt vs. Milliwatt), führt ein Design mit geringer Wärmeleitfähigkeit dazu, dass die Komponenten überhitzen und ausfallen.
- Hochgeschwindigkeits-Digital: Wenn Sie durchgehende, ununterbrochene Referenzebenen für die Impedanzkontrolle auf langen Leiterbahnen benötigen, können die für die thermische Isolation erforderlichen Aussparungen und Hohlräume die Signalintegrität beeinträchtigen.
- Standard-Unterhaltungselektronik: Wenn das Ziel lediglich darin besteht, das Gehäuse kühl zu halten, sind Standard-Thermovias und Kühlkörper kostengünstiger als die Entwicklung eines spezialisierten Substrats mit geringer Leitfähigkeit.
Spezifikationen für Lagenaufbau mit geringer Wärmeleitfähigkeit (Materialien, Lagenaufbau, Toleranzen)
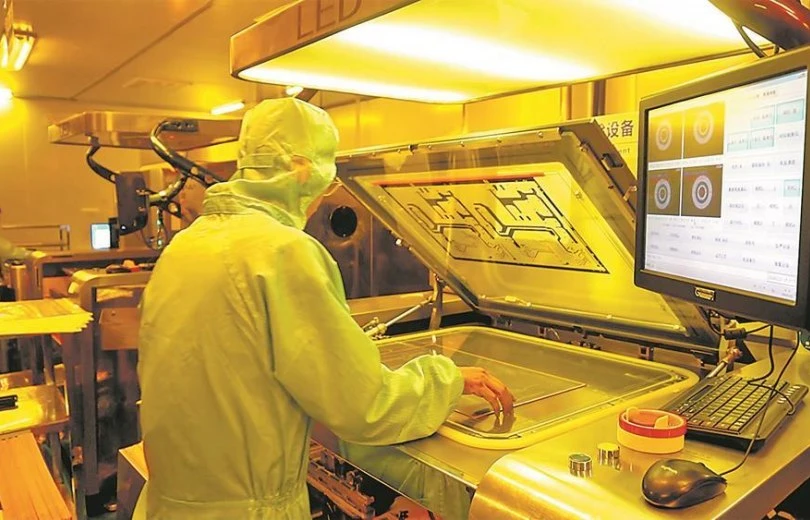
Die frühzeitige Definition der richtigen Parameter verhindert kostspielige Neuentwicklungen. Ziel ist es, die Querschnittsfläche leitfähiger Materialien zu minimieren und gleichzeitig die strukturelle Integrität zu erhalten.
- Auswahl des dielektrischen Materials:
- Polyimid: Bevorzugt für kryogene und Vakuumanwendungen aufgrund seiner Stabilität und moderaten Wärmebeständigkeit.
- Edelstahlverkleidung: Gelegentlich in starren Segmenten zur strukturellen Unterstützung verwendet, da Edelstahl eine deutlich geringere Wärmeleitfähigkeit (~16 W/m·K) im Vergleich zu Kupfer aufweist.
- Epoxid/Glas (FR4): Akzeptabel für nicht-kryogene Isolation, wenn der Harzgehalt hoch ist (Harz leitet weniger Wärme als Glasgewebe).
- Kupfergewicht:
- Spezifizieren Sie 1/3 oz (12µm) oder 1/2 oz (18µm) Kupferfolie. Vermeiden Sie 1 oz oder 2 oz Kupfer, es sei denn, es ist für die Strombelastbarkeit absolut notwendig, da Kupfer der primäre Wärmeleckpfad ist.
- Leiterbahngeometrie & -führung:
- Leiterbahnbreite: Minimale herstellbare Breite (z.B. 3–4 mil), um den Wärmewiderstand zu erhöhen.
- Leiterbahnlänge: Verwenden Sie eine "mäanderförmige" oder "serpentinenartige" Führung, um die effektive Wärmepfadlänge zwischen heißen und kalten Zonen zu erhöhen.
- Lagenaufbau-Konfiguration:
- Keine massiven Flächen: Massive Strom-/Masseflächen in der Wärmeisolationszone sind zu vermeiden. Verwenden Sie gerasterte Flächen (Gitter) mit <20% Kupferdichte, falls eine Abschirmung erforderlich ist.
- Dünnere Dielektrika: Obwohl kontraintuitiv, ermöglichen dünnere Dielektrika dünnere Gesamtplatinen, wodurch die Querschnittsfläche der Glas/Epoxid-Matrix reduziert wird.
- Beschichtung & Oberflächenveredelung:
- ENIG (Electroless Nickel Immersion Gold): Bevorzugt gegenüber HASL. Nickel wirkt als Diffusionsbarriere und hat eine geringere Wärmeleitfähigkeit als reines Kupfer oder Zinn-Blei.
- Hartgold: Für Kantensteckverbinder in Kryostat-Durchführungen.
- Via-Design:
- Via-Fencing: Verwenden Sie keine Via-Fences in Isolationszonen.
- Via-Größe: Verwenden Sie den kleinsten mechanischen Bohrer (z.B. 0,15 mm oder 0,2 mm), um das Volumen des plattierten Kupferzylinders zu minimieren.
- Lötstopplack:
- Standard-LPI ist akzeptabel, aber für Vakuumanwendungen ist ein emissionsarmer Lötstopplack oder eine minimale Maskenabdeckung anzugeben.
- Maßtoleranzen:
- Dickentoleranz: ±10% ist Standard, aber für thermische Berechnungen kann eine engere Toleranz (±5%) erforderlich sein, um die Querschnittsfläche des Dielektrikums zu gewährleisten.
- Impedanzkontrolle:
- Wenn Impedanz über schraffierten Ebenen erforderlich ist, geben Sie 50Ω ±10% unter Bezugnahme auf das spezifische Schraffurmuster (Raster und Breite des Gitters) an.
- Thermische Trennungen:
- Entwerfen Sie physische Schlitze oder Aussparungen (Fräsen) in der Leiterplatte, um den Wärmepfad zu unterbrechen, wobei nur schmale Brücken für Leiterbahnen verbleiben.
- Steckverbinderplatzierung:
- Steckverbinder wirken als massive Wärmesenken. Platzieren Sie sie so weit wie möglich von der empfindlichen Zone entfernt, verbunden durch hochohmige Leiterbahnen.
Fertigungsrisiken bei Stapelaufbauten mit geringer Wärmeleitfähigkeit (Grundursachen und Prävention)
Die Herstellung einer Platine, die dem Wärmefluss widerstehen soll, birgt mechanische und elektrische Risiken, denen Standardplatinen nicht ausgesetzt sind.
- Risiko: Verzug und Wölbung
- Grundursache: Das Entfernen von Kupferebenen führt zu einem unausgeglichenen Lagenaufbau. Kupfer sorgt für strukturelle Steifigkeit; ohne es entspannt sich das Dielektrikum und verzieht sich während des Reflow-Lötens.
- Erkennung: 3D-Profilometrie oder einfache Flachbettmessung.
- Prävention: Verwenden Sie "Kupfer-Thieving" (isolierte Punkte) in ungenutzten Bereichen, um die Kupferdichte auszugleichen, ohne einen Wärmepfad zu schaffen. Verwenden Sie Versteifungen für die Montage.
- Risiko: Rissbildung in durchkontaktierten Löchern (PTH) (Kryogenversagen)
- Grundursache: CTE-Fehlanpassung (Wärmeausdehnungskoeffizient). Wenn eine Platine von 300K auf 4K abkühlt, schrumpft das Z-Achsen-Epoxid schneller als der Kupferzylinder, was zu Zylinderermüdung oder Eckrissen führt.
- Erkennung: Interconnect Stress Testing (IST) oder Flüssigstickstoff-Tauchtest, gefolgt von Mikroschliff.
- Prävention: Verwenden Sie hochzuverlässige Harzsysteme (niedriger CTE in Z-Achse) und stellen Sie sicher, dass die Duktilität der Beschichtung die Anforderungen der IPC Klasse 3 erfüllt.
- Risiko: Impedanzdiskontinuität
- Grundursache: Das Verlegen von Hochgeschwindigkeitssignalen über schraffierte Masseflächen oder thermische Aussparungen verändert die Referenzkapazität und verursacht Reflexionen.
- Erkennung: TDR-Tests (Zeitbereichsreflektometrie) an Coupons.
- Prävention: Rigorose Simulation des Schraffurmusters; Verwendung von Differentialpaaren, die weniger empfindlich auf Referenzebenenlücken reagieren als Single-Ended-Leiterbahnen.
- Risiko: Ausgasung im Vakuum
- Grundursache: Flüchtige Verbindungen im Laminat, Lötstopplack oder Klebstoffen setzen im Vakuum Gase frei, die Sensoren oder Optiken kontaminieren.
- Erkennung: ASTM E595-Prüfung (Gesamtmasseverlust / CVCM).
- Prävention: Backen Sie die Leiterplatten (z.B. 120°C für 4 Stunden) vor der Verpackung. Spezifizieren Sie vakuumkompatible Materialien (z.B. Polyimid ohne Klebstoff).
- Risiko: Ablösen von Leiterbahnen
- Grundursache: Sehr dünne Leiterbahnen (3-4 mil) auf Materialien wie Teflon oder Polyimid haben eine geringere Schälfestigkeit, insbesondere beim Handlöten oder Nacharbeiten.
- Erkennung: Klebebandtest oder Schälfestigkeitstest an Prüfmustern.
- Prävention: Verwenden Sie "Tränenformen" an Pad-Verbindungen. Verankern Sie Pads, wo möglich, mit Vias.
- Risiko: Säurefallen in gerasterten Flächen
- Grundursache: Wenn der Rasterwinkel spitz ist, kann sich Ätzchemie festsetzen und später Korrosion verursachen.
- Erkennung: Sichtprüfung / AOI.
- Prävention: Gestalten Sie gerasterte Flächen mit 45-Grad-Winkeln und stellen Sie sicher, dass der Abstand groß genug für den Flüssigkeitsaustausch ist.
- Risiko: Inkonsistenter Wärmewiderstand
- Grundursache: Variationen in der Plattierungsdicke. Wenn die Kupferplattierung von 20µm auf 30µm variiert, ändert sich die Wärmeleitfähigkeit der Durchkontaktierung erheblich.
- Erkennung: Querschnittsanalyse.
- Prävention: Strengere Kontrolle der Stromdichte im Plattierungsbad; Spezifikation der maximalen Kupferwanddicke, nicht nur der minimalen.
- Risiko: Mechanische Zerbrechlichkeit an Aussparungen
- Grundursache: Schmale Brücken, die zur thermischen Isolation belassen werden, sind Schwachstellen, die bei Handhabung oder Vibration brechen.
- Erkennung: Falltests oder Vibrationstests.
- Prävention: Alle inneren Ecken von Aussparungen abrunden (keine scharfen 90°-Ecken), um Spannungskonzentratoren zu reduzieren.
Validierung und Abnahme des Stapelaufbaus mit geringer Wärmeleitfähigkeit (Tests und Bestehenskriterien)

Sie können sich nicht allein auf den Standard-E-Test (Durchgangsprüfung) verlassen. Die Validierung muss beweisen, dass die Platine sowohl die elektrischen als auch die thermischen/mechanischen Anforderungen erfüllt.
- Ziel: Überprüfung der thermischen Isolationsleistung
- Methode: Eine bekannte Wärmelast (Heizwiderstand) auf eine Seite der Isolationszone anlegen und die Temperaturdifferenz ($\Delta T$) über den Spalt in einer Vakuumkammer messen.
- Abnahmekriterien: Der gemessene Wärmewiderstand ($K/W$) muss innerhalb von ±10% des simulierten Wertes liegen.
- Ziel: Überprüfung der kryogenen Zuverlässigkeit
- Methode: Thermoschockprüfung. 5 bis 10 Zyklen des Eintauchens in flüssigen Stickstoff (77K) und der Rückkehr auf Raumtemperatur.
- Abnahmekriterien: Widerstandsänderung der Daisy-Chain-Vias < 5%. Keine sichtbaren Mikrorisse im Querschnitt.
- Ziel: Überprüfung der Impedanz über das Gitter
- Methode: TDR-Messung an Testcoupons, die mit dem spezifischen Schraffurmuster der Platine entworfen wurden.
- Abnahmekriterien: Impedanz innerhalb von ±10% des Ziels (z.B. 50Ω).
- Ziel: Überprüfung der Sauberkeit (ionische Kontamination)
- Ziel: Sauberkeit überprüfen
- Methode: Ionenchromatographie oder ROSE-Test. Kritisch für rauscharme Auslese-Layouts, bei denen ionische Rückstände Leckströme erzeugen.
- Akzeptanzkriterien: < 1,56 µg/cm² NaCl-Äquivalent (oder strenger für empfindliche Analogschaltungen).
- Ziel: Strukturelle Integrität dünner Dielektrika überprüfen
- Methode: Verzug- und Verdrehungsmessung gemäß IPC-TM-650.
- Akzeptanzkriterien: < 0,75 % für SMT-Bestückung; < 1,0 % für Durchsteckmontage.
- Ziel: Duktilität der Beschichtung überprüfen
- Methode: Zugprüfung der Beschichtungsfolie oder Mikroschliffanalyse nach Belastung.
- Akzeptanzkriterien: Dehnung > 18 % (Klasse 3 Standard), um Temperaturwechsel zu überstehen.
- Ziel: Ausgasung überprüfen (falls zutreffend)
- Methode: Ausheizen, gefolgt von Restgasanalyse (RGA) oder ASTM E595.
- Akzeptanzkriterien: TML < 1,0 %, CVCM < 0,1 %.
- Ziel: Haftung der Leiterbahnen überprüfen
- Methode: Klebebandtest auf Prüfcoupon.
- Akzeptanzkriterien: Kein Ablösen von Leiterbahnen oder Pads.
Checkliste zur Lieferantenqualifizierung für Lagenaufbauten mit geringer Wärmeleitfähigkeit (RFQ, Audit, Rückverfolgbarkeit)
Verwenden Sie diese Checkliste, um Lieferanten zu prüfen. Ein allgemeiner Leiterplattenhersteller versteht möglicherweise nicht die Nuancen von "maximaler Kupferdicke" oder "Impedanz der Schirmfläche".
Gruppe 1: RFQ-Eingaben (Was Sie senden müssen)
- Lagenaufbauzeichnung: Explizite Angabe von Dielektrikumstypen, Dicken und Kupfergewichten (z. B. "Beginnen Sie mit 1/3 oz Folie").
- Schraffurmusterdefinition: DXF- oder Gerber-Detail, das den Raster und die Breite von thermischen Isolationsgittern definiert.
- Materialspezifikation: Spezifische Angabe (z.B. "Polyimid Arlon 85N" oder "Isola 370HR") anstelle des generischen "FR4".
- Thermische Einschränkungen: Hinweis auf der Fertigungszeichnung: "Design mit geringer Wärmeleitfähigkeit – Kein Kupfer-Thieving in Zone A hinzufügen."
- Beschichtungsspezifikation: "ENIG gemäß IPC-4552" oder spezifische Hartgoldanforderungen.
- Bohrtabelle: Eindeutige Identifizierung von Via-Größen und Toleranzen.
- Testanforderungen: Auflistung aller nicht standardmäßigen Tests (Kryo-Tauchbad, TDR auf Gitter).
- Volumen: Prototypenmenge vs. Produktionsprognose.
Gruppe 2: Fähigkeitsnachweis (Was sie zeigen müssen)
- Handhabung dünner Kerne: Fähigkeit, Kerne < 3 mil ohne Dehnung oder Falten zu verarbeiten.
- Fräsen mit kontrollierter Tiefe: Fähigkeit, Schlitze/Ausschnitte mit hoher Präzision (±0,1 mm) zu fräsen.
- Impedanzmodellierung: Software (z.B. Polar Si9000), die in der Lage ist, schraffierte/Gitter-Masseebenen zu modellieren.
- Materialbestand: Haben sie Polyimid- oder niedrig-CTE-Laminate auf Lager, oder müssen sie diese bestellen (was die Lieferzeit beeinflusst)?
- Feinlinienätzung: Fähigkeit für 3 mil Leiterbahn / 3 mil Abstand (oft für hochohmige Leiterbahnen benötigt).
- Vakuumbacken: Öfen für das Ausbacken nach der Fertigung verfügbar.
Gruppe 3: Qualitätssystem & Rückverfolgbarkeit
- Querschnittsdatenbank: Können sie Querschnitte zur Überprüfung der Plattierungsdicke und Wandqualität bereitstellen?
- Materialzertifikate (CoC): Rückverfolgbarkeit des Laminats bis zum Hersteller.
- AOI-Empfindlichkeit: Ist die AOI kalibriert, um Defekte in komplexen Schraffurmuster zu erkennen?
- Kalibrierungsaufzeichnungen: Sind TDR- und KMG-Werkzeuge (Koordinatenmessgerät) kalibriert?
- IPC-Klasse: Zertifizierung zur Fertigung nach IPC Klasse 3 (Hohe Zuverlässigkeit).
- Prozess für nicht konformes Material: Wie gehen sie mit Leiterplatten um, die Impedanztests nicht bestehen?
Gruppe 4: Änderungskontrolle & Lieferung
- Prozessstopp: Vereinbarung, dass keine Änderungen an der Chemie oder den Laminierpresszyklen ohne Ankündigung erfolgen.
- Verpackung: Vakuumversiegelung mit Trockenmittel und Feuchtigkeitsindikatorkarten (HIC).
- Kantenschutz: Schutz für dünne/zerbrechliche Leiterplatten während des Versands.
- Erstmusterprüfung (FAI): Vollständiger Maßbericht wird mit der ersten Lieferung bereitgestellt.
- Lieferzeitpuffer: Vereinbarung über Lieferzeitpuffer für die Beschaffung exotischer Materialien.
- Ausschussquote: Vereinbarung über akzeptablen Ausbeuteverlust bei komplexer mechanischer Routenführung.
Wie man einen Aufbau mit geringer Wärmeleitfähigkeit wählt (Kompromisse und Entscheidungsregeln)
Die Entwicklung eines Aufbaus mit geringer Wärmeleitfähigkeit ist eine Übung im Ausbalancieren von thermischer Isolation gegenüber elektrischer Leistung und mechanischer Stabilität.
- Thermische Isolation vs. Signalintegrität (SI)
- Wenn Sie maximale Wärmeisolierung priorisieren: Verwenden Sie gerasterte Masseflächen oder gar keine Flächen.
- Wenn Sie Signalintegrität priorisieren: Verwenden Sie durchgehende Flächen.
- Entscheidungsregel: Wenn die Signalfrequenz > 1 GHz ist, verwenden Sie gerasterte Flächen mit sorgfältiger Impedanzmodellierung. Bei Gleichstrom/Niederfrequenz entfernen Sie die Flächen vollständig in der Isolationszone.
- Steifigkeit vs. Leitfähigkeit
- Wenn Sie Steifigkeit priorisieren: Verwenden Sie dickeres FR4 oder fügen Sie eine Edelstahlversteifung hinzu.
- Wenn Sie geringe Leitfähigkeit priorisieren: Verwenden Sie dünnes Polyimid (Flex) oder sehr dünnes FR4.
- Entscheidungsregel: Wenn die Platine schwere Komponenten tragen muss, verwenden Sie einen Starrflex-Ansatz, bei dem der "Flex"-Bereich die thermische Trennung bietet.
- Kosten vs. Leistung
- Wenn Sie Kosten priorisieren: Verwenden Sie Standard-FR4 mit Routing-Ausschnitten (Schlitzen), um den Wärmefluss zu reduzieren.
- Wenn Sie Leistung priorisieren: Verwenden Sie Polyimid oder Teflon mit Manganin-Leiterbahnen.
- Entscheidungsregel: Beginnen Sie mit FR4 + Schlitzen. Wechseln Sie nur zu exotischen Materialien, wenn die thermische Modellierung zeigt, dass FR4 das Budget nicht erfüllt.
- Vakuumkompatibilität vs. Standardverarbeitung
- Wenn Sie Vakuumnutzung priorisieren: Vermeiden Sie Lötstopplack (oder verwenden Sie spezielle Typen) und erfordern Sie Ausheizvorgänge.
- Wenn Sie Standardverarbeitung priorisieren: Verwenden Sie Standard-LPI-Lötstopplack.
- Entscheidungsregel: Wenn der Druck < $10^{-6}$ Torr ist, behandeln Sie es als Vakuumanwendung (strenge Materialkontrolle).
- Steckverbinderhaltbarkeit vs. Wärmeleck
- Wenn Sie Haltbarkeit priorisieren: Verwenden Sie Durchsteckverbinder mit robusten Ringpads.
- Wenn Sie geringe Wärmeleckage priorisieren: Verwenden Sie oberflächenmontierte Steckverbinder oder Drahtbonden, um das Kupfervolumen zu minimieren.
- Entscheidungsregel: Verwenden Sie SMT, wo immer möglich; bei hoher mechanischer Belastung verwenden Sie Durchsteckmontage, aber bohren Sie zurück, um Stummel zu entfernen.
Häufig gestellte Fragen (FAQ) zum Aufbau mit geringer Wärmeleitfähigkeit (Kosten, Lieferzeit, DFM-Dateien, Materialien, Tests)
F: Wie beeinflusst ein Aufbau mit geringer Wärmeleitfähigkeit die Leiterplattenkosten? A: Rechnen Sie mit einer Kostensteigerung von 30–50 % gegenüber Standard-Leiterplatten. Dies wird durch spezialisierte Materialien (wie Polyimid), langsamere Verarbeitung für dünne Kerne und die Notwendigkeit komplexer Leiterbahnführung (Fräsen von Schlitzen) verursacht.
F: Was ist die typische Lieferzeit für diese spezialisierten Leiterplatten? A: Die Standardlieferzeit beträgt 15–20 Arbeitstage. Wenn exotische Materialien (wie spezifische Rogers- oder Arlon-Laminate) nicht auf Lager sind, rechnen Sie mit zusätzlichen 2–4 Wochen für die Materialbeschaffung.
F: Kann ich Standard-FR4 für einen Aufbau mit geringer Wärmeleitfähigkeit verwenden? A: Ja, aber Sie müssen sich auf die Geometrie verlassen. Durch die Verwendung von dünnem FR4 (z. B. 0,4 mm) und das Ausfräsen von 80 % der Materialbreite (wodurch schmale Brücken entstehen) können Sie eine signifikante Isolation ohne teure Materialien erreichen.
F: Welche spezifischen DFM-Dateien sind für die thermischen Isolationszonen erforderlich? A: Stellen Sie eine mechanische Lage bereit, die "Ausschnitt- / Fräsregionen" deutlich kennzeichnet. Wenn Sie schraffierte Flächen verwenden, geben Sie außerdem die spezifische Schraffurteilung und -breite in den Gerber-Dateien oder Fertigungsnotizen an, um sicherzustellen, dass der CAM-Ingenieur sie nicht zu massivem Kupfer "korrigiert".
F: Wie testen Sie die Akzeptanzkriterien für die Wärmeleitfähigkeit? A: Wir messen die Wärmeleitfähigkeit normalerweise nicht direkt auf jeder Produktionsplatine. Stattdessen validieren wir die Geometrie (Kupferdicke, Leiterbahnbreite, Dielektrikumdicke) mittels Querschnitt, was garantiert, dass die Wärmeleistung der Designsimulation entspricht.
F: Wird eine Kryostat-Durchführungs-Leiterplatte als Standard-Starrplatine betrachtet? A: Normalerweise nicht. Es handelt sich oft um eine Starrflex-Leiterplatte oder eine spezialisierte Starrplatine mit hermetischen Dichtungsanforderungen. Der "Durchführungs"-Aspekt erfordert oft eine spezifische Toleranzkontrolle für die Steckverbindung.
F: Was ist die beste Oberflächenveredelung für einen Aufbau mit geringer Wärmeleitfähigkeit? A: ENIG ist der Standard. Es bietet eine flache Oberfläche für Fine-Pitch-Komponenten und hat eine geringere Wärmeleitfähigkeit als HASL (das eine dicke, variable Schicht aus Zinn-Blei hinzufügt).
F: Wie wirkt sich ein extrem rauscharmer Auslese-Layout auf den Aufbau aus? A: Es erfordert eine hochohmige Isolation. Möglicherweise müssen Sie den Abstand zwischen den rauschbehafteten digitalen Schichten und den empfindlichen analogen Schichten vergrößern, was potenziell ein dickeres Dielektrikum oder eine spezifische Lagenanzahl erfordert, um die Abschirmung zu erleichtern, ohne thermische Kurzschlüsse zu erzeugen. F: Kann APTPCB bei der thermischen Modellierung helfen? A: Wir geben DFM-Feedback zur Herstellbarkeit Ihrer thermischen Merkmale (z.B. „diese Brücke ist zu schmal, um sicher gefräst zu werden“), aber die thermische Simulation (Wärmestromanalyse) sollte vom Konstruktionsingenieur durchgeführt werden.
Ressourcen für Stapel mit geringer Wärmeleitfähigkeit (verwandte Seiten und Tools)
- Leiterplatten-Lagenaufbau-Design: Verstehen Sie, wie Schichten konfiguriert und Dielektrika ausgewählt werden, um thermische Brücken zu minimieren und gleichzeitig die Signalintegrität zu erhalten.
- Rigid-Flex-Leiterplatten-Fähigkeiten: Entdecken Sie, wie die Kombination von starren und flexiblen Substraten die ultimative thermische Trennung für kryogene Systeme schaffen kann.
- Leiterplatten-Qualitätskontrolle: Überprüfen Sie unsere Testprotokolle, einschließlich Querschnittsanalyse und IPC Klasse 3 Konformität, die für eine hochzuverlässige Isolation unerlässlich sind.
- DFM-Richtlinien: Lernen Sie die Konstruktionsregeln für das Fräsen von Schlitzen und die Handhabung dünner Materialien, um sicherzustellen, dass Ihr Design mit geringer Leitfähigkeit herstellbar ist.
- Flex-Leiterplatten-Fertigung: Details zu Polyimid-Materialien, die der Industriestandard für geringe Wärmeleitfähigkeit und Vakuumkompatibilität sind.
Angebot für Stapel mit geringer Wärmeleitfähigkeit anfordern (DFM-Überprüfung + Preisgestaltung)
Bereit, Ihr Design zu validieren? Klicken Sie hier, um ein Angebot anzufordern und erhalten Sie eine umfassende DFM-Überprüfung, die Ihren Lagenaufbau sowohl auf Herstellbarkeit als auch auf die Integrität der Wärmeisolierung prüft.
Um das genaueste Angebot und DFM zu erhalten, fügen Sie bitte Folgendes bei:
- Gerber-Dateien (RS-274X): Mit klaren Umrissen für thermische Aussparungen.
- Lagenaufbauzeichnung: Angabe von Kupfergewicht (z.B. 1/3 oz) und Materialtyp.
- Fertigungshinweise: Erwähnen Sie "Low Thermal Conductivity Requirement", damit unsere CAM-Ingenieure Ihre schraffierten Ebenen erhalten.
- Testanforderungen: Geben Sie an, ob TDR- oder spezifische Querschnittsberichte benötigt werden.
Fazit: Nächste Schritte für den Lagenaufbau mit geringer Wärmeleitfähigkeit
Das Design eines Lagenaufbaus mit geringer Wärmeleitfähigkeit ist eine Frage der präzisen Subtraktion – das Entfernen jedes Mikrogramms unnötigen Kupfers und Dielektrikums, um den Wärmefluss zu unterbinden, ohne die Funktion der Schaltung zu beeinträchtigen. Ob Sie eine Kryostat-Durchführungs-Leiterplatte oder ein Layout mit extrem geringem Rauschen bauen, der Erfolg des Projekts hängt von strenger Materialkontrolle, präzisem Fräsen und rigoroser Validierung ab. Indem Sie Ihre Spezifikationen frühzeitig festlegen und mit einem fähigen Hersteller wie APTPCB zusammenarbeiten, können Sie sicherstellen, dass Ihre thermischen Barrieren auch in den anspruchsvollsten Umgebungen standhalten.