Für die langfristige Zuverlässigkeit von Ball-Grid-Array-(BGA-)Baugruppen sind konsequente zerstörungsfreie Prüfungen erforderlich, insbesondere mit Blick auf Röntgenkriterien für BGA-Hohlräume und Head-in-Pillow (HiP). Anders als sichtbare Lötstellen liegen BGA-Verbindungen unter dem Gehäuse und entziehen sich damit der normalen optischen Inspektion. Für Ingenieure und Qualitätsverantwortliche bei APTPCB ist es entscheidend, die von IPC-Normen vorgegebenen Gut-/Schlecht-Grenzen präzise zu verstehen, um Feldausfälle durch thermische Wechselfestigkeit oder intermittierende Kontaktunterbrechungen zu vermeiden. Dieser Leitfaden beschreibt die relevanten Röntgenbilder, Messgrenzen und Prozesskontrollen zur Absicherung der BGA-Integrität.
Kurze Antwort (30 Sekunden)
Für eine zuverlässige BGA-Montage orientieren sich die Röntgenkriterien für BGA-Hohlräume und Head-in-Pillow im Regelfall an IPC-7095 und IPC-A-610.
- Grenzwert für Hohlräume: Bei IPC-Klasse 2 und Klasse 3 sollte die gesamte Hohlraumfläche innerhalb einer einzelnen Lötkugel 25 % der gesamten Kugelfläche nicht überschreiten.
- Head-in-Pillow (HiP): Dieser Befund gilt als Prozessindikator und ist in der Regel nicht zulässig. Er zeigt sich als klar erkennbare Trennung oder fehlende Verschmelzung zwischen Lötkugel und Lotpaste, oft wie eine Kugel auf einem Kissen.
- Nachweis: Hohlräume sind in der 2D-Transmissionsaufnahme sichtbar. Für HiP sind häufig schräg aufgenommene 2D-Röntgenbilder (2,5D) oder 3D-Laminografie (CT) nötig, weil die vertikale Überlagerung den Defekt in der Draufsicht verdecken kann.
- Kritische Lage: Hohlräume an der Grenzfläche zwischen Lötkugel und Bauteilpad sind kritischer und führen wegen des Risikos der Rissausbreitung oft unabhängig von ihrer Größe zur Zurückweisung.
- Validierung: Automatisierte Röntgeninspektionssysteme (AXI) müssen so kalibriert sein, dass sie harmlose Makrohohlräume von kritischen planaren Mikroporen unterscheiden.
Wann Röntgenkriterien für BGA-Hohlräume und Head-in-Pillow gelten (und wann nicht)
Wenn der Prüfumfang richtig abgegrenzt ist, werden Ressourcen auf echte Zuverlässigkeitsrisiken statt auf rein optische Auffälligkeiten konzentriert.
Wann diese Kriterien gelten:
- BGA- und CSP-Montage: Jedes Bauteil mit unter dem Gehäuse verborgenen Lötstellen erfordert eine Röntgenfreigabe nach diesen Kriterien.
- Produkte mit hoher Zuverlässigkeitsanforderung: In Automobil-, Luftfahrt- und Medizinanwendungen (IPC-Klasse 3) können thermische Zyklen Hohlräume zu Rissen wachsen lassen.
- Prozessvalidierung: Während der Erstmusterprüfung (FAI) zur Feinabstimmung des Reflow-Profils.
- Fehlersuche bei intermittierenden Ausfällen: Wenn eine Baugruppe den elektrischen Test besteht, unter Vibration oder Temperaturstress aber versagt.
- Einführung neuer Gehäuse: Bei QFN- oder LGA-Gehäusen mit großen Wärmeflächen weichen die Grenzwerte leicht ab, die zugrunde liegende Physik bleibt jedoch ähnlich.
Wann diese Kriterien nicht gelten oder anders bewertet werden:
- Konventionelle Through-Hole-Bauteile: Röntgen kann zwar die Barrel-Füllung prüfen, die Hohlraumkriterien für BGAs lassen sich aber nicht direkt auf wellengelötete Verbindungen übertragen.
- Sichtbare Gull-Wing-Anschlüsse: Hier ist die automatisierte optische Inspektion (AOI) normalerweise sinnvoller; Röntgen ist nur bei speziellen Fragestellungen wie Fersenkehlen erforderlich.
- Thermische Massepads bei QFN/LGA: Für große Wärmeflächen gelten oft großzügigere Hohlraumgrenzen, teils bis 50 % nach kundenspezifischer Vereinbarung, als für BGA-Signalanschlüsse.
- Underfill-Anwendungen: Nach dem Underfill ändert sich der Röntgenkontrast, und die Hohlraumanalyse wird deutlich schwieriger; geprüft werden muss daher vor dem Verguss.
- Kosmetische Oberflächenfehler: Röntgen durchleuchtet das Bauteil, deshalb sind Kratzer auf der Gehäuseoberfläche für diese Kriterien irrelevant.
Regeln & Spezifikationen
Die folgende Tabelle zeigt die technischen Parameter zur Bewertung der BGA-Integrität. Sie übersetzt die allgemeinen Röntgenkriterien für BGA-Hohlräume und Head-in-Pillow in messbare Prüfpunkte.
| Regel / Parameter | Empfohlener Wert/Bereich | Warum das wichtig ist | So wird geprüft | Wenn ignoriert |
|---|---|---|---|---|
| Gesamter Hohlraumanteil | < 25 % der Röntgenbildfläche (IPC Klasse 2/3) | Große Hohlräume verschlechtern Wärme- und Stromleitung und schwächen die mechanische Festigkeit. | Flächenberechnung per AXI-Software. | Bruch der Lötverbindung bei Temperaturwechseln. |
| Größter Einzelhohlraum | < 20 % der Kugelfläche | Eine einzelne große Blase erzeugt einen ausgeprägten Spannungsschwerpunkt. | Durchmesser der größten Region mit geringer Dichte messen. | Sofortiger mechanischer Ausfall unter Schockbelastung. |
| Head-in-Pillow-(HiP-)Signatur | 0 % (Zurückweisung) | Zeigt fehlende metallurgische Bindung an; gehalten wird die Verbindung nur durch Flussmittelrückstände oder mechanischen Druck. | Schrägaufnahme bei 45-70° oder 3D-CT-Schnittanalyse. | Intermittierende Unterbrechungen im Feldeinsatz. |
| Lötkugeldurchmesser | ±15 % des Nennwerts aus dem Datenblatt | Abweichungen deuten auf Verzug oder übermäßiges Zusammendrücken hin. | Vergleichsmessung mit Referenzkugeln. | Offene Lötstellen oder Kurzschlüsse. |
| Lötbrücke / Kurzschluss | 0 (nicht zulässig) | Führt unmittelbar zum elektrischen Ausfall. | Dichte Verbindung zwischen benachbarten Pads im Röntgenbild. | Sofortiger Funktionsausfall durch Kurzschluss. |
| Verformung der Eckkugeln | < 25 % Längung | Die Ecken tragen die höchste thermische Belastung; Längung deutet auf übermäßigen Verzug hin. | Geometrischer Vergleich von Eck- und Innenkugeln. | Pad-Cratering oder Lotermüdung. |
| Grenzflächenhohlräume | 0 % (strenge Kontrolle) | Hohlräume an der Pad-Grenze sind Vorläufer von Black-Pad-Ausfällen. | Hochauflösende Röntgenprüfung mit Fokus auf die Pad-Ebene. | Spröder, katastrophaler Bruch. |
| Ausgehungerte Lötstelle | Volumen > 75 % des Nennwerts | Zu geringe Pastenfreigabe führt zu schwachen Verbindungen. | Grauwertintegration zur volumetrischen Abschätzung. | Schwache Lötstellen mit Vibrationsrisiko. |
| Popcorn / Blowout | 0 Vorkommen | Zeigt an, dass eingeschlossene Feuchtigkeit im Gehäuse während des Reflows explosionsartig austritt. | Unregelmäßige, aufgeplatzte Form der Lötkugel. | Bauteilschaden und Delamination. |
| Ausrichtung / Versatz | < 25 % der Padbreite | Fehlversatz reduziert die Kontaktfläche und erhöht das Brückenrisiko. | Mittelpunktabstand von Kugel und Pad messen. | Sinkende Zuverlässigkeit und mögliche Kurzschlüsse. |
| Benetzungswinkel | Sichtbare Kehle, falls erkennbar | Gute Benetzung zeigt ausreichende Flussmittelaktivität und eine geeignete Pad-Oberfläche. | 3D-Rekonstruktion oder Schliffbild. | Fehlbenetzung oder Entnetzung. |
| Sphärizität der Lötkugel | > 0,85 (Aspektverhältnis) | Nicht kugelförmige Bälle weisen, sofern nicht konstruktiv vorgesehen, auf unvollständiges Reflow oder Verunreinigungen hin. | Formanalyse-Software. | Schlechte Selbstzentrierung beim Reflow. |
Implementierungsschritte
Ein belastbarer Prüfprozess für Röntgenkriterien für BGA-Hohlräume und Head-in-Pillow erfordert ein systematisches Vorgehen. Nur so werden die gewonnenen Daten belastbar und direkt nutzbar.
Annahmeklasse festlegen: Legen Sie fest, ob das Produkt IPC-Klasse 2 (Standardzuverlässigkeit) oder Klasse 3 (hohe Leistung) erfüllen muss. Davon hängt ab, wie streng der zulässige Hohlraumanteil bewertet wird.
- Aktion: Schwellenwerte in der AXI-Software aktualisieren.
- Prüfung: Verifizieren, dass Kundenvorgaben mit den IPC-Definitionen übereinstimmen.
Röntgenanlage kalibrieren: Vor dem Scan müssen Röhrenspannung und Zielstrom auf Leiterplattendicke und Lagenzahl abgestimmt sein.
- Aktion: Ein Referenzmuster oder eine Kalibrierplatte scannen.
- Prüfung: Bildkontrast und Auflösung kontrollieren, etwa ob 2-mil-Drähte sichtbar sind.
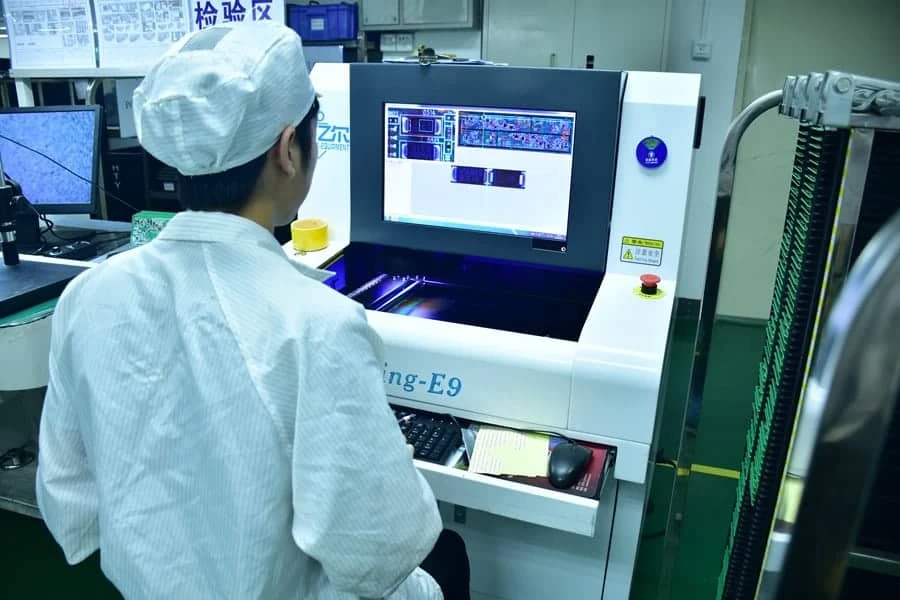
- Referenzbild aufbauen:
Scannen Sie eine nachweislich gute Baugruppe, um Referenz-Graustufen für die Lötstellen festzulegen. So kann die Software Lot, Kupfer und Hohlräume sauber trennen.
- Aktion: Dem AXI-System die Bauteilpositionen aus der Pick-and-Place-Datei beibringen.
- Prüfung: Sicherstellen, dass alle BGA-Anschlüsse korrekt erkannt werden.

2D-Draufsicht ausführen: Führen Sie einen schnellen Überblicksscan durch, um grobe Defekte wie Brücken, fehlende Kugeln oder massive Hohlräume zu finden.
- Aktion: Hohlraumanteile automatisch berechnen lassen.
- Prüfung: Jede Kugel mit mehr als 25 % Hohlraumfläche markieren.
Schrägaufnahme oder 3D-Scan durchführen (entscheidend für HiP): In der Draufsicht bleibt Head-in-Pillow oft verborgen. Deshalb muss der Detektor geneigt oder das Prüfobjekt gedreht werden.
- Aktion: Eckkugeln und große BGA-Gehäuse bei 45-60 Grad prüfen.
- Prüfung: Auf Schneemann-Konturen oder Trennlinien in der Lötkugel achten.
Lage der Hohlräume bewerten: Wenn Hohlräume sichtbar sind, muss unterschieden werden, ob sie zentral liegen oder an der Pad-Grenze auftreten.
- Aktion: Bei 3D-Röntgen die Fokustiefe anpassen.
- Prüfung: Baugruppen mit planaren Mikroporen an der Pad-Oberfläche zurückweisen.
Mit dem Reflow-Profil abgleichen: Treten Defekte auf, müssen sie ihrer Position auf der Baugruppe zugeordnet werden.
- Aktion: Prüfen, ob sich Fehler in kalten oder heißen Ofenzonen häufen.
- Prüfung: Die Zeit über Liquidus (TAL) anpassen, wenn Hohlräume systematisch auftreten.
Datenaufzeichnung und Rückverfolgbarkeit sicherstellen: Röntgenbilder und Gut-/Schlecht-Entscheidungen müssen mit der PCB-Seriennummer verknüpft gespeichert werden.
- Aktion: Den Prüfbericht in das Qualitätsmanagementsystem exportieren.
- Prüfung: Verifizieren, dass die Bilder für spätere Audits wieder auffindbar sind.
Fehlermuster & Fehlersuche
Wenn die Röntgenkriterien für BGA-Hohlräume und Head-in-Pillow nicht erfüllt werden, liegt die Ursache meist in einem vorgelagerten Prozessschritt. Die folgende Übersicht hilft, Symptome bis zur Wurzel zurückzuverfolgen.
1. Symptom: Hoher Hohlraumanteil (>25 %)
- Ursachen: Flüchtige Bestandteile in der Paste, zu kurzes Reflow-Profil, oxidierte Pads.
- Prüfungen: Haltbarkeit der Lotpaste prüfen; Einweichzeit im Reflow-Profil verifizieren.
- Abhilfe: Die Soak-Zone verlängern, damit flüchtige Bestandteile vor dem Aufschmelzen entweichen können.
- Vorbeugung: Für hochzuverlässige Produkte Vakuum-Reflow einsetzen.
2. Symptom: Head-in-Pillow (HiP)
- Ursachen: Bauteilverzug, zu geringe Pastenmenge, Kissenbildung während des Reflows.
- Prüfungen: Koplanarität des Bauteils messen; Verstopfungen in der Schablonenöffnung kontrollieren.
- Abhilfe: Eine Step-up-Schablone für höheren Pastenauftrag verwenden; die Abkühlrate des Reflow-Profils an den CTE des Gehäuses anpassen.
- Vorbeugung: Eine strenge Wareneingangsprüfung für PCBA etablieren, um verzogene Bauteile und Leiterplatten früh auszusortieren.
3. Symptom: Lötbrücken
- Ursachen: Zu viel Lotpaste, zu hoher Bestückdruck, Pastenverschmierung.
- Prüfungen: Schablonendicke und Aperturreduktion kontrollieren, meist sind 10-15 % Reduktion nötig.
- Abhilfe: Unterseite der Schablone reinigen; Bestückkraft reduzieren.
- Vorbeugung: Schablonendesign mit passenden Aspektverhältnissen optimieren.
4. Symptom: Fehlbenetzung (offene Lötstelle)
- Ursachen: Pad-Oxidation, überaltertes Flussmittel, unzureichende Wärme.
- Prüfungen: Lagerbedingungen der PCBs mit Blick auf MSL prüfen; Spitzentemperatur des Reflows verifizieren.
- Abhilfe: PCBs zum Austreiben von Feuchtigkeit trocknen; Spitzentemperatur erhöhen, ohne Bauteile zu schädigen.
- Vorbeugung: ENIG- oder OSP-Oberflächen fachgerecht und innerhalb der Lagerzeit einsetzen.
5. Symptom: Lotkugeln / Satelliten
- Ursachen: Feuchtigkeit in der Paste, zu steile Aufheizrampe.
- Prüfungen: Luftfeuchte im Druckraum prüfen; Rampenrate unter 3 °C/s verifizieren.
- Abhilfe: Aufheizrampe anpassen; sicherstellen, dass die Paste vor dem Druck Raumtemperatur erreicht.
- Vorbeugung: Strenge Umgebungsbedingungen im SMT-Bereich einhalten.
6. Symptom: Popcorn-Effekt
- Ursachen: Feuchtigkeitsaufnahme im BGA-Gehäuse.
- Prüfungen: Nachverfolgung der Moisture Sensitivity Level (MSL) kontrollieren.
- Abhilfe: Bauteile gemäß J-STD-033 vor der Montage trocknen.
- Vorbeugung: Empfindliche Komponenten in Trockenschränken oder Stickstoffatmosphäre lagern.
Konstruktive Entscheidungen
Ob sich die Röntgenkriterien für BGA-Hohlräume und Head-in-Pillow einhalten lassen, wird stark vom Leiterplattendesign beeinflusst. Diese Punkte sollten bereits in der Layoutphase berücksichtigt werden, um Montage und Prüfung zu erleichtern.
Pad-Definition (SMD vs. NSMD):
- NSMD (Non-Solder Mask Defined): Für BGAs meist die bessere Wahl. Das Kupferpad ist kleiner als die Lötstoppmaskenöffnung, sodass die Lötkugel um das Kupfer greifen kann. Das verbessert mechanischen Halt und Selbstzentrierung.
- SMD (Solder Mask Defined): Die Maske überlappt das Kupfer. Dadurch können Spannungsspitzen entstehen, an denen Risse starten, auch wenn diese Variante bei sehr feinem Pitch manchmal gegen Brückenbildung eingesetzt wird.
Via-in-Pad-Technologie:
- Offene Vias in BGA-Pads sind eine häufige Ursache für Hohlräume. Das Lot fließt in die Via ab, was zu ausgehungerten Lötstellen oder eingeschlossener Luft führt.
- Lösung: Für BGA-Pads verschlossene und verfüllte Vias (VIPPO) einsetzen. Das schafft eine plane Oberfläche und reduziert Lotverlust sowie Hohlraumbildung deutlich.
Bauteilplatzierung und Ausrichtung:
- Schwere Bauteile wie Transformatoren oder Abschirmhauben nicht direkt neben BGAs platzieren. Unterschiedliche Wärmemassen führen sonst zu ungleichmäßiger Erwärmung, Verzug und HiP-Fehlern.
- Rund um das BGA ausreichend Freiraum für schräge Röntgenaufnahmen vorsehen. Hohe Nachbarbauteile können die 2,5D-Prüfung unmöglich machen.
Schablonendesign:
- Bei Fine-Pitch-BGAs lösen quadratische Aperturen mit gerundeten Ecken die Paste meist besser als runde Öffnungen.
- Elektropolierte Schablonen verbessern den Pastentransfer und verringern so das Risiko von Unterfüllung, die zu HiP beiträgt.
Detaillierte Hinweise für ein fertigungsgerechtes Layout finden Sie in unseren DFM-Richtlinien.
FAQ
1. Worin unterscheiden sich IPC-Klasse 2 und Klasse 3 bei BGA-Hohlräumen? Im Grundsatz begrenzen sowohl Klasse 2 als auch Klasse 3 den Hohlraumanteil auf 25 % der Kugelfläche. Klasse 3 mit hoher Zuverlässigkeitsanforderung kann jedoch strengere kundenspezifische Vorgaben zur Lage der Hohlräume enthalten, etwa ein Verbot von Grenzflächenhohlräumen, und verlangt eine strengere Prozessdokumentation.
2. Kann 2D-Röntgen Head-in-Pillow erkennen? Nur selten. In der 2D-Draufsicht überlagern sich Lötkugel und Pastendepot, sodass sie verbunden wirken, obwohl vertikal eine Trennschicht vorhanden sein kann. Für die sichere Erkennung sind Schrägaufnahmen oder 3D-Laminografie erforderlich.
3. Ist Nacharbeit zulässig, wenn ein BGA die Röntgenprüfung nicht besteht? Ja. BGA-Nacharbeit ist ein übliches Verfahren, bei dem das Bauteil entfernt, die Stelle gereinigt und ein neues Teil eingelötet wird. Wiederholte Nacharbeit kann jedoch die Pads schädigen. APTPCB begrenzt daher die Zahl der Nacharbeitszyklen, um die Integrität der Leiterplatte zu schützen.
4. Warum liegen Hohlräume meist im Zentrum der Kugel? Hauptursache ist das Ausgasen des Flussmittels. Wenn das Lot von außen nach innen schmilzt, werden flüchtige Bestandteile in Richtung Zentrum verdrängt, also an den Bereich, der zuletzt erstarrt. Zentrale Hohlräume sind im Allgemeinen weniger kritisch als Hohlräume an der Pad-Grenze.
5. Welchen Einfluss hat die Oberfläche auf Head-in-Pillow? Oxidierte Oberflächen, etwa gealtertes OSP, verhindern das Benetzen des Pads durch die Lotpaste. Dadurch bleibt die Paste von der Kugel getrennt. ENIG-Oberflächen bieten meist bessere Benetzung und senken das HiP-Risiko, sofern kein Black-Pad-Fehler vorliegt.
6. Was bedeutet der Schneemann-Effekt im Röntgenbild? Das ist ein typisches optisches Merkmal von Head-in-Pillow oder unvollständigem Reflow in einer Schrägaufnahme. Die Lötkugel sitzt auf der aufgeschmolzenen Paste, ohne mit ihr zu verschmelzen, und erinnert dadurch an einen Schneemann.
7. Reduziert Stickstoff-Reflow den Hohlraumanteil? Ja. Stickstoff begrenzt die Oxidation der Lotoberflächen während des Reflows und verbessert dadurch die Benetzung. Bessere Benetzung erleichtert das Entweichen von Gasblasen aus dem flüssigen Lot und senkt den gesamten Hohlraumanteil.
8. Kann AOI die Röntgenprüfung bei BGAs ersetzen? Nein. AOI arbeitet auf Sichtlinie. Damit lassen sich manchmal äußere Filets oder die Bauteilposition prüfen, nicht aber die Lötstellen unter dem BGA-Gehäuse. Für BGAs ist Röntgen unverzichtbar.
9. Welche Kostenfolgen hat eine 100-%-Röntgenprüfung? Eine 100-%-Röntgenprüfung ist langsam und erhöht die Kosten. In der Serienproduktion wird daher oft nach Stichprobenplan, etwa per AQL, geprüft oder nur komplexe BGAs werden vollständig geröntgt, während der Rest über die Prozessvalidierung abgesichert wird.
10. Wie vermeide ich HiP durch Verzug? Verwenden Sie PCB-Materialien mit hoher Tg, gleichen Sie die Kupferverteilung im Lagenaufbau aus, um Verbiegen zu vermeiden, und optimieren Sie die Abkühlrate im Reflow-Profil. Eine niedrigere Löttemperaturlegierung wie SnBi kann den thermischen Stress ebenfalls senken, verändert aber die mechanischen Eigenschaften.
11. Was ist ein Champagne-Hohlraum? Dabei handelt es sich um eine spezielle Form von Grenzflächenhohlräumen, bei der sich viele kleine Poren an der intermetallischen Schicht sammeln. Dieser Befund ist besonders kritisch, weil eine schwache Bruchfläche entsteht, oft infolge von Beschichtungsproblemen.
12. Wie geht APTPCB mit der BGA-Prüfung um? Für NPI-Projekte und komplexe Baugruppen nutzen wir fortschrittliche 3D-Röntgentechnik. Ergänzend setzen wir SPI ein, um Defekte bereits vor der Bauteilplatzierung zu verhindern.
Verwandte Seiten & Tools
- PCB-Fertigungsservice: Überblick über unsere Möglichkeiten für hochlagige und HDI-Leiterplatten, die sich für BGA-Baugruppen eignen.
- Röntgenprüfung: Erfahren Sie, wie wir verdeckte Lötstellen wie Hohlräume und HiP in der PCBA prüfen.
- Kontakt: Technische Unterstützung für Ihre spezifischen Anforderungen an die BGA-Zuverlässigkeit.
- DFM-Richtlinien: Laden Sie unsere Designregeln herunter, um Layouts für Fertigung und Prüfung zu optimieren.
Glossar (Schlüsselbegriffe)
| Begriff | Definition |
|---|---|
| BGA (Ball Grid Array) | Ein SMD-Gehäuse für integrierte Schaltungen, bei dem die Anschlüsse als Raster aus Lötkugeln ausgeführt sind. |
| Head-in-Pillow (HiP) | Ein Fehlerbild, bei dem die BGA-Kugel auf der Lotpaste aufliegt, aber nicht zu einer gemeinsamen Lötstelle verschmilzt. |
| Hohlraum | Eine im Inneren der Lötstelle eingeschlossene Luft- oder Gasblase. |
| Laminografie | Ein 3D-Röntgenverfahren, das Schichtbilder der Leiterplatte erzeugt und so die Inspektion einzelner Ebenen ermöglicht. |
| Intermetallische Phase (IMC) | Chemische Schicht zwischen Lot und Kupferpad, die für die Bindung notwendig ist, bei zu großer Dicke jedoch spröde wird. |
| Koplanarität | Maximaler Höhenunterschied zwischen der höchsten und der niedrigsten Lötkugel eines Bauteils; schlechte Koplanarität führt zu offenen Verbindungen. |
| Benetzung | Fähigkeit des geschmolzenen Lots, sich auf einer Metalloberfläche auszubreiten und dort zu haften. |
| Reflow-Profil | Temperatur-Zeit-Verlauf, den eine Leiterplatte im Ofen durchläuft; entscheidend für Flussmittelaktivierung und Lotaufschmelzung. |
| Stand-off-Höhe | Abstand zwischen Bauteilunterseite und Leiterplattenoberfläche nach dem Löten. |
| IPC-7095 | Industrienorm, die speziell Design und Fertigungsumsetzung für BGA-Baugruppen beschreibt. |
Fazit
Wer die Röntgenkriterien für BGA-Hohlräume und Head-in-Pillow beherrscht, erfüllt nicht nur eine Norm, sondern sichert Lebensdauer und Betriebssicherheit des Endprodukts. Durch konsequente Anwendung der IPC-Grenzen, den Einsatz von 3D-Prüftechnik und ein klares Verständnis der Fehlerursachen lassen sich feldrelevante BGA-Ausfälle weitgehend vermeiden.
Bei APTPCB sind diese Prüfabläufe fester Bestandteil des Standardprozesses. Von einer strengen Wareneingangsprüfung bis zur fortgeschrittenen Röntgenanalyse sorgen wir dafür, dass jede Baugruppe die geforderte Zuverlässigkeit erreicht. Wenn Sie mit komplexen BGA-Layouts oder Zuverlässigkeitsproblemen arbeiten, unterstützt Sie unser Engineering-Team mit einer fundierten technischen Bewertung.
