Placing active or passive components directly onto flexible circuit materials requires strict adherence to mechanical and thermal constraints that do not exist in rigid PCB design. Unlike standard FR4 boards, component placement on flex zones introduces risks related to dynamic stress, coefficient of thermal expansion (CTE) mismatches, and pad lifting during reflow. Engineers must utilize stiffeners, optimize pad geometries, and control adhesive flow to ensure solder joint reliability. This guide provides the technical specifications, checklists, and troubleshooting protocols necessary to execute robust assembly on flexible substrates.
Quick Answer (30 seconds)
Successful component placement on flex zones relies on isolating the solder joints from mechanical stress. If the flex circuit bends near a component, the solder fillet will crack.
- Mandatory Stiffeners: Never place components on a flex region without a rigid stiffener (FR4, Polyimide, or Steel) directly underneath.
- Bend Proximity: Maintain a minimum clearance of 1.5mm to 2.5mm between the edge of the stiffener and the start of the bend radius.
- Pad Geometry: Use "tie-downs" or "spurs" (anchoring pads) to increase copper peel strength on the flexible substrate.
- Plating Selection: Electroless Nickel Immersion Gold (ENIG) is preferred over HASL to prevent stress fractures in the plating layer during handling.
- Adhesive Management: Account for adhesive squeeze-out (typically 0.1mm - 0.3mm) from the coverlay or stiffener to ensure pads remain solderable.
- Carrier Requirement: Flexible panels must be supported by magnetic fixtures or taped to rigid pallets during SMT assembly to maintain planarity.
When component placement on flex zones applies (and when it doesn’t)
Understanding the physical limitations of flexible materials is the first step in determining if your design is viable. While placing parts on flex allows for 3D packaging and weight reduction, it is not suitable for every application.
When to apply component placement on flex zones:
- Static Flex (Flex-to-Install): The circuit bends only once during installation. Components are placed on a flat area reinforced by a stiffener.
- Rigid-Flex Construction: Components are placed on the flexible layers that are laminated internally to rigid sections, provided there is Z-axis support.
- High-Density Sensors: Applications requiring sensors to conform to a curved surface (e.g., wearable health monitors), where the component area is locally stiffened but the surrounding area remains flexible.
- Weight-Critical Aerospace: Replacing heavy rigid boards and connectors with a single populated flex circuit to reduce mass.
- Z-Axis Height Constraints: When a standard rigid PCB is too thick, a thin flex circuit with a thin polyimide stiffener can reduce stack-up height by 50% or more.
When NOT to apply it:
- Dynamic Flex Regions: Never place components on a section of the flex that will undergo continuous bending or rolling (e.g., printer heads, hinge cables). The metal fatigue will inevitably crack solder joints.
- Unsupported Flex: Placing components without a stiffener is a critical failure mode. The flexibility of the base material (PI) cannot support the rigidity of the component body or the solder joint.
- High-Power Applications: Thin flex copper (typically 0.5oz or 1oz) and thin dielectrics have poor thermal conductivity compared to rigid boards, making heat dissipation difficult for power FETs or regulators.
- Heavy Components: Large inductors or connectors placed on flex zones can cause the substrate to tear due to gravity or vibration if not mechanically anchored to a chassis.
Rules & specifications
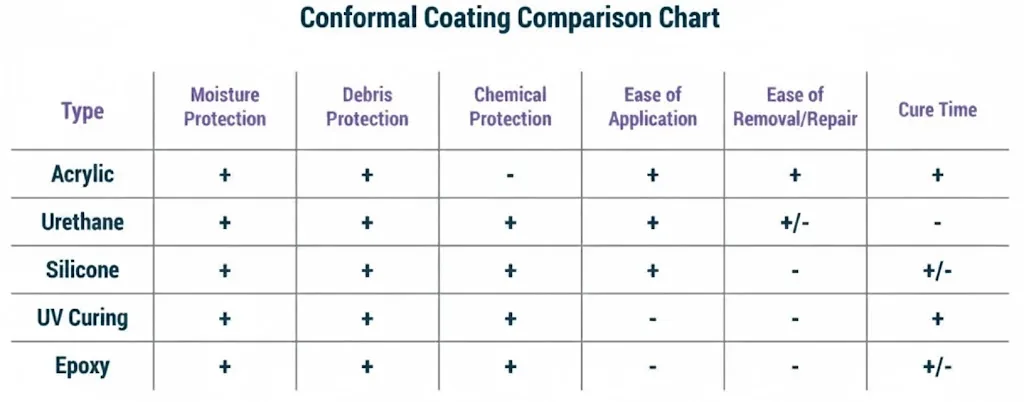
Once the application is validated, the design must adhere to specific geometric and material rules to ensure manufacturability. The following table outlines the critical parameters for component placement on flex zones, derived from IPC-2223 and practical DFM experiences at APTPCB (APTPCB PCB Factory).
| Rule | Recommended Value / Range | Why it matters | How to verify | If ignored |
|---|---|---|---|---|
| Stiffener Overlap | Stiffener must extend 0.5mm - 1.0mm beyond component pads on all sides. | Prevents stress concentration at the solder joint edge; transfers load to the stiffener. | Check mechanical layer vs. component courtyard in CAD. | Solder joints crack immediately upon handling or installation. |
| Distance to Bend | ≥ 1.5mm (2.5mm preferred) from stiffener edge to bend line. | Isolates the rigid component area from the mechanical strain of the bending zone. | Measure distance from stiffener outline to defined bend radius. | Stiffener edge acts as a fulcrum, causing trace fracture or coverlay peeling. |
| Pad Anchoring | Use anchoring spurs or oversized pads (+10-20% vs rigid). | Polyimide has lower copper peel strength than FR4; anchors prevent pads from lifting during rework. | Visual inspection of footprint design; check for "ears" on pads. | Pads lift off the substrate during hand soldering or repair. |
| Coverlay Opening | 0.1mm - 0.25mm clearance around pads (SMD). | Coverlay adhesive flows during lamination; insufficient clearance leads to pad contamination. | Review Gerber solder mask/coverlay layer against copper pads. | Solderability failure; "skip" soldering due to adhesive on pad. |
| Component Orientation | Align long axis of component parallel to the bend direction (if near bend). | Reduces the mechanical leverage applied to the component body during incidental flexing. | Check placement rotation relative to the flex outline. | Component body cracks (MLCCs) or solder fillets fracture. |
| Solder Mask Type | Use flexible LPI or Coverlay (Polyimide). | Standard rigid solder mask is brittle and will crack when the flex circuit is handled. | Specify "Flexible LPI" or "Coverlay" in fabrication notes. | Micro-cracks in mask allow moisture ingress and potential shorts. |
| Stiffener Material | FR4 (0.2mm-1.5mm) for components; PI for ZIF thickness. | FR4 provides the necessary rigidity for SMT process planarity. | Verify material stack-up in fabrication drawing. | Warpage during reflow; components tombstone or misalign. |
| Adhesive Type | Thermoset (Acrylic/Epoxy) vs. PSA (Pressure Sensitive). | Thermoset is required for reflow temperatures; PSA will delaminate or bubble. | Specify adhesive type in stack-up; PSA is only for post-reflow attachment. | Stiffener falls off or bubbles during SMT reflow oven passage. |
| Via Placement | No vias under components on flex (unless filled/capped). | Flex vias are prone to barrel cracking; placing them under pads concentrates stress. | DRC check for vias within component courtyards. | Intermittent connections; solder wicking into vias causing shorts. |
| Surface Finish | ENIG (Electroless Nickel Immersion Gold). | HASL is too stressful (thermal shock) and uneven for fine-pitch flex assembly. | Specify ENIG in surface finish notes. | Uneven pads cause tombstoning; HASL process damages thin flex. |
| Panelization | Use FPC panelization and carriers. | Flex is flimsy; it cannot travel through conveyors without a carrier. | Design panel with breakaway tabs or request carrier fixture design. | Assembly line stoppage; impossible to print solder paste accurately. |
Implementation steps

With the rules established, the execution phase requires a disciplined workflow. Following these steps ensures that component placement on flex zones transitions smoothly from CAD design to physical assembly at APTPCB.
Define the Mechanical Stack-up
- Action: Determine the total thickness required for the stiffened area.
- Key Parameter: If using a ZIF connector on the same flex, the stiffener thickness there is fixed (usually 0.3mm total). For component areas, select an FR4 stiffener thickness (e.g., 0.6mm, 0.8mm, 1.0mm) that provides sufficient rigidity without exceeding height constraints.
- Acceptance Check: Verify the stack-up drawing explicitly labels stiffener material, thickness, and adhesive type (Thermoset).
Optimize Footprint Design for Flex
- Action: Modify standard IPC footprints to accommodate flex characteristics.
- Key Parameter: Increase pad size by 10-20% to enlarge the soldering area. Add "spurs" or "tie-downs" (small copper extensions covered by coverlay) to mechanically anchor the pad to the base polyimide.
- Acceptance Check: Review CAM files to ensure pads are not standard rigid definitions; anchors must be visible in copper layers.
Design Stiffener Geometry
- Action: Create the stiffener outline in a mechanical layer.
- Key Parameter: Ensure the stiffener extends at least 0.5mm beyond the component courtyard. Add tooling holes (fiducials) on the stiffener or the flex panel frame for SMT machine alignment.
- Acceptance Check: Overlay the stiffener layer with the component layer. Ensure no component overhangs the stiffener edge.
Configure FPC Panelization and Carriers
- Action: Design the delivery panel to support the flex during assembly.
- Key Parameter: Use a "frame" design where the flex is held by tabs, or specify a magnetic carrier fixture. The flex must remain flat during solder paste printing.
- Acceptance Check: Verify that the panel design includes global fiducials and that the flex does not sag in the center of the array.
Baking and Moisture Removal
- Action: Pre-bake the bare flex PCBs before assembly.
- Key Parameter: Polyimide absorbs moisture (up to 3% by weight). Bake at 120°C for 2-4 hours (depending on manufacturer specs) immediately before SMT.
- Acceptance Check: Verify humidity indicator cards; ensure assembly starts within 1-2 hours of baking to prevent "popcorning" or delamination.
Solder Paste Printing and Placement
- Action: Apply solder paste using a stencil optimized for flex.
- Key Parameter: Use a slightly thinner stencil (e.g., 100µm) if planarity is a concern, or standard if using a high-quality carrier. Place components with lower placement pressure to avoid deflecting the flex.
- Acceptance Check: Inspect paste deposition for smearing (indicates flex movement) before component placement.
Reflow Profiling
- Action: Run the assembly through the reflow oven.
- Key Parameter: Flex heats up faster than rigid boards but cools down faster too. Ensure the profile accounts for the thermal mass of the carrier/pallet, not just the flex.
- Acceptance Check: X-ray inspection for BGA/QFN; visual inspection for wetting and fillet shape.
Depanelization
- Action: Remove the populated flex from the panel/carrier.
- Key Parameter: Use laser cutting or punch dies. Never break tabs by hand, as the stress will propagate to the nearest component and crack the solder or trace.
- Acceptance Check: Inspect edges for tearing; inspect nearest components for capacitor cracking.
Failure modes & troubleshooting
Even with strict rules, issues can arise during component placement on flex zones. This section details common failure modes, their root causes, and how to resolve them.
1. Pad Lifting (Copper Peeling)
- Symptom: The copper pad separates from the polyimide base after soldering or rework.
- Causes: Excessive heat duration during hand soldering; lack of pad anchors; mechanical force applied to component.
- Checks: Microscope inspection of the pad interface; review footprint design for anchors.
- Fix: Epoxy bonding for repair (unreliable for production).
- Prevention: Use "tie-down" pad designs; strictly limit soldering iron contact time (<3 seconds); use wider tracks entering the pad.
2. Solder Joint Cracking (Fatigue)
- Symptom: Intermittent electrical connection; visible crack in the solder fillet.
- Causes: Flexing near the component; stiffener too small; CTE mismatch between component and flex.
- Checks: Flex the circuit gently while monitoring continuity. Check distance from stiffener edge to bend.
- Fix: None (board is scrap).
- Prevention: Increase stiffener size; move components further from bend zones; use flexible epoxy underfill for large components.
3. Stiffener Delamination
- Symptom: The rigid stiffener separates from the flex circuit after reflow.
- Causes: Moisture trapped in the flex/stiffener interface (popcorning); wrong adhesive (PSA used instead of Thermoset); insufficient lamination pressure.
- Checks: Look for bubbles or gaps between layers. Check baking logs.
- Fix: None.
- Prevention: Strict pre-bake (120°C) before assembly; specify high-temperature thermoset adhesive for all SMT stiffeners.
4. Component Tombstoning
- Symptom: Passive components stand up on one end during reflow.
- Causes: Uneven heating (flex heats unevenly if not flat); uneven solder paste printing due to flex warpage.
- Checks: Inspect carrier fixture flatness; check stencil alignment.
- Fix: Rework by hand (risky on flex).
- Prevention: Use high-quality magnetic carriers or sticky fixtures to ensure absolute flatness during printing and reflow.
5. Coverlay Encroachment (Solder Skip)
- Symptom: Solder fails to wet a portion of the pad.
- Causes: Coverlay adhesive flowed onto the pad during PCB fabrication lamination.
- Checks: Visual inspection of bare boards before assembly.
- Fix: Micro-abrasion (difficult).
- Prevention: Increase "Coverlay Expansion" rule in design (min 0.1mm); use LPI solder mask instead of coverlay for tight pitch components.
6. Warpage After Reflow
- Symptom: The flex assembly curls significantly after cooling.
- Causes: CTE mismatch between the copper, polyimide, and stiffener; asymmetric copper distribution.
- Checks: Measure bow and twist against flat surface.
- Fix: Fixture during cooling.
- Prevention: Balance copper density on top and bottom layers; use stiffeners with CTE closer to the assembly average; optimize cooling profile.
Design decisions
Successful implementation often comes down to selecting the right materials and structures early in the design phase.
Material Selection: Polyimide vs. Polyester (PET) For component placement on flex zones, Polyimide (PI) is the only viable choice. PET (used in cheap membrane switches) cannot withstand SMT reflow temperatures. Always specify standard Polyimide (e.g., DuPont Pyralux or equivalent) for any flex circuit requiring soldered components.
Stiffener Types
- FR4 (Glass Epoxy): The standard for component support. It provides the same surface properties as a rigid PCB. Use this for 95% of component areas.
- Polyimide Stiffener: Used when thickness is critical (e.g., increasing thickness to 0.3mm for a ZIF connector). Not recommended for heavy component support as it is still somewhat pliable.
- Stainless Steel / Aluminum: Used for heat sinking or extreme rigidity. Requires a non-conductive adhesive layer. Harder to process and more expensive.
Adhesive Selection
- Acrylic/Epoxy (Thermoset): Cures under heat and pressure. Permanent. Withstands reflow. Must be used for stiffeners under components.
- Pressure Sensitive Adhesive (PSA): Like double-sided tape (e.g., 3M 467MP). Applied cold. Cannot withstand reflow (will bubble/slip). Only use PSA for stiffeners applied after soldering (manual assembly) or for mounting the flex to a chassis.
FAQ
Q: Can I place BGAs on flex circuits? A: Yes, but it requires a rigid FR4 stiffener directly underneath and often underfill.
- The stiffener prevents the flex from warping during reflow.
- Underfill helps distribute mechanical stress to prevent solder ball cracking.
- X-ray inspection is mandatory.
Q: How close can a component be to the bend line? A: The component itself should be far away, but the stiffener edge must be at least 1.5mm to 2.5mm from the bend line.
- If the stiffener is too close, the bend stress concentrates at the stiffener edge, snapping traces.
- The component sits safely on the stiffener, isolated from the bend.
Q: Do I need a special solder paste for flex? A: Generally, no. Standard SAC305 (lead-free) or SnPb (leaded) paste is used.
- However, "low-temperature" solders (SnBi) are sometimes used to reduce thermal stress on the polyimide, though they have lower mechanical strength.
- The critical factor is the profile, not the paste chemistry.
Q: Why is baking required before assembly? A: Polyimide is hygroscopic and absorbs moisture quickly.
- If not baked, the moisture turns to steam during reflow (240°C+).
- This causes "delamination" (layers separating) or "measling" (white spots).
- Bake at 120°C for 2-4 hours immediately before assembly.
Q: Is it more expensive to place components on flex than rigid boards? A: Yes, assembly costs are higher.
- Requires custom carriers/pallets (NRE cost).
- Slower pick-and-place speeds to avoid bouncing.
- Manual handling is more delicate.
- Yields can be lower if design rules are not followed strictly.
Q: Can I hand solder components on flex? A: Yes, but it requires high skill.
- Pad lifting is very common due to lower peel strength.
- Use a temperature-controlled iron.
- Apply heat for the minimum time possible.
- Anchor pads are essential for hand-soldering reliability.
Q: What is the difference between Coverlay and Solder Mask for components? A: Coverlay is a laminated sheet of polyimide; Solder Mask is printed ink.
- Coverlay is stronger and more flexible but has lower resolution (larger openings required).
- Flexible LPI (Liquid Photoimageable) Solder Mask allows for tighter pitch components (like BGAs or QFNs) but is less robust against repeated bending.
- Hybrid designs often use Coverlay for the flex arm and LPI for the component area.
Q: What are "FPC panelization and carriers"? A: This refers to how the flex circuits are arrayed and supported.
- Panelization: Grouping multiple units into a frame for efficiency.
- Carriers: Rigid trays (magnetic or taped) that hold the flimsy panel flat during the SMT process. Without carriers, the flex will sag, causing print defects.
Q: Can I put vias under the component pads on flex? A: It is highly discouraged.
- Unless you use "via-in-pad" technology (plated shut and capped), solder will wick down the via.
- On flex, the barrel of the via is a stress point. Placing it under a component pad adds thermal stress to mechanical stress, increasing failure rates.
Q: How do I specify the stiffener location in my Gerber files? A: Use a dedicated mechanical layer.
- Draw the outline of the stiffener.
- Add text indicating material (e.g., "0.8mm FR4 Stiffener").
- Ensure this layer is included in the fabrication data set sent to APTPCB.
Related pages & tools
To further ensure the success of your flexible circuit design, utilize these resources from APTPCB:
- DFM Guidelines: Comprehensive design rules for rigid and flex PCBs.
- PCB Manufacturing: Details on our assembly capabilities and equipment.
- Materials: Specifications for Polyimide, FR4, and adhesive options.
- Quote: Get a cost estimate for your flex assembly project.
- Gerber Viewer: Verify your stiffener layers and coverlay openings before submission.
Glossary (key terms)
| Term | Definition |
|---|---|
| Stiffener | A rigid material (FR4, PI, Steel) laminated to a specific area of the flex circuit to support components or connectors. |
| Coverlay | A polyimide layer with adhesive used to insulate the outer layers of a flex circuit (analogous to solder mask on rigid boards). |
| Polyimide (PI) | The base material for flexible circuits, known for high thermal stability and flexibility. |
| PSA (Pressure Sensitive Adhesive) | "Tape-like" adhesive applied cold; not suitable for reflow soldering processes. |
| Thermoset Adhesive | Adhesive that cures with heat and pressure; required for bonding stiffeners that will undergo SMT reflow. |
| Anchoring Spur | A copper extension on a pad, covered by coverlay, used to mechanically lock the pad to the substrate to prevent lifting. |
| Dynamic Flex | A usage scenario where the circuit is continuously bent or folded (e.g., a hinge); components must never be placed here. |
| Static Flex | A usage scenario where the circuit is bent once for installation and then remains stationary; suitable for component placement with stiffeners. |
| CTE (Coefficient of Thermal Expansion) | The rate at which a material expands when heated. Mismatches between PI, Copper, and Components cause stress. |
| ZIF (Zero Insertion Force) | A type of connector often used with flex tails; requires specific stiffener thickness tolerances. |
| FPC Panelization | The arrangement of multiple single flex circuits into a larger array to facilitate manufacturing and assembly. |
| Carrier / Pallet | A fixture used to hold flexible panels flat during the screen printing and component placement process. |
| Baking | The process of heating bare boards to remove absorbed moisture before high-temperature assembly. |
Conclusion
Component placement on flex zones is a powerful technique for reducing device size and weight, but it demands a rigorous engineering approach. By treating the flex substrate as a mechanical system—using stiffeners to isolate stress, optimizing pad geometry for adhesion, and strictly controlling the assembly environment—you can achieve reliability comparable to rigid PCBs.
Whether you are designing a static sensor array or a complex rigid-flex assembly, adhering to these specifications is non-negotiable. For validation of your stack-up or to discuss specific stiffener requirements, contact the engineering team at APTPCB. We specialize in high-reliability flex and rigid-flex assembly, ensuring your design survives both the manufacturing process and the real world.