Rigid PCB Manufacturing
High-reliability rigid PCB fabrication up to 64 layers with HDI, heavy copper, fine-pitch BGAs, and impedance control. FR-4, low-loss RF materials, and full DFM support.
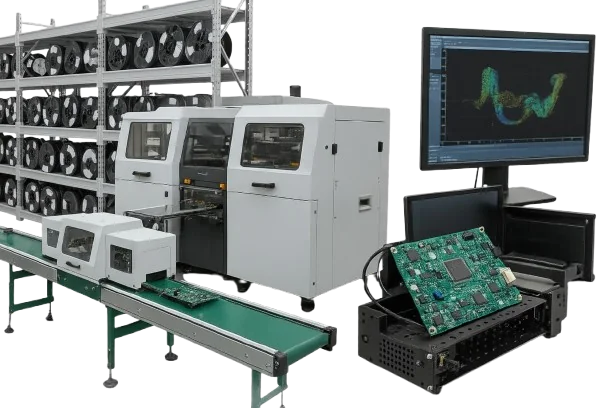
Manufacturing Capabilities
APTPCB offers comprehensive PCB manufacturing solutions across rigid, flex, HDI, rigid-flex, metal core, and ceramic PCBs. From prototype to mass production, we deliver high-reliability solutions for compute, RF, medical, automotive, and aerospace applications.
Explore our six core PCB manufacturing capabilities designed for diverse applications and requirements.
High-reliability rigid PCB fabrication up to 64 layers with HDI, heavy copper, fine-pitch BGAs, and impedance control. FR-4, low-loss RF materials, and full DFM support.
Flexible PCB (FPC) solutions for compact and lightweight electronics. 1–16 layer flex PCBs with polyimide, PET, PEN, and FR-4 base films, supporting bend-radius optimization.
Advanced High-Density Interconnect (HDI) PCB solutions enabling compact, high-performance devices. Microvia technology, sequential build-up, fine-line routing, and controlled impedance.
High-quality rigid-flex PCB fabrication up to 32 layers with 0.025 mm flex cores, HDI microvias, fine-pitch BGA support, and comprehensive engineering guidance.
Aluminum, copper-based, and iron-based metal core PCB (MCPCB) manufacturing for LED lighting, power electronics, and automotive applications with superior thermal conductivity.
High-performance ceramic PCB solutions using DPC, LTCC, and DBC technologies. Thermal conductivity 20–220 W/m·K for power electronics, automotive, medical, aerospace, and RF applications.
Share your stackup or DFM package and we will return recommendations with lead time and pricing guidance.